切割带及切割芯片接合薄膜的制作方法
 2021-02-02 16:02:37|
2021-02-02 16:02:37| 254|
254| 起点商标网
起点商标网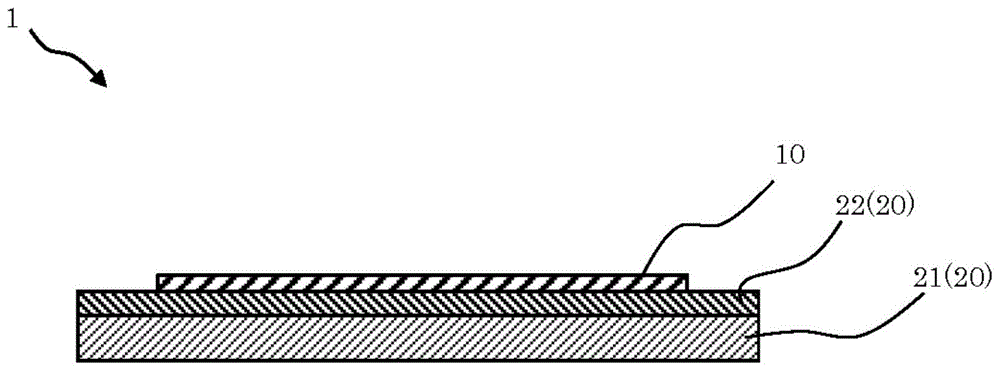
本发明涉及切割带及切割芯片接合薄膜。
背景技术:
以往在半导体集成电路的制造中使用切割带、切割芯片接合薄膜。
前述切割带具备基材层和层叠于该基材层的粘合剂层。
所述切割带在半导体集成电路的制造中在将半导体晶圆配置于粘合剂层上并将半导体晶圆切断时用于进行固定以使经单片化的半导体芯片不飞散。
前述切割芯片接合薄膜具备:切割带、和层叠于该切割带的粘合剂层的芯片接合层(芯片接合薄膜)。
所述切割芯片接合薄膜在半导体集成电路的制造中用于由半导体晶圆得到贴附有芯片接合层的状态的半导体芯片。
对于使用切割芯片接合薄膜来获得贴附有芯片接合层的状态的半导体芯片的方法,将可分割为半导体芯片的状态(或经分割的状态)的半导体晶圆贴附于切割芯片接合薄膜的芯片接合层上的中央,对切割芯片接合薄膜的基材层在低温下(例如-20℃~5℃)进行扩展(也称为“冷扩展工序”。),由此将半导体晶圆和芯片接合层(芯片接合薄膜)一起割断(使用经分割的状态的半导体晶圆的情况下仅将芯片接合层割断),在切割带上得到带芯片接合薄膜的半导体芯片。
接着,在例如10℃以上的温度下进行扩展(也称为“热扩展工序”、“常温扩展工序”。),由此扩大邻接的带芯片接合薄膜的半导体芯片彼此的间隔。
然后,通过使切割带的外周部分热收缩,保持扩大了带芯片接合薄膜的半导体芯片彼此的间隔的状态(也称为“热收缩工序”。)。
由此,变得容易进行带芯片接合薄膜的半导体芯片自切割带上的拾取(也称为“拾取工序”。)。
另外,在热收缩工序后、并且在从切割带上拾取带芯片接合薄膜的半导体芯片前,有时也用水等清洗液对切割带上的带芯片接合薄膜的半导体芯片进行清洗(也称为“清洗工序”。)。
现有技术文献
专利文献
专利文献1:日本特开2015-185591号公报
专利文献2:日本特开2018-195746号公报
技术实现要素:
发明要解决的问题
然而,在拾取工序前,带芯片接合薄膜的半导体芯片的端部有时自切割带的粘合剂层浮起。
所述浮起在清洗工序等中可成为带芯片接合薄膜的半导体芯片自切割带的不期望的剥离的原因。
特别是在半导体晶圆表面预先形成的布线结构越进行多层化,布线结构内的树脂与半导体芯片主体的半导体材料的热膨胀率之差越成为主要原因从而容易发生前述浮起。
另外,特别是在常温扩展工序时容易发生前述浮起。
此处,为了抑制所述浮起的发生,考虑提高前述粘合剂层的粘合力。
但是,仅通过提高前述粘合剂层的粘合力,难以从切割带上拾取带芯片接合薄膜的半导体芯片。
因此,寻求能抑制浮起、并且拾取性优异的切割芯片接合薄膜。
另外,寻求在使用切割带由半导体晶圆得到半导体芯片时也能抑制浮起、并且拾取性优异的切割带。
因此,本发明鉴于上述期望的点,课题在于,得到能抑制浮起、并且拾取性优异的切割带及切割芯片接合薄膜。
用于解决问题的方案
本发明的切割带具备:基材层、和层叠于该基材层的粘合剂层,
前述粘合剂层含有具有聚合性不饱和键的紫外线固化型的聚合性聚合物,
前述粘合剂层的紫外线固化的差示扫描量热测定中的每单位质量的发热量为19mj/mg以上。
根据所述切割带,通过使前述粘合剂层具备前述紫外线固化型的聚合性聚合物,从而即使提高前述粘合剂层的粘合力来抑制浮起,通过在拾取工序前对粘合剂层照射紫外线,也能够使前述粘合剂层的紫外线固化型的聚合性聚合物彼此进行自由基聚合,其结果,能够降低粘合剂层的粘合力从而提高拾取性。
进而,根据所述切割带,通过使前述每单位时间的发热量为19mj/mg以上,从而能够使照射紫外线前后的粘合剂层的粘合力差异很大。
因此,所述切割带可抑制浮起、并且拾取性优异。
另外,本发明的切割芯片接合薄膜具备前述切割带、和层叠于该切割带的前述粘合剂层的芯片接合层。
如上所述,根据本发明,可提供抑制浮起、并且拾取性优异的切割带及切割芯片接合薄膜。
附图说明
图1为将本实施方式的切割芯片接合薄膜沿厚度方向切断而得的截面图。
图2的a为示意性地示出半导体集成电路的制造方法中的半切割加工的情况的截面图。
图2的b为示意性地示出半导体集成电路的制造方法中的半切割加工的情况的截面图。
图2的c为示意性地示出半导体集成电路的制造方法中的半切割加工的情况的截面图。
图2的d为示意性地示出半导体集成电路的制造方法中的半切割加工的情况的截面图。
图3的a为示意性地示出半导体集成电路的制造方法中的安装工序的情况的截面图。
图3的b为示意性地示出半导体集成电路的制造方法中的安装工序的情况的截面图。
图4的a为示意性地示出半导体集成电路的制造方法中的冷扩展工序的情况的截面图。
图4的b为示意性地示出半导体集成电路的制造方法中的冷扩展工序的情况的截面图。
图4的c为示意性地示出半导体集成电路的制造方法中的冷扩展工序的情况的截面图。
图5的a为示意性地示出半导体集成电路的制造方法中的热扩展工序的情况的截面图。
图5的b为示意性地示出半导体集成电路的制造方法中的热扩展工序的情况的截面图。
图6为示意性地示出半导体集成电路的制造方法中的拾取工序的情况的截面图。
附图标记说明
1:切割芯片接合薄膜、
10:芯片接合层、
20:切割带、
21:基材层、
22:粘合剂层。
具体实施方式
以下,参照附图对本发明的切割芯片接合薄膜及切割带的一实施方式进行说明。
如图1所示,本实施方式的切割芯片接合薄膜1具备:切割带20,其具有基材层21及层叠于该基材层21的粘合剂层22;和层叠于前述粘合剂层22并且粘接于半导体晶圆的芯片接合层10。
本实施方式的切割带20通常为长条片,直到使用为止以卷绕的状态保管。本实施方式的切割芯片接合薄膜1粘贴于具有比经割断处理的硅晶圆大一圈的内径的圆环状的框并切割来使用。
本实施方式的切割带20的前述粘合剂层22含有具有聚合性不饱和键的紫外线固化型的聚合性聚合物。
另外,前述粘合剂层22的紫外线固化的差示扫描量热测定中的每单位质量的发热量为19mj/mg以上是重要的,优选为19~60mj/mg、优选为22~40mj/mg。
本实施方式的切割带20通过使前述粘合剂层具备前述紫外线固化型的聚合性聚合物,从而即使提高粘合剂层的粘合力来抑制浮起,通过在拾取工序前对粘合剂层照射紫外线,也能够使前述粘合剂层的紫外线固化型的聚合性聚合物彼此进行自由基聚合,其结果,能够降低粘合剂层的粘合力从而提高拾取性。
另外,本实施方式的切割带20通过使前述每单位质量的发热量为19mj/mg以上,从而能够使照射紫外线前后的粘合剂层的粘合力差异很大。
前述差示扫描量热测定的发热峰的每单位质量的峰顶的值优选超过0.7mw/mg、更优选为1.0~2.6mw/mg。
本实施方式的切割带20通过使前述差示扫描量热测定的发热峰的每单位质量的峰顶的值超过0.7mw/mg,从而紫外线固化变快,其结果,能够在紫外线照射后早期成为拾取性优异的状态。
前述差示扫描量热测定中的从紫外线照射开始到直至前述峰顶为止的时间优选为1.0分钟以下、更优选为0.05~0.3分钟。
本实施方式的切割带20通过使前述差示扫描量热测定中的从紫外线照射开始到直至前述峰顶为止的时间为1.0分钟以下,从而紫外线固化变快,其结果,能够在紫外线照射后早期成为拾取性优异的状态。
需要说明的是,“前述粘合剂层22的紫外线固化的差示扫描量热测定中的每单位质量的发热量”、“前述差示扫描量热测定的发热峰的每单位质量的峰顶的值”、及“前述差示扫描量热测定中的从紫外线照射开始到直至前述峰顶为止的时间”可以通过后述的实施例中记载的方法来求出。
前述差示扫描量热测定中,照射紫外线直到前述粘合剂层22充分固化为止。
将sus板贴合于前述粘合剂层22时的前述粘合剂层22与前述sus板间的180°剥离强度优选为0.30n/20mm以上、更优选为0.8~3.0n/20mm。
需要说明的是,将sus板贴合于前述粘合剂层22时的前述粘合剂层22与前述sus板间的180°剥离强度是指紫外线照射前的180°剥离强度。
本实施方式的切割带20通过使紫外线照射前的前述180°剥离强度为0.30n/20mm以上,从而粘合剂层的粘合力变高,其结果,变得更容易抑制浮起。另外,本实施方式的切割带20通过抑制浮起,从而变得容易维持氧不与前述粘合剂层22的表面接触的状态,其结果,能够抑制紫外线固化受到阻碍。
将sus板贴合于前述粘合剂层并对前述粘合剂层照射紫外线后的前述粘合剂层与前述sus板间的180°剥离强度(以下也称为“紫外线照射后的180°剥离强度”。)优选不足0.20n/20mm、更优选为0.02~0.10n/20mm。
本实施方式的切割带20通过使紫外线照射后的前述180°剥离强度不足0.20n/20mm,从而紫外线照射后的粘合剂层的粘合力变低,其结果,能够提高拾取性。
将sus板贴合于前述粘合剂层时的前述粘合剂层与sus板间的180°剥离强度优选满足下述式(1)、更优选满足下述式(2)。
紫外线照射后的前述180°剥离强度/紫外线照射前的前述180°剥离强度<0.28···(1)
0.02≤紫外线照射后的前述180°剥离强度/紫外线照射前的前述180°剥离强度≤0.25···(2)
本实施方式的切割带20通过满足上述式(1),从而能够进一步抑制浮起、并且能够进一步提高拾取性。
需要说明的是,“紫外线照射后的前述180°剥离强度”及“紫外线照射前的前述180°剥离强度”可以通过后述的实施例中记载的方法来求出。
紫外线照射后的前述180°剥离强度是指照射紫外线直至前述粘合剂层22充分固化为止后的180°剥离强度。
前述粘合剂层22含有具有粘合性的聚合物成分。作为前述聚合物成分,例如可列举出丙烯酸类聚合物、烯烃聚合物、或有机硅聚合物等。其中,优选丙烯酸类聚合物。
需要说明的是,丙烯酸类聚合物为包含(甲基)丙烯酸酯单体作为构成单元的聚合物。(甲基)丙烯酸酯为包含甲基丙烯酸酯及丙烯酸酯的概念。丙烯酸类聚合物可以包含除(甲基)丙烯酸酯单体以外的单体作为构成单元。
前述粘合剂层22含有具有聚合性不饱和键的紫外线固化型的聚合性聚合物作为前述粘合性聚合物。
作为该聚合性聚合物,可列举出主链或侧链的末端含有聚合性的乙烯基(h2c=ch-)或乙炔基(hc≡c-)的聚合物等。
本实施方式中,前述粘合剂层22含有具有聚合性不饱和键的紫外线固化型的聚合性丙烯酸类聚合物作为前述聚合性聚合物。
另外,本实施方式中,粘合剂层22例如包含上述的聚合性丙烯酸类聚合物、异氰酸酯化合物、和聚合引发剂。
粘合剂层22例如具有3μm以上且20μm以下的厚度。粘合剂层22的形状及大小通常与基材层21的形状及大小相同。
粘合剂层22中所含的丙烯酸类聚合物中,上述的构成单元可以通过1h-nmr、13c-nmr等nmr分析、热分解gc/ms分析、及红外分光法等进行确认。需要说明的是,丙烯酸类聚合物中的上述构成单元的摩尔比例通常可以根据使丙烯酸类聚合物进行聚合时的配混量(投料量)来算出。
本实施方式中,上述的丙烯酸类聚合物由(甲基)丙烯酸烷基酯的构成单元、含羟基(甲基)丙烯酸酯的构成单元、和含聚合性基团的(甲基)丙烯酸酯的构成单元构成。需要说明的是,构成单元为构成丙烯酸类聚合物的主链的单元。上述的丙烯酸类聚合物中的各侧链包含在构成主链的各构成单元中。
(甲基)丙烯酸烷基酯的构成单元源自(甲基)丙烯酸烷基酯单体。换言之,(甲基)丙烯酸烷基酯单体进行了聚合反应后的分子结构为(甲基)丙烯酸烷基酯的构成单元。详细而言,通过(甲基)丙烯酸烷基酯单体的聚合反应产生的键构成丙烯酸类聚合物的主链的一部分。
烷基的烃部分以为饱和烃,也可以为不饱和烃。例如,烷基的烃部分为直链状饱和烃、支链状饱和烃、脂环式烃、芳香族烃。所述烃部分优选为直链状饱和烃或支链状饱和烃,更优选为支链状饱和烃。
需要说明的是,烷基的烃部分也可以包含具有氧(o)、氮(n)等的极性基团,但优选不含该极性基团。
作为(甲基)丙烯酸烷基酯的构成单元,例如可列举出(甲基)丙烯酸乙酯、(甲基)丙烯酸丁酯、(甲基)丙烯酸己酯、(甲基)丙烯酸庚酯、(甲基)丙烯酸正辛酯、(甲基)丙烯酸2-乙基己酯、(甲基)丙烯酸异辛基酯、(甲基)丙烯酸正壬酯、(甲基)丙烯酸异(仲)壬酯、(甲基)丙烯酸叔壬酯、(甲基)丙烯酸异冰片酯、(甲基)丙烯酸正癸酯、(甲基)丙烯酸异(仲)癸酯、(甲基)丙烯酸叔癸酯、(甲基)丙烯酸正十一烷基酯、(甲基)丙烯酸异(仲)十一烷基酯、(甲基)丙烯酸叔十一烷基酯、(甲基)丙烯酸月桂酯等各构成单元。
丙烯酸类聚合物具有含羟基(甲基)丙烯酸酯的构成单元,所述构成单元的羟基容易与异氰酸酯基进行反应。
通过预先使粘合剂层22中共存具有含羟基(甲基)丙烯酸酯的构成单元的丙烯酸类聚合物和异氰酸酯化合物,从而能够使粘合剂层适度地固化。
含羟基(甲基)丙烯酸酯的构成单元源自含羟基(甲基)丙烯酸酯单体。换言之,含羟基(甲基)丙烯酸酯单体进行了聚合反应后的分子结构为含羟基(甲基)丙烯酸酯的构成单元。详细而言,通过含羟基(甲基)丙烯酸酯单体的聚合反应而产生的键构成丙烯酸类聚合物的主链的一部分。
含羟基(甲基)丙烯酸酯的构成单元优选为含羟基c2~c4烷基(甲基)丙烯酸酯的构成单元。
烷基的烃部分通常为饱和烃。例如,烷基的烃部分为直链状饱和烃或支链状饱和烃。烷基的烃部分优选不含具有氧(o)、氮(n)等的极性基团。
需要说明的是,含羟基(甲基)丙烯酸酯的构成单元中,羟基(-oh基)可以与烃部分的任意碳(c)键合。羟基(-oh基)优选与烃部分的末端的碳(c)键合。
作为含羟基烷基(甲基)丙烯酸酯的构成单元,例如,可列举出(甲基)丙烯酸羟基乙酯、(甲基)丙烯酸羟基丙酯、(甲基)丙烯酸羟基正丁酯或(甲基)丙烯酸羟基异丁酯这样的(甲基)丙烯酸羟基丁酯的各构成单元。需要说明的是,(甲基)丙烯酸羟基丁酯的构成单元中,羟基(-oh基)可以与烃部分的末端的碳(c)键合,也可以与烃部分的末端以外的碳(c)键合。
作为含羟基烷基(甲基)丙烯酸酯的构成单元,优选(甲基)丙烯酸羟基乙酯的构成单元,更优选(甲基)丙烯酸2-羟基乙酯的构成单元。
由此,具有能够进一步抑制半导体芯片的浮起的优点。
本实施方式中,上述的丙烯酸类聚合物如上所述还含有含聚合性基团的(甲基)丙烯酸酯的构成单元。换言之,上述的丙烯酸类聚合物包含在侧链具有聚合性不饱和双键的含聚合性基团的(甲基)丙烯酸酯的构成单元。
通过使上述的丙烯酸类聚合物含有含聚合性基团的(甲基)丙烯酸酯的构成单元,由此能在拾取工序前通过紫外线的照射来使粘合剂层22固化。详细而言,通过紫外线的活性能量射线的照射,由光聚合引发剂产生自由基,通过该自由基的作用,能够使丙烯酸类聚合物彼此进行交联反应。由此,通过照射能够使照射前的粘合剂层22的粘合力降低。而且,有能够使芯片接合层10从粘合剂层22良好地剥离、能够发挥更良好的拾取性这样的优点。
含聚合性基团的(甲基)丙烯酸酯的构成单元可以通过使分子中具有能与羟基键合的官能团和聚合性基团的单体与含羟基(甲基)丙烯酸酯的构成单元键合来形成。上述的官能团可以为与羟基的反应性高的异氰酸酯基。换言之,上述的单体可以为在分子的两末端分别具有异氰酸酯基和乙烯基的单体。乙烯基例如可以为(甲基)丙烯酰基的一部分。
具体而言,含聚合性基团的(甲基)丙烯酸酯的构成单元可以具有使上述的含羟基(甲基)丙烯酸酯的构成单元中的羟基与含异氰酸酯基的(甲基)丙烯酸酯单体的异氰酸酯基进行氨基甲酸酯键合而成的分子结构。换言之,含聚合性基团的(甲基)丙烯酸酯的构成单元可以具有作为源自含羟基(甲基)丙烯酸酯的构成单元的分子结构的、借助源自羟基的氨基甲酸酯键而键合有聚合性基团((甲基)丙烯酰基)的分子结构。
具有聚合性基团的含聚合性基团的(甲基)丙烯酸酯的构成单元可以在丙烯酸类聚合物中间体的聚合后制备。例如,可以在(甲基)丙烯酸烷基酯单体与含羟基(甲基)丙烯酸酯单体的共聚后,使含羟基(甲基)丙烯酸酯的构成单元的一部分的羟基与含异氰酸酯基的聚合性单体的异氰酸酯基进行氨基甲酸酯化反应,由此得到上述的含聚合性基团的(甲基)丙烯酸酯的构成单元。
上述的含异氰酸酯基的(甲基)丙烯酸酯单体优选在分子中具有1个异氰酸酯基并且具有1个(甲基)丙烯酰基。作为所述单体,例如,可列举出(甲基)丙烯酸2-异氰酸根合乙酯、4-丙烯酰基吗啉等。
前述粘合剂层22还含有异氰酸酯化合物。异氰酸酯化合物的一部分可以为通过氨基甲酸酯化反应等进行反应后的状态。
异氰酸酯化合物在分子中具有多个异氰酸酯基。通过使异氰酸酯化合物在分子中具有多个异氰酸酯基,从而能够使粘合剂层22中的丙烯酸类聚合物间的交联反应进行。详细而言,通过使异氰酸酯化合物的一个异氰酸酯基与丙烯酸类聚合物的羟基进行反应、使其他异氰酸酯基与其他丙烯酸类聚合物的羟基进行反应,从而可以进行借助了异氰酸酯化合物的交联反应。
作为异氰酸酯化合物,例如,可列举出脂肪族二异氰酸酯、脂环族二异氰酸酯、或芳香脂肪族二异氰酸酯等二异氰酸酯。
作为脂肪族二异氰酸酯,例如,可列举出亚乙基二异氰酸酯、四亚甲基二异氰酸酯、六亚甲基二异氰酸酯、2,4,4-或2,2,4-三甲基六亚甲基二异氰酸酯、2,6-二异氰酸根合己酸甲酯等。
作为脂环族二异氰酸酯,例如,可列举出3-异氰酸根合甲基-3,5,5-三甲基环己烷、1,3-或1,4-双(异氰酸根合甲基)环己烷、甲基环己烷-2,4-或2,6-二异氰酸酯、二环己基甲烷-4,4’-二异氰酸酯、1,3-或1,4-二异氰酸根合环己烷等。
作为芳香族二异氰酸酯,例如,可列举出间苯二异氰酸酯或对苯二异氰酸酯、二苯基甲烷-4,4’-二异氰酸酯、2,4-或2,6-甲苯二异氰酸酯、1,3’-或1,4-双(异氰酸根合甲基)苯、1,3-或1,4-双(α-异氰酸根合异丙基)苯等。
另外,作为异氰酸酯化合物,可列举出三异氰酸酯。作为三异氰酸酯,例如,可列举出三苯基甲烷-4,4’,4”-三异氰酸酯、1,3,5-三异氰酸根合苯、1,3,5-三(异氰酸根合甲基)环己烷、1,3,5-三(异氰酸根合甲基)苯、2,6-二异氰酸根合己酸-2-异氰酸根合乙酯等。
进而,作为异氰酸酯化合物,例如,可列举出二异氰酸酯的二聚体、三聚体等聚合多异氰酸酯、多亚甲基多亚苯基多异氰酸酯。
此外,作为异氰酸酯化合物,例如,可列举出使过量的上述异氰酸酯化合物与含活性氢化合物反应而得的多异氰酸酯。作为含活性氢化合物,可列举出含活性氢低分子量化合物、含活性氢高分子量化合物等。
作为含活性氢低分子量化合物,例如,可列举出乙二醇、丙二醇、二丙二醇、二乙二醇、三乙二醇、2,2,4-三甲基-1,3-戊二醇、新戊二醇、己二醇、环己烷二甲醇、环己二醇、氢化双酚a、苯二亚甲基二醇、甘油、三羟甲基乙烷、三羟甲基丙烷、己烷三醇、季戊四醇、山梨糖醇(sorbitol)、山梨糖醇(sorbit)、蔗糖、蓖麻油、乙二胺、六亚甲基二胺、二乙醇胺、三乙醇胺、水、胺、尿素等,作为含活性氢高分子量化合物,可列举出各种聚醚多元醇、聚酯多元醇、聚氨酯多元醇、丙烯酸类多元醇、环氧多元醇等。
进而,作为异氰酸酯化合物,也可以使用脲基甲酸酯化多异氰酸酯、缩二脲化多异氰酸酯等。
上述的异氰酸酯化合物可以单独使用1种或组合使用2种以上。
作为上述的异氰酸酯化合物,优选芳香族二异氰酸酯与含活性氢低分子量化合物的反应产物。芳香族二异氰酸酯进行反应而得的反应产物由于异氰酸酯基的反应速度比较慢,因此包含所述反应产物的粘合剂层22可抑制过度地进行固化。作为上述的异氰酸酯化合物,优选分子中具有3个以上异氰酸酯基的异氰酸酯化合物。
粘合剂层22中所含的聚合引发剂为能够通过施加的热、光的能量而使聚合反应开始的化合物。通过使粘合剂层22包含聚合引发剂,从而能够在对粘合剂层22赋予热能、光能时使丙烯酸类聚合物间的交联反应进行。详细而言,能够使具有含聚合性基团的(甲基)丙烯酸酯的构成单元的丙烯酸类聚合物间开始聚合性基团彼此的聚合反应,从而使粘合剂层22固化。由此,如上所述,能够发挥更良好的拾取性。
作为聚合引发剂,例如,可以采用光聚合引发剂或热聚合引发剂等。作为聚合引发剂,可以使用通常的市售制品。
粘合剂层22还可以包含除上述的成分以外的其他成分。作为其他成分,例如,可列举出增塑剂、填充剂、防老剂、抗氧化剂、紫外线吸收剂、光稳定剂、耐热稳定剂、抗静电剂、表面活性剂、轻剥离化剂等。其他成分的种类及用量可以根据目的来适当地选择。
本实施方式的切割带20具备与上述的粘合剂层22贴合的基材层21。基材层21例如为金属箔、纸、布等纤维片、橡胶片、树脂薄膜等。基材层21也可以具有层叠结构。
作为构成基材层21的纤维片,可列举出纸、织布、无纺布等。
作为树脂薄膜的材质,例如,可列举出聚乙烯(pe)、聚丙烯(pp)、乙烯-丙烯共聚物等聚烯烃;乙烯-乙酸乙烯酯共聚物(eva)、离聚物树脂、乙烯-(甲基)丙烯酸共聚物、乙烯-(甲基)丙烯酸酯(无规、交替)共聚物等乙烯的共聚物;聚对苯二甲酸乙二醇酯(pet)、聚萘二甲酸乙二醇酯(pen)、聚对苯二甲酸丁二醇酯(pbt)等聚酯;聚丙烯酸酯;聚氯乙烯(pvc);聚氨酯;聚碳酸酯;聚苯硫醚(pps);脂肪族聚酰胺、全芳香族聚酰胺(芳纶)等聚酰胺;聚醚醚酮(peek);聚酰亚胺;聚醚酰亚胺;聚偏氯乙烯;abs(丙烯腈-丁二烯-苯乙烯共聚物);纤维素或纤维素衍生物;含有机硅高分子;含氟高分子等。这些可以单独使用1种或组合使用2种以上。
基材层21具有树脂薄膜的情况下,也可以对树脂薄膜实施拉伸处理等,控制伸长率等变形性。
对于基材层21的表面,为了提高与粘合剂层22的密合性,也可以实施表面处理。作为表面处理,例如,可采用铬酸处理、臭氧暴露、火焰暴露、高压电击暴露、离子化辐射线处理等基于化学方法或物理方法的氧化处理等。另外,也可以实施基于锚涂剂、底漆、粘接剂等涂布剂的涂布处理。
对于基材层21的背面侧(不与粘合剂层22重叠的一侧),为了赋予剥离性,例如可以利用有机硅树脂、氟树脂等脱模剂(剥离剂)等来实施涂布处理。
对于基材层21,从能从背面侧对粘合剂层22施加紫外线等活性能量射线的方面出发,优选为透光性(紫外线透过性)的树脂薄膜等。
本实施方式的切割带20在使用前的状态下也可以具备覆盖粘合剂层22的一个面(粘合剂层22的不与基材层21重叠的面)的剥离片。面积比粘合剂层22小的芯片接合层10以容纳于粘合剂层22的方式配置的情况下,剥离片以覆盖粘合剂层22及芯片接合层10这两者的方式来配置。剥离片是为了保护粘合剂层22而使用的,在将芯片接合层10贴附于粘合剂层22之前被剥离。
作为剥离片,例如,可以使用利用有机硅系、长链烷基系、氟系、硫化钼等的剥离剂进行了表面处理的塑料薄膜或纸等。
另外,作为剥离片,例如,可以使用聚四氟乙烯、聚氯三氟乙烯、聚氟化乙烯、聚偏氟乙烯、四氟乙烯·六氟丙烯共聚物、氯氟乙烯·偏氟乙烯共聚物等氟系聚合物制的薄膜;聚乙烯、聚丙烯等聚烯烃制的薄膜;聚对苯二甲酸乙二醇酯(pet)等聚酯制的薄膜等。
另外,作为剥离片,例如,可以使用利用氟系剥离剂、丙烯酸长链烷基酯系剥离剂等剥离剂进行了表面涂布的塑料薄膜或纸类等。
需要说明的是,剥离片可以作为用于支撑粘合剂层22的支撑材料来利用。剥离片特别是在将粘合剂层22重叠于基材层21上时适合使用。详细而言,可以在剥离片与粘合剂层22层叠的状态下使粘合剂层22重叠于基材层21,重叠后将剥离片剥离(转印),由此在基材层21上重叠粘合剂层22。
接着,对本实施方式的切割芯片接合薄膜1详细进行说明。
本实施方式的切割芯片接合薄膜1具备:上述的切割带20、和层叠于该切割带20的粘合剂层22的芯片接合层10。芯片接合层10在半导体集成电路的制造中粘接于半导体晶圆。
芯片接合层10可包含热固化性树脂及热塑性树脂中的至少一者。芯片接合层10优选包含热固化性树脂及热塑性树脂。
作为热固化性树脂,例如,可列举出环氧树脂、酚醛树脂、氨基树脂、不饱和聚酯树脂、聚氨酯树脂、有机硅树脂、热固化性聚酰亚胺树脂等。作为上述热固化性树脂,可以仅采用1种或采用2种以上。从含有更少的可成为作为芯片接合对象的半导体芯片的腐蚀原因的离子性杂质等的方面出发,作为上述热固化性树脂,优选环氧树脂。作为环氧树脂的固化剂,优选酚醛树脂。
作为上述环氧树脂,例如,可列举出双酚a型、双酚f型、双酚s型、溴化双酚a型、氢化双酚a型、双酚af型、联苯型、萘型、芴型、苯酚酚醛清漆型、邻甲酚酚醛清漆型、三羟基苯基甲烷型、四羟苯基乙烷型、乙内酰脲型、异氰脲酸三缩水甘油酯型、或缩水甘油胺型的各环氧树脂。
作为环氧树脂,优选萘型环氧树脂。
酚醛树脂可以作为环氧树脂的固化剂而发挥作用。作为酚醛树脂,例如,可列举出酚醛清漆型酚醛树脂、甲阶酚醛型酚醛树脂、聚对氧苯乙烯等聚氧苯乙烯等。
作为酚醛清漆型酚醛树脂,例如,可列举出苯酚酚醛清漆树脂、苯酚芳烷基树脂、甲酚酚醛清漆树脂、叔丁基苯酚酚醛清漆树脂、壬基苯酚酚醛清漆树脂等。
作为酚醛树脂,优选苯酚酚醛清漆树脂。这些酚醛树脂作为环氧树脂(芯片接合用粘接剂)的固化剂而发挥作用时,能够进一步提高作为粘接剂的环氧树脂的粘接性。
作为上述酚醛树脂,可以仅采用1种或采用2种以上。
芯片接合层10中,酚醛树脂的羟基相对于环氧树脂的环氧基1当量优选为0.5当量以上且2.0当量以下,更优选为0.7当量以上且1.5当量以下。由此,能够充分进行环氧树脂与酚醛树脂的固化反应。
芯片接合层10包含热固化性树脂的情况下,芯片接合层10中的所述热固化性树脂的含有比例相对于芯片接合层10的总质量优选5质量%以上且60质量%以下、更优选10质量%以上且50质量%以下。由此,芯片接合层10能够适当地表现作为热固化型粘接剂的功能。
作为芯片接合层10中可包含的热塑性树脂,例如,可列举出天然橡胶、丁基橡胶、异戊二烯橡胶、氯丁橡胶、乙烯-乙酸乙烯酯共聚物、乙烯-丙烯酸共聚物、乙烯-丙烯酸酯共聚物、聚丁二烯树脂、聚碳酸酯树脂、热塑性聚酰亚胺树脂、聚酰胺6(6-尼龙)、聚酰胺66(6,6-尼龙)等聚酰胺树脂、苯氧基树脂、丙烯酸类树脂、pet、pbt等饱和聚酯树脂、聚酰胺酰亚胺树脂、氟树脂等。
作为上述热塑性树脂,从离子性杂质少、并且耐热性高,因此能够进一步确保芯片接合层10的粘接性的方面出发,优选丙烯酸类树脂。
作为上述热塑性树脂,可以仅采用1种或采用2种以上。
上述丙烯酸类树脂优选为分子中的构成单元中(甲基)丙烯酸烷基酯的构成单元以质量比例计最多的聚合物。作为该(甲基)丙烯酸烷基酯,例如,可列举出(甲基)丙烯酸c2~c4烷基酯。
上述丙烯酸类树脂还可以包含源自能与(甲基)丙烯酸烷基酯单体共聚的其他单体成分的构成单元。
作为上述其他单体成分,例如,可列举出含羧基单体、酸酐单体、含羟基单体、含缩水甘油基单体、含磺酸基单体、含磷酸基单体、丙烯酰胺、丙烯腈等含官能团的单体、或其他各种多官能性单体等。
对于上述丙烯酸类树脂,从芯片接合层10能够发挥更高的内聚力的方面出发,优选为(甲基)丙烯酸烷基酯(特别是烷基部分的碳数为4以下的(甲基)丙烯酸烷基酯)与含羧基单体与含氮原子单体与多官能性单体(特别是多缩水甘油基系多官能单体)的共聚物,更优选为丙烯酸乙酯与丙烯酸丁酯与丙烯酸与丙烯腈与多缩水甘油基(甲基)丙烯酸酯的共聚物。
对于上述丙烯酸类树脂的玻璃化转变温度(tg),从容易将芯片接合层10的弹性、粘性设定为期望的范围内的方面出发,优选为5℃以上且35℃以下、更优选为10℃以上且30℃以下。
芯片接合层10包含热固化性树脂和热塑性树脂的情况下,对于芯片接合层10中的上述热塑性树脂的含有比例,相对于除填料以外的有机成分(例如热固化性树脂、热塑性树脂、固化催化剂等、硅烷偶联剂、染料)的总质量,优选为20质量%以上且60质量%以下,更优选为30质量%以上且50质量%以下,进一步优选为35质量%以上且45质量%以下。需要说明的是,通过使热固化性树脂的含有比例变化,从而能够对芯片接合层10的弹性、粘性进行调整。
芯片接合层10的热塑性树脂具有热固化性官能团的情况下,作为该热塑性树脂,例如,可以采用含热固化性官能团丙烯酸类树脂。该含热固化性官能团丙烯酸类树脂优选在分子中包含最多的质量比例的源自(甲基)丙烯酸烷基酯的构成单元。作为该(甲基)丙烯酸烷基酯,例如,可列举出上述例示的(甲基)丙烯酸烷基酯。
另一方面,作为含热固化性官能团丙烯酸类树脂中的热固化性官能团,例如可列举出缩水甘油基、羧基、羟基、异氰酸酯基等。其中,优选缩水甘油基、羟基、羧基。换言之,作为含热固化性官能团丙烯酸类树脂,优选含有羟基及羧基的丙烯酸类树脂。
芯片接合层10优选含有含热固化性官能团丙烯酸类树脂和固化剂。作为固化剂,可列举出作为粘合剂层22中可包含的固化剂而例示出的物质。含热固化性官能团丙烯酸类树脂中的热固化性官能团为缩水甘油基的情况下,优选使用具有多个酚结构的化合物作为固化剂。例如,可以使用上述的各种酚醛树脂作为固化剂。
芯片接合层10优选含有填料。通过改变芯片接合层10中的填料的量,从而能够更容易地对芯片接合层10的弹性及粘性进行调整。进而,能够调整芯片接合层10的导电性、导热性、弹性模量等物性。
作为填料,可列举出无机填料及有机填料。作为填料,优选无机填料。
作为无机填料,例如,可列举出包含氢氧化铝、氢氧化镁、碳酸钙、碳酸镁、硅酸钙、硅酸镁、钙氧化物、镁氧化物、铝氧化物、氮化铝、氮化硼、结晶质二氧化硅、非晶质二氧化硅等二氧化硅等的填料。另外,作为无机填料的材质,可列举出铝、金、银、铜、镍等金属单质、合金等。可以为硼酸酸铝晶须、无定形炭黑、石墨等填料。填料的形状可以为球状、针状、片状等各种形状。作为填料,可以仅采用上述的1种或采用2种以上。
上述填料的平均粒径优选为0.005μm以上且10μm以下、更优选为0.005μm以上且1μm以下。通过使上述平均粒径为0.005μm以上,从而对半导体晶圆等被粘物的润湿性、粘接性进一步提高。通过使上述平均粒径为10μm以下,从而能够更充分地发挥由添加的填料带来的特性,另外,能够进一步发挥芯片接合层10的耐热性。填料的平均粒径例如可以使用光度式的粒度分布计(例如,制品名“la-910”、horiba,ltd.制)来求出。
芯片接合层10包含填料的情况下,上述填料的含有比例相对于芯片接合层10的总质量优选为30质量%以上且70质量%以下、更优选为40质量%以上且60质量%以下、进一步优选为42质量%以上且55质量%以下。
芯片接合层10根据需要可以包含其他成分。作为上述其他成分,例如,可列举出固化催化剂、阻燃剂、硅烷偶联剂、离子捕捉剂、染料等。
作为阻燃剂,例如,可列举出三氧化锑、五氧化锑、溴化环氧树脂等。
作为硅烷偶联剂,例如,可列举出β-(3,4-环氧环己基)乙基三甲氧基硅烷、γ-环氧丙氧基丙基三甲氧基硅烷、γ-环氧丙氧基丙基甲基二乙氧基硅烷等。
作为离子捕捉剂,例如,可列举出水滑石类、氢氧化铋、苯并三唑等。
作为上述其他添加剂,可以仅采用1种或采用2种以上。
对于芯片接合层10,从容易调整弹性及粘性的方面出发,优选包含热塑性树脂(特别是丙烯酸类树脂)、热固化性树脂、及填料。
芯片接合层10中,丙烯酸类树脂等热塑性树脂相对于除填料以外的有机成分的总质量的含有比例优选为30质量%以上且70质量%以下、更优选为40质量%以上且60质量%以下、进一步优选为45质量%以上且55质量%以下。
相对于芯片接合层10的总质量,填料的含有比例优选为30质量%以上且70质量%以下、更优选为40质量%以上且60质量%以下、进一步优选为42质量%以上且55质量%以下。
芯片接合层10的厚度没有特别限定,例如为1μm以上且200μm以下。所述厚度的上限值优选为100μm、更优选为80μm。所述厚度的下限值优选为3μm、更优选为5μm。需要说明的是,芯片接合层10为层叠体的情况下,上述的厚度为层叠体的总厚度。
芯片接合层10的玻璃化转变温度(tg)优选为0℃以上、更优选为10℃以上。通过使上述玻璃化转变温度为0℃以上,从而能够通过冷扩展容易地将芯片接合层10割断。芯片接合层10的玻璃化转变温度的上限例如为100℃。
芯片接合层10例如如图1所示,可以具有单层结构。本说明书中,单层是指仅具有由同种组合物形成的层。由同种组合物形成的层层叠多层而成的形态也为单层。
另一方面,芯片接合层10例如可以具有由2种以上不同的组合物分别形成的层进行层叠而成的多层结构。
本实施方式的切割芯片接合薄膜1在使用时,通过照射紫外线来使粘合剂层22固化。详细而言,在半导体晶圆粘接于一个面的芯片接合层10与贴合于该芯片接合层10的另一面的粘合剂层22层叠的状态下,至少对粘合剂层22照射紫外线。例如,从配置基材层21侧照射紫外线,经过了基材层21的紫外线到达粘合剂层22。通过紫外线的照射,粘合剂层22发生固化。
通过在照射后粘合剂层22发生固化,从而能够降低粘合剂层22的粘合力,因此能够在照射后比较容易地从粘合剂层22将芯片接合层10(粘接有半导体晶圆的状态)剥离。由此,能够发挥良好的拾取性。
紫外线的照射能量例如为50mj/cm2以上,优选为50mj/cm2以上且500mj/cm2以下、更优选为100mj/cm2以上且300mj/cm2以下。通常,除了粘合剂层22和芯片接合层10贴合的区域的边缘部之外,照射紫外线。进行局部照射的情况下,隔着形成有图案的掩模进行照射,由此能够设置未照射的区域。另外,可以进行点状照射来形成照射区域。
用于照射紫外线的装置没有特别限定,例如可以使用日东精机株式会社制造的制品名“um810”。
本实施方式的切割芯片接合薄膜1在使用前的状态下可以具备覆盖芯片接合层10的一个面(芯片接合层10的不与粘合剂层22重叠的面)的剥离片。剥离片是为了保护芯片接合层10而使用的,在即将将被粘物(例如半导体晶圆)贴附于芯片接合层10之前被剥离。
作为该剥离片,可以采用与上述的剥离片同样的剥离片。该剥离片可以作为用于支撑芯片接合层10的支撑材料来利用。剥离片在将芯片接合层10重叠于粘合剂层22上时适合使用。详细而言,可以在剥离片与芯片接合层10层叠的状态下使芯片接合层10与粘合剂层22重叠,重叠后将剥离片剥离(转印),由此在粘合剂层22上重叠芯片接合层10。
本实施方式的切割芯片接合薄膜1由于以如上方式来构成,因此能够抑制半导体芯片的浮起,能够发挥良好的拾取性。
接着,对本实施方式的切割带20及切割芯片接合薄膜1的制造方法进行说明。
本实施方式的切割芯片接合薄膜1的制造方法具备:
制造切割带20的工序(切割带的制造方法)、和在制造的切割带20上重叠芯片接合层10来制造切割芯片接合薄膜1的工序。
切割带的制造方法(制造切割带的工序)具备:
在溶剂存在下合成丙烯酸类聚合物的合成工序;
粘合剂层制作工序,从包含前述丙烯酸类聚合物、异氰酸酯化合物、聚合引发剂、和根据目的适宜追加的其他成分的粘合剂组合物中使溶剂挥发而制作粘合剂层22;和
层叠工序,使粘合剂层22和基材层21贴合,由此将基材层21和粘合剂层22层叠。
在合成工序中,例如,使(甲基)丙烯酸烷基酯单体与含羟基(甲基)丙烯酸酯单体进行自由基聚合,由此合成丙烯酸类聚合物中间体。
自由基聚合可以通过通常的方法来进行。例如,可以使上述的各单体溶解于溶剂并且边加热边进行搅拌,添加聚合引发剂,由此合成丙烯酸类聚合物中间体。为了调整丙烯酸类聚合物的分子量,也可以在链转移剂的存在下进行聚合。
接着,使丙烯酸类聚合物中间体中所含的含羟基(甲基)丙烯酸酯的构成单元的一部分羟基与含异氰酸酯基的聚合性单体的异氰酸酯基通过氨基甲酸酯化反应进行键合。由此,含羟基(甲基)丙烯酸酯的构成单元的一部分形成为含聚合性基团的(甲基)丙烯酸酯的构成单元。
氨基甲酸酯化反应可以通过通常的方法来进行。例如,在溶剂及氨基甲酸酯化催化剂的存在下,边加热边对丙烯酸类聚合物中间体和含异氰酸酯基的聚合性单体进行搅拌。由此,能够使丙烯酸类聚合物中间体的羟基的一部分与含异氰酸酯基的聚合性单体的异氰酸酯基进行氨基甲酸酯键合。
需要说明的是,为了有效地进行氨基甲酸酯化反应,可以在sn催化剂等的存在下进行氨基甲酸酯化反应。
粘合剂层制作工序中,例如,将含有丙烯酸类聚合物和溶剂的液体、异氰酸酯化合物、和聚合引发剂混合,制备粘合剂组合物。通过使溶剂的量变化,从而能够调整组合物的粘度。接着,将粘合剂组合物涂布于剥离片。作为涂布方法,例如,采用辊涂覆、丝网涂覆、凹版涂覆等通常的涂布方法。对经涂布的组合物实施脱溶剂处理、固化处理等,由此使经涂布的粘合剂组合物固化,制作粘合剂层22。
脱溶剂处理例如可以在80℃以上且150℃以下、0.5分钟以上且5分钟以下的条件下进行。
层叠工序中,将与剥离片重叠的状态的粘合剂层22和基材层21重叠而进行层叠。需要说明的是,剥离片在直到使用前为止可以为与粘合剂层22重叠的状态。
需要说明的是,为了促进交联剂与丙烯酸类聚合物的反应,另外,为了促进交联剂与基材层21的表面部分的反应,在层叠工序之后可以在50℃环境下实施48小时的熟化处理工序。
需要说明的是,基材层21可以使用市售的薄膜等,也可以通过通常的方法进行制膜来制作。作为进行制膜的方法,例如,可列举出压延制膜法、有机溶剂中的浇铸法、密闭体系中的吹胀挤出法、t模挤出法、共挤出法、干式层压法等。
通过这些工序,能够制造切割带20。
切割芯片接合薄膜的制造方法(制造切割芯片接合薄膜的工序)具备如下工序:
芯片接合用组合物制备工序,制备用于形成芯片接合层10的芯片接合用组合物;
芯片接合层制作工序,由芯片接合用组合物制作芯片接合层10;和
贴附工序,在如上所述而制造的切割带20的粘合剂层22上贴附芯片接合层10。
芯片接合用组合物制备工序中,例如通过将树脂、填料、固化催化剂、及溶剂等混合来制备芯片接合用组合物。可以通过改变溶剂的量来调整组合物的粘度。
芯片接合层制作工序中,例如,将如上所述而制备的树脂组合物涂布于剥离片。作为涂布方法,没有特别限定,例如,可以采用辊涂覆、丝网涂覆、凹版涂覆等通常的涂布方法。接着,根据需要,通过脱溶剂处理、固化处理等,使涂布的组合物固化,制作芯片接合层10。
脱溶剂处理例如可以在70℃以上且160℃以下、1分钟以上且5分钟以下的条件下进行。
贴附工序中,从切割带20的粘合剂层22及芯片接合层10分别将剥离片剥离,以芯片接合层10与粘合剂层22直接接触的方式使两者贴合。例如,可以通过进行压接来贴合。贴合时的温度没有特别限定,例如,为30℃以上且50℃以下,优选为35℃以上且45℃以下。贴合时的线压没有特别限定,优选为0.1kgf/cm以上且20kgf/cm以下、更优选为1kgf/cm以上且10kgf/cm以下。
通过这些工序,能够制造切割芯片接合薄膜1。
如上所述地制造的切割芯片接合薄膜1例如作为用于制造半导体集成电路的辅助用具而使用。以下,对使用中的具体例进行说明。
制造半导体集成电路的方法通常具备从形成有电路面的半导体晶圆将芯片切出并进行组装的工序。
该工序例如具有如下工序:半切割工序,为了通过割断处理将半导体晶圆加工为芯片(die)而用金刚石刀片在半导体晶圆上形成槽,进而对半导体晶圆进行磨削而减薄厚度;安装工序,将经半切割加工的半导体晶圆(可割断的状态的半导体晶圆)的一面(例如与电路面处于相反侧的面)贴附于芯片接合层10,将半导体晶圆固定于切割带20;扩展工序,将可割断的状态的半导体晶圆及芯片接合层10割断,进而使通过割断得到的半导体芯片彼此的间隔扩大;拾取工序,将芯片接合层10与粘合剂层22之间剥离并在贴附有芯片接合层10的状态下取出半导体芯片(die);和芯片接合工序,将贴附有芯片接合层10的状态的半导体芯片(die)粘接于被粘物。实施这些工序时,本实施方式的切割带(切割芯片接合薄膜)作为制造辅助用具来使用。
半切割工序中,如图2的a~图2的d所示,实施用于将半导体集成电路割割成小片(die)的半切割加工。详细而言,在半导体晶圆w的与电路面处于相反侧的面贴附晶圆加工用带t。另外,将切割环r安装于晶圆加工用带t。在贴附有晶圆加工用带t的状态下形成分割用的槽。在形成有槽的面贴附背面研磨带g,另外将开始贴附的晶圆加工用带t剥离。在贴附有背面研磨带g的状态下实施磨削加工直至半导体晶圆w成为规定的厚度为止。
安装工序中,如图3的a~图3的b所示,将切割环r安装于切割带20的粘合剂层22后,在露出的芯片接合层10的面贴附可割断的状态的半导体晶圆w。然后,从半导体晶圆w将背面研磨带g剥离。
扩展工序中,如图4的a~图4的c所示,将切割环r固定于扩展装置的保持件h。使扩展装置所具备的顶起构件u自切割芯片接合薄膜1的下侧顶起,由此在低温下对切割芯片接合薄膜1进行拉伸使得其在面方向上扩展(冷扩展工序)。由此,将可割断的状态的半导体晶圆w及芯片接合层10割断。冷扩展工序的温度条件例如为-20~5℃,优选为-15~0℃、更优选为-10~-5℃。使顶起构件u下降,由此将扩展状态解除。进而,扩展工序中,如图5的a~图5的b所示,在比冷扩展工序更高的温度条件下(例如10℃以上的温度)对切割带20进行拉伸以使面积扩大(热扩展工序)。由此,使相邻的半导体芯片c在薄膜面的面方向分离,进一步使间隔扩大。
拾取工序中,如图6所示,将贴附有芯片接合层10的状态的半导体芯片c从切割带20的粘合剂层剥离。详细而言,使销构件p上升,从而将拾取对象的半导体芯片隔着切割带20顶起。将顶起的半导体芯片用吸附夹具j保持。
芯片接合工序中,将贴附有芯片接合层10的状态的半导体芯片粘接于被粘物。
本说明书公开的事项包含以下事项。
(1)
一种切割带,其具备:基材层、和层叠于该基材层的粘合剂层,
前述粘合剂层含有具有聚合性不饱和键的紫外线固化型的聚合性聚合物,
前述粘合剂层的紫外线固化的差示扫描量热测定中的每单位质量的发热量为19mj/mg以上。
(2)
根据上述(1)所述的切割带,其中,前述差示扫描量热测定中的发热峰的每单位质量的峰顶的值超过0.7mw/mg,
前述差示扫描量热测定中的从紫外线照射开始到直至前述峰顶为止的时间为1.0分钟以下。
(3)
根据上述(1)或(2)所述的切割带,其中,将sus板贴合于前述粘合剂层时的前述粘合剂层与前述sus板间的180°剥离强度为0.30n/20mm以上。
(4)
根据上述(1)~(3)中任一项所述的切割带,其中,将sus板贴合于前述粘合剂层并对前述粘合剂层照射紫外线后的前述粘合剂层与前述sus板间的180°剥离强度不足0.20n/20mm。
(5)
根据上述(1)~(4)中任一项所述的切割带,其中,将sus板贴合于前述粘合剂层时的前述粘合剂层与前述sus板间的180°剥离强度满足下述式(1)。
紫外线照射后的前述180°剥离强度/紫外线照射前的前述180°剥离强度<0.28···(1)
(6)
根据上述(1)~(5)中任一项所述的切割带,其中,前述聚合性聚合物含有聚合性丙烯酸类聚合物。
(7)
一种切割芯片接合薄膜,其具备:上述(1)~(6)中任一项所述的切割带、和层叠于该切割带的前述粘合剂层的芯片接合层。
需要说明的是,本发明的切割带及切割芯片接合薄膜不限定于上述实施方式。另外,本发明的切割带及切割芯片接合薄膜不受上述作用效果限定。进而,本发明的切割带及切割芯片接合薄膜可以在不脱离本发明的主旨的范围内进行各种变更。
例如,本实施方式中,作为贴附于芯片接合层的半导体晶圆,使用可割断的状态的半导体晶圆,在冷扩展工序中,将可割断的状态的半导体晶圆及芯片接合层割断,但在本发明中,也可以使用经割断的半导体晶圆作为贴附于芯片接合层的半导体晶圆,在冷扩展工序中仅将芯片接合层割断。
需要说明的是,对于在冷扩展工序中将半导体晶圆与芯片接合层一起割断的情况,与仅将芯片接合层割断的情况相比,在扩展工序(冷扩展工序及热扩展工序)中必须对切割带进行更多的拉伸,因此容易发挥本发明的效果。
另外,本发明中,可以通过对半导体晶圆中的预分割线照射激光来在半导体晶圆内形成改性区域(脆弱化区域),从而得到前述可割断的状态的半导体晶圆。
实施例
接着,举出实施例及比较例更具体地对本发明进行说明。
如下制造切割带。另外,使用该切割带,制造切割芯片接合薄膜。
<(甲基)丙烯酸类单体>
“第1合成阶段”
·含羟基丙烯酸酯单体:丙烯酸2-羟基乙酯(2-hydroxyethylacrylate)(hea)
·丙烯酸烷基酯单体:丙烯酸乙酯(ethylacrylate)(ea)
·丙烯酸烷基酯单体:丙烯酸丁酯(buthylacrylate)(ba)
·丙烯酸烷基酯单体:丙烯酸2-乙基己酯(2-ethylhexylacrylate)(2eha)
·丙烯酸烷基酯单体:丙烯酸异壬酯(isononylacrylate)(ina)
·丙烯酸烷基酯单体:丙烯酸月桂酯(laurylacrylate)(la)
·丙烯酸酯单体:4-丙烯酰基吗啉(4-acryloylmoropholine)(制品名“acmo”)
“第2合成阶段”
·聚合性丙烯酸酯单体:甲基丙烯酸2-异氰酸根合乙酯(2-isocyanatoethylmethacrylate)(制品名“moi”)
<切割带的原料>
·粘合剂层
前述(甲基)丙烯酸类单体
热聚合引发剂:偶氮双异丁腈(aibn)
有机溶剂:乙酸乙酯
有机溶剂:甲苯
异氰酸酯化合物:
甲苯二异氰酸酯的三羟甲基丙烷加成物的乙酸乙酯溶液
(制品名“coronatel”东曹株式会社制)
光聚合引发剂(制品名“omnirad127”igmresins公司制)
光聚合引发剂(制品名“omnirad2959”igmresins公司制)
(实施例1)
如下合成丙烯酸类聚合物中间体后,由丙烯酸类聚合物中间体合成丙烯酸类聚合物。使用合成的丙烯酸类聚合物来制作粘合剂层,制造切割带。
<第1合成阶段:丙烯酸类聚合物中间体的合成>
准备在1l圆底可拆式烧瓶(以下也简称为“烧瓶”。)上装备有可拆式盖、分液漏斗、温度计、氮气导入管、李比希冷凝器、真空密封装置(vacuumseal)、搅拌棒、搅拌羽叶片的聚合用实验装置。
接着,将下述表1的(甲基)丙烯酸类单体以下述表1的配方比例放入前述烧瓶中,并且放入热聚合引发剂(相对于第1合成阶段中使用的聚合性(甲基)丙烯酸类单体100质量份为0.2质量份)及乙酸乙酯,得到混合物(乙酸乙酯相对于第1合成阶段中使用的(甲基)丙烯酸类单体和乙酸乙酯的合计(100质量%)的含有比例:38质量%),在氮气的气流中于62℃对混合物进行6小时搅拌(聚合处理),得到含丙烯酸类聚合物中间体的溶液。
<第2合成阶段:丙烯酸类聚合物的合成>
将下述表1的(甲基)丙烯酸类单体以下述表1的配方比例放入含丙烯酸类聚合物中间体的溶液中,并且加入二月桂酸二丁基锡(相对于第1合成阶段中使用的(甲基)丙烯酸类单体100质量份为0.07质量份),得到混合物,在空气的气流中于50℃对混合物进行12小时搅拌(加成反应处理),制备含丙烯酸类聚合物的溶液。
<粘合剂层用组合物的制备>
将相对于丙烯酸类聚合物(粘合剂层用组合物的固体成分)100质量份为下述表2所示的量的交联剂及光聚合引发剂混合在含丙烯酸类聚合物的溶液中,制备粘合剂层用组合物。
<粘合剂层的制作>
作为剥离片,准备pet系薄膜。对该薄膜的单面用有机硅实施了脱模处理。在实施了脱模处理的剥离片的面涂布如上所述而制备的粘合剂层用组合物。对涂布的组合物在剥离片上于120℃进行2分钟加热(干燥处理),制作厚度10μm的粘合剂层。
<切割带的制作>
在粘合剂层与剥离片重叠的状态下,以不混入气泡的方式将粘合剂层贴合于基材层(聚烯烃薄膜(制品名“funcrarened#125”gunzelimited制)、厚度:125μm)的电晕处理面,在50℃下进行24小时的加热(干燥处理),制作切割带。
<芯片接合薄膜的制作>
使用下述的原料,如下制作芯片接合薄膜。
丙烯酸类树脂:100质量份
(制品名“teisanresinsg-p3”、nagasechemtexcorporation制、玻璃化转变温度12℃、含环氧基)
酚醛树脂:12质量份
(制品名“meh-7851ss”、明和化成株式会社制、联苯酚醛清漆树脂)
球状二氧化硅:100质量份
(制品名“so-25r”、admatechsco.,ltd.制、平均粒径:500μm)
将上述的原料和甲乙酮混合,制备固体成分浓度20质量%的树脂组合物。
作为剥离片,准备pet系薄膜。对该薄膜的单面用有机硅实施例脱模处理。在实施了脱模处理的剥离片的面涂布前述树脂组合物,在130℃下进行2分钟加热而使溶剂挥发,在剥离片上制作厚度10μm的芯片接合薄膜。
<切割芯片接合薄膜的制作>
将芯片接合薄膜层叠于切割带的粘合剂层,制作具有芯片接合层的切割芯片接合薄膜。
(实施例2、3)
将(甲基)丙烯酸类单体设为下述表1的配方,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
(实施例4)
将(甲基)丙烯酸类单体设为下述表1的配方且将二月桂酸二丁基锡的量设为相对于第1合成阶段中使用的(甲基)丙烯酸类单体100质量份为0.13质量份,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
(实施例5)
将(甲基)丙烯酸类单体设为下述表1的配方、将第1合成阶段中的62℃下的搅拌时间设为8小时、且将交联剂设为下述表2的配方比例,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
(实施例6)
将(甲基)丙烯酸类单体设为下述表1的配方且使用下述表2的光聚合引发剂,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
(比较例1)
将(甲基)丙烯酸类单体设为下述表1的配方且将二月桂酸二丁基锡的量设为相对于第1合成阶段中使用的(甲基)丙烯酸类单体100质量份为0.04质量份,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
(比较例2)
将(甲基)丙烯酸类单体设为下述表1的配方且将二月桂酸二丁基锡的量设为相对于第1合成阶段中使用的(甲基)丙烯酸类单体100质量份为0.02质量份,除此以外,与实施例1同样地操作,制作切割带及切割芯片接合薄膜。
[表1]
[表2]
(dsc曲线)
仅取出切割带的粘合剂层,使用下述紫外线照射装置、下述测定装置,利用紫外线使该粘合剂层固化并测定反应热。
<紫外线照射装置>
紫外线照射光源装置pdc-121(山下电装株式会社制)
灯:汞氙灯(hg-xe200w)
干涉滤波器:不使用
发射波长:250nm~500nm
<测定装置>
exstar6000(siinanotechnologyinc.制)
<测定方法>
将装有样品(粘合剂层)的皿(pan)和参考(reference)的空皿设置于测定装置,进行等温设定以成为设定的气氛温度(25℃),温度及热量稳定后开始样品的测定。
样品的测定按照以下的步骤来进行。
步骤1:设定气氛温度25℃、0.2分钟
步骤2:设定气氛温度25℃、紫外线照射(紫外线照度:70mw/cm2)、10分钟
步骤3:设定气氛温度25℃、0.2分钟
在样品的测定后,不取出样品而直接进行等温设定,温度及热量稳定后开始参考的测定。
参考的测定按照以下的步骤来进行。
步骤1:设定气氛温度25℃、0.2分钟
步骤2:设定气氛温度25℃、紫外线照射(紫外线照度:70mw/cm2)、10分钟
步骤3:设定气氛温度25℃、0.2分钟
需要说明的是,边供给氮气边在氮气气氛下进行样品的测定及参考的测定。
另外,以紫外线大致垂直于粘合剂层的面的方式来照射紫外线。即,对粘合剂层的面以紫外线照度70mw/cm2照射紫外线。
<解析方法>
用上述测定结果求出表3的各参数。
具体而言,首先,在exstar6000的软件dscsub上,从样品的测定数据减去参考的测定数据,求出仅样品的热量数据(dsc曲线(横轴:时间、纵轴:每单位时间的发热量))。
然后,对该减去后的dsc曲线,使用解析软件musejobs求出前述粘合剂层的紫外线固化的差示扫描量热测定中的每单位质量的发热量(mj/mg)、该差示扫描量热测定的发热峰的每单位质量的峰顶的值(mw/mg)、该差示扫描量热测定中的从紫外线照射开始到直至前述峰顶为止的时间(分钟)。
将各参数示于下述表3。
需要说明的是,发热量采用dsc曲线中的从固化反应开始到直至固化反应结束为止的每单位时间的发热量的积分值。另外,固化反应开始设为dsc曲线中的紫外线照射后的峰的升高的部分,固化反应结束设为反应热几乎消失的部分。进而,发热峰的每单位质量的峰顶的值是指dsc曲线的每单位质量、单位时间的发热量的峰顶的值。
(紫外线固化前的粘合剂层与sus板间的180°剥离强度)
用切割刀将切割带切出为长度100mm、宽度20mm的长条状。
另外,用甲苯对比切出的前述切割带大的sus304ba板进行超声波清洗,使其自然干燥。
接着,用手压辊(2kg)使切出的前述切割带的粘合剂层侧与经自然干燥的前述sus304ba板贴合而得到层叠体。需要说明的是,此时不让气泡混入粘合剂层与sus304ba板间。
然后,将该层叠体在常温下保存30分钟。
接着,使用该层叠体和拉伸试验机(shimadzu公司制的autographag-is),对粘合剂层与sus板间的180°剥离强度(以下也称为“紫外线固化前的剥离强度”。)进行测定。
关于测定条件,将温度设为23℃、速度设为300mm/分钟,进行测定直到冲程为50mm~80mm为止。
将测定值示于下述表3。
(紫外线固化后的粘合剂层与sus板间的180°剥离强度)
在30分钟的常温保存后且剥离强度的测定前,使用紫外线照射装置(日东精机株式会社制的um-810、光源:高压汞灯、紫外线照射强度:65mw/cm2)从切割带侧对层叠体照射紫外线,除此以外,通过与上述“(紫外线固化前的粘合剂层与sus板间的180°剥离强度)”中记载的方法同样的方法测定粘合剂层与sus板间的180°剥离强度(以下也称为“紫外线固化后的剥离强度”。)。
需要说明的是,对于紫外线的照射,进行照射直到粘合剂层充分固化为止(照射量:300mj/cm2)。
将测定值示于下述表3。
(保持性评价试验)
在以扩展后成为10mm×10mm的尺寸的方式进行了基于激光的前处理的半导体晶圆
接着,将厚度30μm的半导体晶圆与切割芯片接合薄膜的芯片接合层层叠,在50~80℃之间进行加热使其贴合,得到带半导体晶圆的切割芯片接合薄膜。
对带半导体晶圆的切割芯片接合薄膜,使用discocorporation制的芯片分离装置dds2300,将半导体晶圆及芯片接合层割断,使切割带热收缩。
具体而言,首先,将带半导体晶圆的切割芯片接合薄膜保持在切割环。
然后,以冷扩展单元在扩展温度-15℃、扩展速度200mm/秒、扩展量11mm的条件下进行冷扩展,将半导体晶圆及芯片接合层割断,得到带芯片接合薄膜的半导体芯片。
接着,以热扩展单元在室温下、扩展速度1mm/秒、扩展量7mm的条件下进行常温扩展。然后,在维持扩展状态下在加热温度200℃、风量40l/分钟、加热距离20mm、旋转速度3°/秒的条件下使半导体芯片的外周部分的切割带热收缩。
在切割芯片接合薄膜被保持于切割环的状态下从切割带侧观察带芯片接合薄膜的半导体芯片,按照以下的评价基准评价保持性。
〇:未确认到自切割带明显浮起的带芯片接合薄膜的半导体芯片的情况
×:确认到自切割带明显浮起的带芯片接合薄膜的半导体芯片的情况
将结果示于下述表3。
(拾取性评价试验)
上述“(保持性评价试验)”的热收缩后,使用前述芯片分离装置dds2300中附带的紫外线照射单元,对切割带从基材层侧照射紫外线(照射量:300mj/cm2),使粘合剂层充分固化,然后,在室温下放置1天。
然后,使用芯片焊接机(diebonder)spa-300(新川株式会社制),在以下的条件下进行拾取,按照以下的评价基准评价拾取性。
“拾取条件”
销数:5
顶起速度:1mm/秒
拾取高度:350μm
拾取评价对象的带芯片接合薄膜的半导体芯片的数量:50个
“评价基准”
◎:拾取成功率为100%的情况
〇:拾取成功率为90%以上且不足100%的情况
×:拾取成功率不足90%的情况
将结果示于下述表3。
[表3]
如表3所示,对于实施例1~6,与每单位质量的发热量为18mj/mg以下的比较例1、2的情况相比,保持性及拾取性优异。
因此可知,根据本发明,可提供能抑制浮起、并且拾取性优异的切割带及切割芯片接合薄膜。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询



 商标分类
商标分类  商标转让
商标转让 



