减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法及卤化物气相外延生长系统与流程
 2021-01-30 19:01:28|
2021-01-30 19:01:28| 321|
321| 起点商标网
起点商标网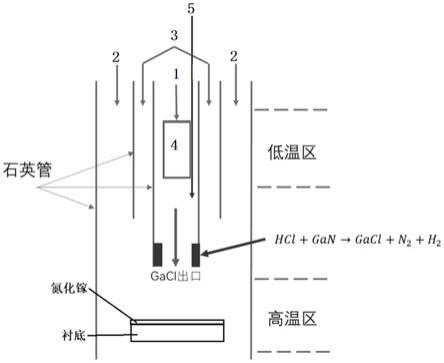
[0001]
本发明涉及到一种卤化物气相外延生长系统的气路系统、卤化物气相外延生长系统以及减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,属于半导体材料技术领域。
背景技术:
[0002]
以gan及ingan、algan合金材料为主的iii-v族氮化物材料(又称gan基材料)是近几年来国际上倍受重视的新型半导体材料。
[0003]
gan基材料的生长有很多种方法,如金属有机物气相外延(mocvd)、高温高压合成体gan单晶、分子束外延(mbe)、升华法以及卤化物气相外延(hvpe)等。由于gan基材料本身物理性质的限制,gan体单晶的生长具有很大的困难,尚未实用化。卤化物气相外延由于具有高的生长率和横向-纵向外延比,可用于同质外延生长自支撑gan衬底,引起广泛地重视和研究。
[0004]
由于hvpe系统内部结构、气流输运等的限制,大面积(>2英寸)gan基材料生长的均匀性仍需要进一步研究改进。在立式hvpe生长系统中,由于反应腔体可以设计成轴对称的,气体的输运系统远比卧式系统更容易并且更均匀,最终生长得到的材料厚度也更均匀。不断改进立式hvpe生长系统对于gan基材料的生长具有重要意义。在立式hvpe系统中,由于氨气和gacl的预反应,会堵塞管路,造成gacl反应气体输运的终止,而阻碍了反应的进一步进行。本发明设计的立式hvpe系统针对上述问题提出了创新性方法,由于可以持续运行,除了基本应用外,可以专用于厘米级大尺寸gan体单晶材料的长时间生长。
[0005]
卤化物气相外延系统原理图如图1所示,图1中为立式hvpe,气流从上往下或者反过来设置,卧式hvpe系统原理相同,只是气流方向为水平方式流动。所有hvpe系统均由两个主要温区组成,低温区用于生成氯化镓(gacl),高温区用于氯化镓和氨气反应生成氮化镓(gan)。由于反应室中存在强腐蚀性氯化氢气体,且反应在高温下进行,hvpe反应室为石英管结构。
[0006]
hvpe方法生长氮化镓的基本反应如下:
[0007][0008]
gacl+nh
3
→
gan+hcl+h
2
ꢀꢀꢀ
高温区
[0009]
由于在低温区生成氯化镓的反应是歧化反应,通常hvpe系统需设计为热壁反应,整个反应室内部和衬底均需保持高温。由于各种气体的扩散作用,环境高温会导致氮化镓不仅仅在衬底上生长,也会在整个反应室内壁外延,特别是在gacl出口处石英管内壁沉积严重(此处gacl浓度最高),gan的不断沉积会造成管口缩小甚至阻塞,降低了衬底上方gacl的浓度,从而影响gan外延的生长速率、均匀性和质量。
技术实现要素:
[0010]
本发明的目的是提供一种卤化物气相外延生长系统的气路系统,可有效减缓gan在gacl出口处石英管内壁沉积的现象。
[0011]
本发明采取的技术方案为:
[0012]
一种卤化物气相外延生长系统的气路系统,包括第一hcl导管,n
2
导管和nh
3
导管,所述第一hcl导管通到镓舟处,其特征在于:还包括第二hcl导管,通到接近gacl出口处的位置。
[0013]
本发明还公开了一种卤化物气相外延生长系统,包括腔体管和气路系统,其气路系统为上述的卤化物气相外延生长系统的气路系统。
[0014]
本发明还公开了一种减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,一路hcl通入镓舟,与镓舟反应生成gacl,其特征在于:再通入一路hcl到接近gacl出口处的位置,与gacl混合后,输运至衬底处。该位置大概在gacl出口处往内1~3cm处,该处沉积的gan最多,通至该处以便hcl与gan反应。
[0015]
优选的,通入接近gacl出口处的hcl流量与通入镓舟处的hcl流量比为1:1~4。
[0016]
本发明在镓舟区域增加一路hcl通到接近gacl出口处,与低温区反应后的gacl混合,再进行输运。该hcl与gacl混合气体通过出口处的石英管时,其中的hcl会与管壁上预反应沉积的gan发生腐蚀反应,减缓管壁沉积,从而不会因管内径缩小导致生长速率和均匀性大幅下降。腐蚀反应生成产物为gacl,也会提高输运到衬底上方的反应物浓度,保持衬底上gan生长的长时间高稳定速率,并且提高镓利用率。腐蚀反应产物中除了gacl外,也有氢气(h
2
),以及未反应完全的hcl。在输运到衬底上方过程中,hcl会与空间反应生成的gan微粒进一步发生腐蚀,减少落到衬底上的gan晶粒,从而提高了gan晶体质量。上述反应也会改变衬底表面gacl的局域过饱和浓度,有助于晶体质量的改善。
附图说明
[0017]
图1为现有技术的卤化物气相外延生长系统内部气体输运结构示意图。
[0018]
图2为本发明的卤化物气相外延生长系统内部气体输运结构示意图。
具体实施方式
[0019]
本发明的卤化物气相外延生长系统的反应腔体由腔体管和多支气体导管组成,气体导管位于腔体管的入口部份,用于将反应气体送至生长区的外延生长衬底处,加热系统采用电阻炉或者射频加热方式均可。卤化物气相外延生长系统为双温区结构,分为金属源区(低温区)和生长区(高温区)。hcl和金属源反应,生成的气体产物进入生长区,在衬底表面和nh
3
混合发生反应,形成gan。尾气及反应尘埃通过抽气系统抽出。金属源区温度从500-1000℃(生长gan时温度一般为850-900℃),生长区温度从450-1100℃(生长gan时温度一般为1000-1100℃)。载气气体导管在周围分布。载气采用氮气或者氩气或者氢气及氢气和氮气混合气体。
[0020]
本发明反应腔体采用石英管结构,如图1所示。氨气和氯化镓气体出口采用轴对称结构,水平面中心对称于中轴线两侧。反应腔压力保持在0.1-1个大气压。本发明中的生长反应为热壁反应,氨气和gacl气体通过扩散进行预混合会造成空间反应,这种预先反应形
成的gan在gacl管路口沉积,会降低gacl输运到衬底的浓度从而降低生长速率。在gacl口沉积的gan也会堵塞该管口,造成生长区衬底上gan生长的终止。
[0021]
本发明通过添加一路hcl先与gacl混合,在输运过程中到达gacl管口,hcl与gan发生腐蚀反应,消除部分沉积的gan,从而减缓在此处的gan沉积。未完全反应的氯化氢在输运至衬底表面的过程中,也会和空间中预反应的gan晶粒发生腐蚀反应,降低晶粒在衬底表面的沉积,从而提高晶体质量。腐蚀用hcl与通入镓舟的hcl流量比从1:4到1:1变化。
[0022]
实施例1
[0023]
一种卤化物气相外延生长系统,包括生长区和气路系统,其中气路系统包括第一hcl导管1,n
2
导管2和nh
3
导管3,所述第一hcl导管1通到镓舟4处,其特征在于:还包括第二hcl导管5,通到接近gacl出口处的位置。
[0024]
实施例2
[0025]
一种减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,其步骤包括:
[0026]
1、蓝宝石衬底的清洗和处理。
[0027]
2、蓝宝石衬底放入反应器中后,缓慢升温至生长温度,即可开始生长gan。生长温度1100℃。气体流量分别:nh
3
流量为1500sccm,nh
3
载气流量为1000sccm,第一hcl导管1的hcl流量为20sccm,hcl载气流量为500sccm,第二hcl导管5的腐蚀用hcl流量为5sccm,其载气为500sccm。总氮气为15000sccm。样品为2英寸蓝宝石衬底。反应腔体压力1个大气压。
[0028]
3、生长到合适的时间后,按照一定的速率缓慢降至室温,取出样品。本实施例中生长时间约为60分钟,生长速率为120微米/小时。
[0029]
4、观察gacl石英管口位置,gan略有沉积,厚度约500微米。
[0030]
实施例3
[0031]
一种减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,其步骤包括:
[0032]
1、蓝宝石衬底的清洗和处理。
[0033]
2、蓝宝石衬底放入反应器中后,缓慢升温至生长温度,即可开始生长gan。生长温度1050℃。气体流量分别:nh
3
流量为1500sccm,nh
3
载气流量为1000sccm,第一hcl导管1的hcl流量为20sccm,hcl载气流量为500sccm,第二hcl导管5的腐蚀用hcl流量为10sccm,其载气为500sccm。总氮气为15000sccm。样品为2英寸蓝宝石衬底。反应腔体压力1个大气压。
[0034]
3、生长到合适的时间后,按照一定的速率缓慢降至室温,取出样品。本实施例中生长时间约为60分钟,生长速率为100微米/小时。
[0035]
4、观察gacl石英管口位置,gan略有沉积,厚度约300微米。
[0036]
实施例4
[0037]
一种减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,其步骤包括:
[0038]
1、蓝宝石衬底的清洗和处理。
[0039]
2、蓝宝石衬底放入反应器中后,缓慢升温至生长温度,即可开始生长gan。生长温度1000℃。气体流量分别:nh
3
流量为1500sccm,nh
3
载气流量为1000sccm,第一hcl导管1的hcl流量为20sccm,hcl载气流量为500sccm,第二hcl导管5的腐蚀用hcl流量为15sccm,其载气为500sccm。总氮气为15000sccm。样品为2英寸蓝宝石衬底。反应腔体压力1个大气压。
[0040]
3、生长到合适的时间后,按照一定的速率缓慢降至室温,取出样品。本实施例中生长时间约为60分钟,生长速率约为100微米/小时。
[0041]
4、观察gacl石英管口位置,gan略有沉积,厚度约100微米。
[0042]
实施例5
[0043]
一种减缓卤化物气相外延生长系统中管壁沉积氮化镓的方法,其步骤包括:
[0044]
1、蓝宝石衬底的清洗和处理。
[0045]
2、蓝宝石衬底放入反应器中后,缓慢升温至生长温度,即可开始生长gan。生长温度1050℃。气体流量分别:nh
3
流量为1500sccm,nh
3
载气流量为1000sccm,第一hcl导管1的hcl流量为20sccm,hcl载气流量为500sccm,第二hcl导管5的腐蚀用hcl流量为20sccm,其载气为500sccm。总氮气为15000sccm。样品为2英寸蓝宝石衬底。反应腔体压力1个大气压。
[0046]
3、生长到合适的时间后,按照一定的速率缓慢降至室温,取出样品。本实施例中生长时间约为60分钟,生长速率约为100微米/小时。
[0047]
4、观察gacl石英管口位置,gan略有沉积,厚度低于100微米。
[0048]
蓝宝石衬底可替换成其他生长gan用的常规衬底例如si或sic,nh
3
流量、n
2
流量、第一hcl导管1的hcl流量以及相应的载气流量也可以根据生长gan的实际需要进行调整,保证腐蚀用hcl与通入镓舟的hcl流量比在1:4到1:1的范围内即可实现减缓gan在gacl出口处石英管内壁沉积的目的。
[0049]
上述实施例为本发明较佳的实施方式,但本发明的实施方式并不受上述实施例的限制,其他的任何未背离本发明的精神实质与原理下所作的改变、修饰、替代、组合、简化,均应为等效的置换方式,都包含在本发明的保护范围之内。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询

tips


 商标分类
商标分类  商标转让
商标转让 



