一种晶棒的制备方法和设备与流程
 2021-01-30 23:01:00|
2021-01-30 23:01:00| 251|
251| 起点商标网
起点商标网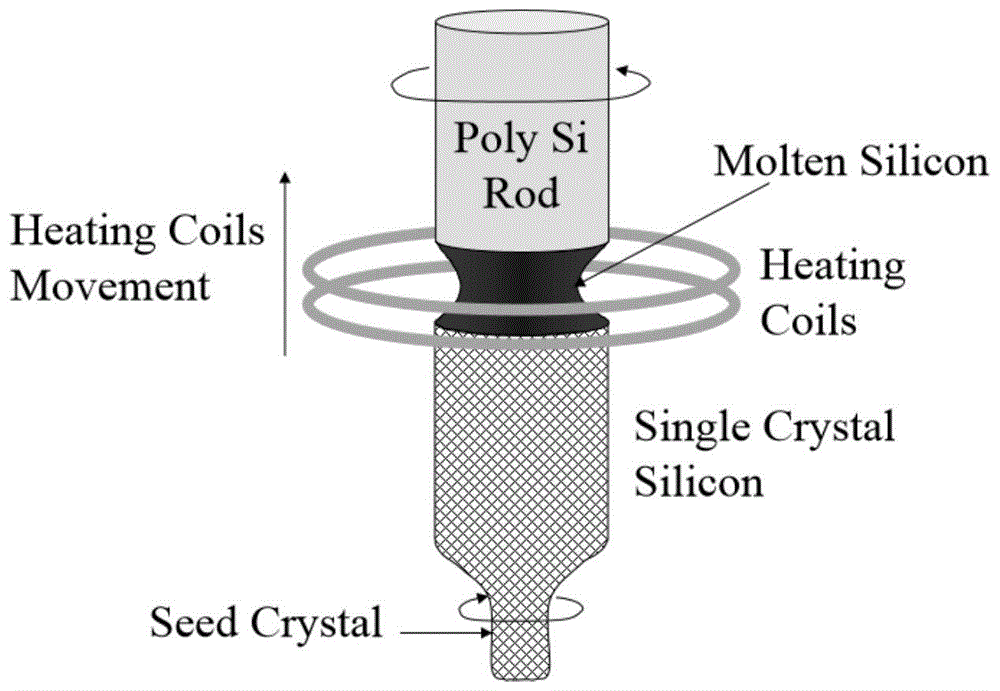
本发明涉及半导体技术领域,具体涉及一种晶棒的制备方法和设备。
背景技术:
在晶体制备技术中,通常使用直拉法或者区熔法制备晶体。
直拉法又称为切克劳斯基法,它是1918年由切克劳斯基(czochralski)建立起来的一种晶体生长方法,简称cz法。cz法的特点是在一个直筒型的热系统汇总,用石墨电阻加热,将装在高纯度石英坩埚中的多晶硅熔化,然后将籽晶插入熔体表面进行熔接,同时转动籽晶,再反转坩埚,籽晶缓慢向上提升,经过引晶、放大、转肩、等径生长、收尾等过程,一支硅单晶就生长出来了。但是该方法需要坩埚,在制备过程中避免不了坩埚对晶体的污染,导致制备的晶体的纯度偏低。
附图1示意出现有技术中区熔法的制备过程,现用技术中的区熔法是利用热能在半导体棒料的一端产生一熔区,再熔接单晶籽晶。调节温度使熔区缓慢地向棒的另一端移动,通过整根棒料,生长成一根单晶,晶向与籽晶的相同。区熔生长技术的基本特点是样品的熔化部分是完全由固体部分支撑的,不需要坩埚。附图2示意出现有技术中区熔法的垂直于多晶半导体材料棒轴向的截面图,柱状的高纯多晶材料200固定于卡盘,一个金属线圈201在柱状多晶外围沿多晶长度方向缓慢移动,移动时在金属线圈中通过高功率的射频电流,射频功率激发的电磁场将在多晶柱中引起涡流,产生焦耳热,通过调整线圈功率,可以使得线圈内部的多晶柱线部分熔化,线圈移过后,熔料结晶为单晶。该方法能够消除来自坩埚的污染源,目前用于生产高纯度的单晶。
但是,现有技术中的区熔法制备用于生产小直径的单晶,其原因之一就是因为在大直径的多晶半导体材料棒在受到线圈的加热后,材料棒的熔化不均匀,导致了大面积的结晶受阻,无法形成均匀的大面积的单晶材料。
技术实现要素:
有鉴于此,本发明提供了一种晶棒制备的方法,以解决大面积制备单晶材料的问题。
一方面,所述晶体的制备方法包括:提供单晶籽晶体和多晶半导体材料棒,所述多晶半导体材料棒为圆心处具有一贯穿孔的圆环柱状结构;在所述多晶半导体材料棒外侧设置外部加热线圈;在所述贯穿孔内部设置内部加热装置;所述外部加热线圈和所述内部加热装置对所述多晶半导体材料棒进行加热,在所述单晶籽晶体和所述多晶半导体材料棒的第一端面之间产生熔融区;移动所述外部加热线圈和所述内部加热装置,所述熔融区随着所述外部加热线圈和所述内部加热装置移动,自所述半导体材料棒的所述第一端面向所述多晶半导体材料棒的与所述第一端面相对的第二端面移动,以完成结晶过程。
通过在多晶半导体材料棒内部设置内部加热装置,提高了材料棒的受热均匀度,提高熔融区的均匀性。其更有助于实现大横截面积的材料棒的更均匀的熔化。另一方面,由于热源的增加,提高了熔化速率,提升了产能。
可选地,所述多晶半导体材料棒和所述单晶籽晶体能朝着相反的方向自旋。或者,所述外部加热线圈和所述内部加热装置朝着相反的方向自旋。其进一步提升了熔融区的均匀性。
可选地,所述多晶半导体材料棒的材料为多晶硅。
可选地,所述多晶半导体材料棒的材料内具有掺杂物质。比如p型掺杂物质或n型掺杂物质,或者稀土元素。
可选地,所述外部加热线圈为高频感应线圈。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。所述内部加热装置可以以热辐射的形式加热。
可选地,所述内部加热装置为柱状,比如圆柱状、棱柱状等;或者所述内部加热装置为长条型加热线圈。
可选地,所述内部加热装置的长度可以调整。
可选地,所述内部加热装置的加热温度能够通过改变所述加热装置的内部电流的大小、交变电流的频率等方法改变所述内部加热装置的温度。
可选地,所述内部加热装置的位置可调节。
通过调整所述加热装置的温度、位置、形状或长度,可进一步扩大了可制备晶体材料的选择范围,同时通过调整所述加热装置的温度、位置、形状或长度能够控制结晶速率,增加了控制待加工晶体的材料的结晶速率的手段。
另一方面,本发明还提供了一种晶体制备设备,所述设备包括外部加热线圈和内部加热装置;所述内部加热装置能够置于圆环柱状的多晶半导体材料棒的圆心处的贯穿孔中;所述多晶半导体材料棒能够置于所述外部加热线圈的空心部分中。通过在多晶半导体材料棒内部设置加热装置,提高了所述多晶材料棒的受热均匀度,提高熔融区的均匀性。其更有助于实现了大横截面积的材料棒的更均匀的熔化。另一方面,由于热源的增加,提高了熔化速率,提升了产能。
可选地,所述内部加热装置可以以热辐射的形式加热其特征在于所述外部加热线圈和所述内部加热装置能够沿着所述半导体材料帮的第一端面向所述多晶半导体材料棒的与所述第一端面相对的第二端面移动。
可选地,所述设备包括固定所述多晶半导体材料棒的第一固定装置和固定单晶籽晶体的第二固定装置。
可选地,所述第一固定装置和所述第二固定装置能朝着相反的方向自旋。或者,所述外部加热线圈和所述内部加热装置朝着相反的方向自旋。其进一步提升了熔融区的均匀性。
可选地,所述外部加热线圈为高频感应线圈。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。
可选地,所述外部加热线圈为高频感应线圈。
可选地,所述内部加热装置由内部加热装置的固定装置固定。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。所述内部加热装置可以以热辐射的形式加热。
可选地,所述内部加热装置的加热温度能够通过改变所述加热装置的内部电流的大小、交变电流的频率等方法改变所述内部加热装置的温度。
可选地,所述内部加热装置的位置可调节。
可选地,所述内部加热装置为柱状,比如圆柱状、棱柱状等;或者所述内部加热装置为长条型加热线圈。同时,也可根据待加工晶体的材料及其对应的熔融速率来选择所述加热装置的长度。
通过调整所述加热装置的温度、位置、形状或长度,可进一步扩大了可制备晶体材料的选择范围,同时通过调整所述加热装置的温度、位置、形状或长度调整结晶速率,增加了控制待加工晶体的材料的结晶速率的手段。
附图说明
通过参考附图会更加清楚的理解本发明的特征和优点,附图是示意性的而不应理解为对本发明进行任何限制,在附图中:
图1显示为现有技术中区熔法的制备过程;
图2显示为现有技术中区熔法的垂直于多晶半导体材料棒轴向的截面图;
图3显示为本发明中的区熔法的垂直于多晶半导体材料棒轴向的截面图;
图4显示为本发明中一实施例的区熔法的沿着多晶半导体材料棒轴向的截面图;
图5显示为本发明中另一实施例的区熔法的沿着多晶半导体材料棒轴向的截面图;
具体实施方式
为使本发明实施例的目的、技术方案和优点更加清楚,下面将结合本发明实施例中的附图,对本发明实施例中的技术方案进行清楚、完整地描述,显然,所描述的实施例是本发明一部分实施例,而不是全部的实施例。基于本发明中的实施例,本领域技术人员在没有作出创造性劳动前提下所获得的所有其他实施例,都属于本发明保护的范围。
本发明提供一种晶体的制备方法和设备,其通过在多晶半导体材料棒的圆心处制备贯穿孔,同时在所述贯穿孔中插入内部加热装置。所述内部加热装置与外部加热线圈同时对所述半导体材料棒加热,提高了所述多晶半导体材料棒的受热均匀度,提高熔融区的均匀性。其更有助于实现大横截面积的材料棒的更均匀的熔化。另一方面,由于热源的增加,提高了熔化速率,提升了产能。
参见附图3和4,附图3和4示意出本发明实施例的一种晶体的制备方法中区熔法的垂直于多晶半导体材料棒轴向的截面图以及该实施例的区熔法的沿着多晶半导体材料棒轴向的截面图,所述方法包括:提供单晶籽晶体(未示出)和多晶半导体材料棒100,所述多晶半导体材料棒100为圆心处具有一贯穿孔102的圆环柱状体结构;
在所述多晶半导体材料棒外侧设置外部加热线圈101;
在所述贯穿孔内部设置内部加热装置103;
所述外部加热线圈101和所述内部加热装置103通过共同加热的方式,在所述单晶籽晶体和所述多晶半导体材料棒100的第一端面之间产生熔融区;
随着所述外部加热线圈101和所述内部加热装置103的移动,所述熔融区自所述多晶半导体材料棒100的所述第一端面向所述多晶半导体材料棒100的与所述第一端面之间相对的第二端面移动,以完成结晶过程。
通过在多晶半导体材料棒100内部设置内部加热装置103,提高了材料棒的受热均匀度,提高熔融区的均匀性。其更有助于实现大横截面积的材料棒的更均匀的熔化。另一方面,由于热源的增加,提高了熔化速率,提升了产能。
可选地,所述多晶半导体材料棒100和所述单晶籽晶体能朝着相反的方向自旋。或者,所述外部加热线圈101和所述内部加热装置103朝着相反的方向自旋。其进一步提升了熔融区的均匀性。
可选地,所述多晶半导体材料棒的材料为多晶硅。
可选地,所述多晶半导体材料棒的材料内具有掺杂物质。比如p型掺杂物质或n型掺杂物质,或者稀土元素。
可选地,所述外部加热线圈为高频感应线圈。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。所述内部加热装置可以以热辐射的形式加热。
可选地,所述内部加热装置为柱状,比如圆柱状、棱柱状等;或者所述内部加热装置为长条型加热线圈。
参考附图5,可选地,所述内部加热装置103’的长度可以调整。
可选地,所述内部加热装置的加热温度能够通过改变所述加热装置的内部电流的大小、交变电流的频率等方法改变所述内部加热装置的温度。
可选地,所述内部加热装置103’的位置可调节。
通过调整所述加热装置的温度、位置、形状或长度,可进一步扩大了可制备晶体材料的选择范围,同时通过调整所述加热装置的温度、位置、形状或长度能够控制结晶速率,增加了控制待加工晶体的材料的结晶速率的手段。
本发明还提供了一种晶体制备设备,所述设备包括外部加热线圈和内部加热装置;所述内部加热装置能够置于圆环柱状的多晶半导体材料棒的圆心处的贯穿孔中;所述多晶半导体材料棒能够置于所述外部加热线圈的空心部分中。通过在多晶半导体材料棒内部设置加热装置,提高了所述多晶材料棒的受热均匀度,提高熔融区的均匀性。其更有助于实现了大横截面积的材料棒的更均匀的熔化。另一方面,由于热源的增加,提高了熔化速率,提升了产能。
可选地,所述内部加热装置可以以热辐射的形式加热其特征在于所述外部加热线圈和所述内部加热装置能够沿着所述半导体材料帮的第一端面向所述多晶半导体材料棒的与所述第一端面相对的第二端面移动。
可选地,所述设备包括固定所述多晶半导体材料棒的第一固定装置和固定单晶籽晶体的第二固定装置。
可选地,所述第一固定装置和所述第二固定装置能朝着相反的方向自旋。或者,所述外部加热线圈和所述内部加热装置朝着相反的方向自旋。其进一步提升了熔融区的均匀性。
可选地,所述外部加热线圈为高频感应线圈。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。
可选地,所述外部加热线圈为高频感应线圈。
参考附图4,可选地,所述内部加热装置由内部加热装置的固定装置1031固定。
可选地,所述内部加热装置与所述多晶半导体材料棒不接触。其保证了在实现熔融时不引入新的污染源。所述内部加热装置可以以热辐射的形式加热。
可选地,所述内部加热装置的加热温度能够通过改变所述加热装置的内部电流的大小、交变电流的频率等方法改变所述内部加热装置的温度。
可选地,所述内部加热装置的位置可调节。参考附图5显示的实施列,所述固定装置1031’能够改变所述内部加热装置103’的位置。
可选地,所述内部加热装置为柱状,比如圆柱状、棱柱状等;或者所述内部加热装置为长条型加热线圈。同时,也可根据待加工晶体的材料及其对应的熔融速率来选择所述加热装置的长度。
通过调整所述内部加热装置的温度、位置、形状或长度,可进一步扩大了可制备晶体材料的选择范围,同时通过调整所述加热装置的温度、位置、形状或长度调整结晶速率,增加了控制待加工晶体的材料的结晶速率的手段。
上述实施例仅例示性说明本发明的原理及其功效,而非用于限制本发明,本领域技术人员可以在不脱离本发明的精神和范围的情况下作出各种修改和变型,这样的修改和变型均落入由所附权利要求所限定的范围之内。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询



 商标分类
商标分类  商标转让
商标转让 



