一种用于功率半导体器件封装的无重熔高温高压注塑模具的制作方法
 2021-02-23 16:02:31|
2021-02-23 16:02:31| 425|
425| 起点商标网
起点商标网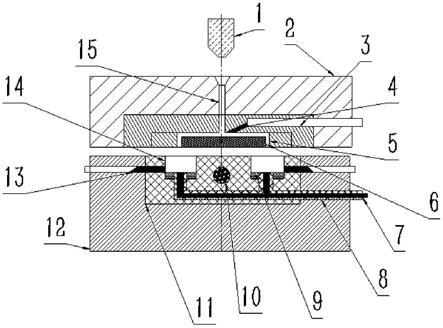
[0001]
本实用新型涉及半导体器件热塑型材料封装模具,尤其是涉及一种用于功率半导体器件封装的无重熔高温高压注塑模具。
背景技术:
[0002]
目前,由于半导体芯片材料由第一代向第三代宽禁带材料的升级,现有的以热固型塑封材料(以emc为主)和注压成型(传递模塑成型)封装工艺制造的器件,因材料和工艺固有特性的限制,已无法发挥第三代宽禁带材料芯片175℃以上工作结温的优良特性,进而限制了第三代半导体器件性价比优势的拓展。然而热塑型塑封材料(lcp、pi、改性pa)优良的综合特性完全可以满足第三代半导体芯片高工作结温的电热特性,但根本无法通过注压成型(传递模塑成型)工艺及装备实现封装制程,即无法完成从芯片到具备实际工程意义的器件转化。
[0003]
热塑型塑封材料成型的关键工艺参数,诸如温度、压力、流动性等相对于热固型塑封材料有很大的差异性,仅注塑成型熔融体温度就远高于目前使用的芯片固晶层材料的熔融温度,然而芯片固晶层材料的熔融温度远低于注塑成型熔融体温度。那么在高温高压的封装环境中,芯片固晶层材料不可避免的会发生重熔现象。固晶层材料重熔会产生以下问题:
[0004]
1、固晶层材料的金相组织会变化严重影响其固有的电热特性;
[0005]
2、在重熔状态下固晶层材料会与熔融状态的塑封材料产生的挥发性气体反应,形成微气孔破坏了固晶层的导热性能;
[0006]
3、在高压注塑条件下,会发生芯片位置漂移,导致电极邦定引线开路,使器件失效。
[0007]
由此可见,避免固晶层材料重熔是成功实现热塑型材料封装制程,保障最终器件制品有效可靠性的关键所在。
[0008]
由于目前热塑型材料的注塑模具均应用于同质结构嵌入件的封装,对注塑熔融体之成型温度和压力等工艺参数范围要求相对宽泛,而对型腔内的局域成型温度和压力等工艺参数没有靶向性控制的要求,因此无法实现对具有高可靠性要求的半导体芯片器件等多异质结构嵌入件的封装。
技术实现要素:
[0009]
本实用新型的目的就是为了克服上述现有技术存在的缺陷而提供一种用于功率半导体器件封装的无重熔高温高压注塑模具。
[0010]
本实用新型的目的可以通过以下技术方案来实现:
[0011]
一种用于功率半导体器件封装的无重熔高温高压注塑模具,包括移动模部件和固定模部件,所述移动模部件包括依次设置的上模板、热流道板和温度调节板,所述移动模部件设有贯穿上模板和热流道板的主流道,所述热流道板中设有第一温度传感器;
[0012]
所述固定模组件包括下模和设置在下模中的型腔模板,所述型腔模板中设有型腔,所述型腔中设有型腔冷却器,所述型腔的侧壁设有压力传感器和第二温度传感器;
[0013]
所述第一温度传感器、压力传感器和第二温度传感器均与模控系统连接。
[0014]
优选的,所述型腔的底部设有型腔热屏蔽层。
[0015]
优选的,所述型腔模板中设有与型腔相连的瞬间冷却器。
[0016]
优选的,所述瞬间冷却器之处设有高敏温度传感器。
[0017]
优选的,所述瞬间冷却器与型腔的底部连接。
[0018]
优选的,所述温度调节板与热流道板之间设有流道热屏蔽层。
[0019]
优选的,所述压力传感器和第二温度传感器设置在型腔的其中一个侧壁,所述型腔冷却器设置在与该侧壁相对的另一侧壁。
[0020]
优选的,所述模控系统采用具有亚毫秒级响应速度的模控系统mcu。
[0021]
优选的,所述型腔设有两部分,所述型腔冷却器设置在两部分型腔之间。
[0022]
优选的,所述型腔冷却器为管状。
[0023]
与现有技术相比,本实用新型具有以下优点:
[0024]
1、本装置解决了第三代半导体芯片异质结构嵌入部件热塑型材料封装的技术问题,构建具备高可靠性和工程化的第三代半导体芯片器件封装的装备系统,使第三代半导体芯片在规定使用技术条件下最大限度的发挥其特有效能,使其器件获得更加优良的可靠性指标和更高的性价比。
[0025]
2、型腔设有型腔冷却器、型腔热屏蔽层、压力传感器和温度传感器,在型腔热屏蔽层中置入集高敏传感器和瞬间冷却器一体化的高响应速度防重熔温度调节部件,可以实现型腔内部多点熔融体温度、压力、流量同步自动调节。
[0026]
3、移动模部件设有传感器、温度调节板、流道热屏蔽层,可实现注塑熔融体温度、压力、流量与型腔内部相关参数协自动调节。
附图说明
[0027]
图1为本实用新型的结构示意图;
[0028]
图2为本实用新型模具的协同控制示意图。
[0029]
图中标注:1、注塑机射嘴,2、上模板,3、热流道板,4、第一温度传感器,5、流道热屏蔽,6、温度调节板,7、高敏温度传感器,8、瞬间冷却器,9、型腔热屏蔽,10、型腔冷却器,11、型腔模板,12、下模,13、型腔传感器,14、型腔,15、主流道,16、模控系统mcu,17、注塑机mcu,18、外设冷却系统。
具体实施方式
[0030]
下面结合附图和具体实施例对本实用新型进行详细说明。本实施例以本实用新型技术方案为前提进行实施,给出了详细的实施方式和具体的操作过程,但本实用新型的保护范围不限于下述的实施例。
[0031]
实施例
[0032]
如图1所示,本申请提出一种用于功率半导体器件封装的无重熔高温高压注塑模具,包括移动模部件和固定模部件。
[0033]
移动模部件包括依次设置的上模板2、热流道板3和温度调节板6。移动模部件设有贯穿上模板2和热流道板3的主流道15,主流道15与热塑性材料注塑机射嘴11联结。热流道板3中设有第一温度传感器4,第一温度传感器4与外置亚毫秒级响应速度温度及压力传感控制的模控系统连接,进行信号交互处理。温度调节板6与热流道板3之间设有压入式高绝热材质的流道热屏蔽层5。
[0034]
固定模组件包括下模12和设置在下模12中的型腔模板11,型腔模板11中设有型腔14,型腔14中设有管状的型腔冷却器10,型腔14的侧壁设有型腔传感器13,包括压力传感器和第二温度传感器。压力传感器和第二温度传感器均与模控系统连接。型腔14的底部设有压入式高绝热材质的型腔热屏蔽层9,形成局域绝热层结构。型腔模板11中设有与型腔14的底部相连的瞬间冷却器8,瞬间冷却器8处设有高敏温度传感器7,高敏温度传感器7与模控系统连接,高敏温度传感器7和瞬间冷却器8一体化构成高响应速度防重熔温度调节部件。型腔14可实现内部多点熔融体温度、压力、流量同步自动调节。
[0035]
瞬间冷却器8、型腔冷却器10与外设冷却系统18联结,外设冷却系统18受控于模控系统。模控系统采用具有亚毫秒级响应速度的模控系统mcu16。
[0036]
具体的,型腔14的其中一个侧壁置入了压力传感器和第二温度传感器,型腔冷却器10设置在与该侧壁相对的另一侧壁。本实施例中,如图1所示,型腔114设有两部分,型腔冷却器10设置在两部分型腔14之间。
[0037]
本装置协同亚毫秒级响应速度温度及压力传感控制技术,实现具有三维靶向控制特性的温度、压力和再结晶速度及防重熔系统,实现对第三代半导体芯片异质结构嵌入部件的可靠封装。
[0038]
本装置的使用方法:
[0039]
将第三代半导体芯片异质结构嵌入部件定位置入固定模部件的型腔14中,开启热塑性材料注塑机,使移动模部件向下运动,完成移动模部件和固定模部件的合模;使热塑性材料熔融体通过注塑机射嘴1经热流道板3高压注入型腔14;如图2所示,熔融体在模控系统控制下的型腔传感器13、第一温度传感器4、高敏温度传感器7、瞬间冷却器8、型腔冷却器10的协同作用下,完成无重熔高温高压注塑制程。
[0040]
采用本申请装置封装的三代半导体大功率分立器件,经第三方国家级元器件可靠性检测机构检测,使用环境温度ta>155℃,工作结温tj>225℃,均达到:aec-q100;aec-q101;0级(航天级)标准。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询

tips


 商标分类
商标分类  商标转让
商标转让 


