用于芯片贴装的可固化粘合剂组合物的制作方法
 2021-02-02 17:02:26|
2021-02-02 17:02:26| 376|
376| 起点商标网
起点商标网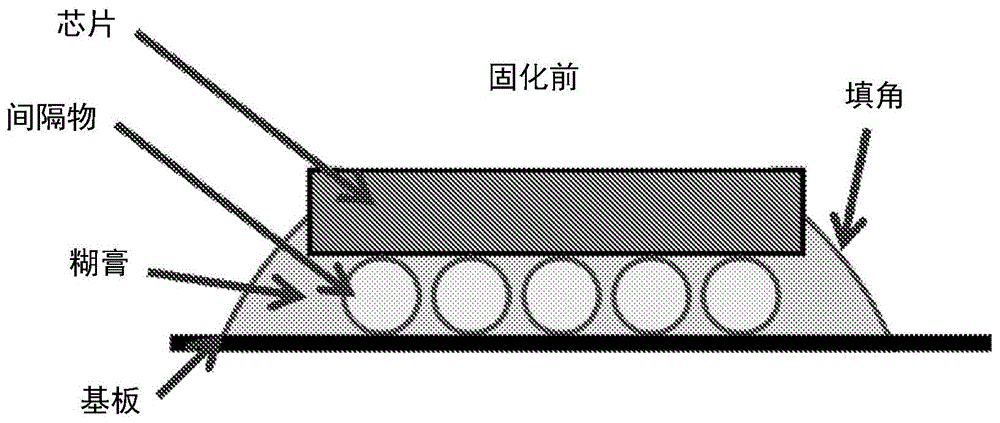
本发明涉及可固化粘合剂组合物。特别地,本发明涉及用于芯片贴装(dieattach)的可固化粘合剂组合物,其在固化时消除了空隙(void)问题,使填角(fillet)最小化,并且具有较小的粘合层厚度(bondlinethickness)和倾斜趋势。
背景技术:
:在半导体封装和微电子器件的制备和组装中,预施用的粘合剂组合物用于各种目的。更显著的用途包括将电子元件诸如集成电路晶片连接到引线框或其它基板,以及将电路封装或组件连接到印刷线路板。可用于电子封装应用的粘合剂通常表现出多种性能,诸如良好的机械强度、不影响部件或载体的固化性能、以及与应用到微电子和半导体部件相容的流变性能。由于减小半导体封装尺寸的压力不断增加,近来对薄芯片(诸如尺寸为0.2mmx0.2mm至10.0mmx10.0mm的芯片)感兴趣。微型化趋势扩大到多种封装类型,诸如方形扁平无引脚(qfn)、双扁平无引脚(dfn)、小外型集成电路(soic)、双列直插封装(dip)、小外形晶体管(sot)、小塑料方形扁平封装(qfp)器件等。使用常规芯片贴装糊膏粘合剂的半导体封装包括将芯片降低到芯片贴装糊膏的分配图案上,直到围绕芯片边缘形成填角(fillet)为止。标准的芯片贴装技术有时会限制糊膏在紧密公差封装中的使用,在紧密公差封装中填角与基板上的接合焊盘(bondpads)之间的距离最小。最小填角依赖于对粘合层厚度(blt)的精确控制,blt即芯片底部与基板表面之间的粘合剂的厚度。如果blt过薄,则由于高的内力或与芯片表面和/或基板的不良粘附性能,芯片容易从基板上脱层。如果blt在芯片表面上不均匀,则糊膏粘合剂倾向于形成溢出到芯片顶部的大体积的(bulky)填角,从而污染芯片顶部并导致不可靠的引线连接。结果是,较薄芯片的封装组装者不得不使用芯片连接膜(die-bondingfilm),这增加了材料成本并且招致资本设备投资。此外,当使用常规半导体封装技术时,在将芯片降低到芯片贴装糊膏的分配图案上之后,通常将芯片压在糊膏上以确保与基板的适当粘合。由于半导体芯片已经变得越来越薄,即,施用于薄芯片的压力会使芯片破裂、倾斜或包裹芯片,芯片贴装方法中的该步骤变得有问题。包含破裂芯片的封装必须废弃,并且组装堆叠的芯片封装时,不合格封装的风险会增加。在较薄芯片应用中使用可固化粘合剂的另一挑战在于在粘合基板与芯片的固化产品中产生的空隙。如果含有挥发性溶剂或间隔物的粘合剂组合物的固化快于溶剂的完全挥发或间隔物的变形,则这发生在组合物的固化期间。wo2017066563a公开了一种导电性粘合剂配制物,其包含有机基质、作为填料的颗粒化的镍或颗粒化的镍合金,以及其它金属填料。该粘合剂配制物可用作芯片贴装糊膏粘合剂。wo2003072673a公开了一种粘合剂组合物,其包含至少一种含马来酰亚胺的单体、任选存在的至少一种固化引发剂以及由一种或多种有机聚合物构成的多个间隔物。us6022616b教导了一种改进的粘合剂组合物,其由至少一种有机聚合物树脂、无机填料和挥发性(fugitive)液体制备,其中所述液体和所述有机聚合物树脂各自基本上不溶于另一种中;其中改进包括:所述至少一种有机聚合树脂以粒度为25μm或更小的颗粒形式存在。如此制备的粘合剂组合物可用于金属基板上的400密耳×400密耳或更大的芯片,而没有显著的脱层。然而,这些尝试不能完全解决上述问题。因此,在本领域中需要这样的可固化粘合剂组合物,在连接薄芯片的应用中固化时,其提供优异的blt控制,并且实现无空隙、最小填角、较低倾斜趋势,同时保持优异的粘合强度。技术实现要素:本发明提供了克服常规配制物的上述缺点的可固化粘合剂组合物。本发明中的可固化粘合剂组合物在施用时和在固化时可获得优异的blt。本发明中的可固化粘合剂组合物在固化时消除了空隙。本发明中的可固化粘合剂组合物在固化时具有较低的倾斜趋势和最小填角。此外,所述可固化粘合剂组合物的应用是简单的并且适合于工业生产。概括而言,本发明提供了一种可固化粘合剂组合物,其包含:(1)热固性或热塑性树脂组分,(2)第一金属或合金的多个颗粒,其熔点不高于300℃并且d50粒度为10μm至100μm,(3)第二金属或合金的多个颗粒,其熔点高于300℃并且d50粒度为0.1μm至小于10μm,和(4)任选存在的固化剂。本发明还提供了一种组件,其包括通过用于芯片贴装的可固化粘合剂组合物的固化产物粘附至基板的芯片。本发明还提供了一种芯片贴装的方法,其包括:(a)将可固化粘合剂组合物施用于基板,(b)使所述基板与芯片紧密接触以形成组件,以及(c)使所述组件处于适合于使所述可固化粘合剂组合物固化的条件。附图说明图1是在固化之前包括通过根据本发明的粘合剂组合物附接的芯片和基板的芯片组件的示意图。图2是在固化之后包括通过根据本发明的粘合剂组合物附接的芯片和基板的芯片组件的示意图。图3是显示根据实施例1的固化的粘合剂糊膏的表面的x射线显微图像。图4是显示根据对比例1的固化的粘合剂糊膏的表面的x射线显微图像。图5是显示根据对比例2的固化的粘合剂糊膏的表面的x射线显微图像。具体实施方式在下面的段落中,将更详细地描述本发明。除非明确指示相反,否则如此描述的每个方面可与任何其它一个方面或多个方面组合。特别地,指明为优选的或有利的任何特征可以与指明作为优选的或者有利的任何其他一个特征或多个特征组合。在本发明的上下文中,除非上下文另外指明,否则将根据以下定义来解释所使用的术语。除非上下文明确另外指明,否则如本文中所使用的单数形式“一(个/种)”和“该/所述”包括单数和复数个指代物。本文所使用的术语“包含(“comprising”,“comprises”,“comprisedof”)”与“包括(“including”,“includes”)”或“含有(“containing”,“contains”)”同义,并且是包括性的或开放式的,并且不排除额外的、未提及的成员、要素或工艺步骤。术语“合金”是指含有两种或更多种金属和任选存在的另外的非金属的混合物,其中当熔融时合金的各元素熔合在一起或彼此溶解。本文中用于合金组成的标记使用由斜杠(“/”)分隔的iupac符号列出了两种或更多种元素。当给出时,合金中元素的比例用元素后的数字表示,该数字对应于合金中的元素的重量百分比。例如,sn/bi表示锡(sn)和铋(bi)的合金,其可以是任何比例的这两种元素。sn60/bi40表示含有60重量%锡和40重量%铋的锡和铋的特定合金。当给出合金中一种或多种元素的重量百分比的范围时,该范围表明该元素可以所表明范围内的任何量存在。例如,sn(70-90)/bi(10-30)是指含有70重量%至90重量%锡和10重量%至30重量%铋的合金。因此,“sn(70-90)/bi(10-30)”范围所涵盖的合金包括但不限于:sn70/bi30、sn71/bi29、sn72/bi28、sn73/bi27、sn74/bi26、sn75/bi25、sn76/bi24、sn77/bi23、sn78/bi22、sn79/bi21、sn80/bi20、sn81/bi19、sn82/bi18、sn83/bi17、sn84/bi16、sn85/bi15、sn86/bi14、sn87/bi13、sn88/bi12、sn89/bi11和sn90/bi10。此外,sn(70-90)/bi(10-30)表示这样的合金,其中元素sn和bi的具体比例可在sn70/bi30至sn90/bi10变化,包括sn的比例从70-90重量%变化,bi的比例相反地从30-10重量%。本文所用的术语“熔融温度”或“熔点”是指固体在大气压下变成液体的温度(点)。数值端点的记载包括涵盖在相应范围内的所有数值的分数,以及所述端点。本说明书中引用的所有参考文献以参考的方式全文并入本文。除非另有定义,否则在公开本发明中使用的所有术语,包括技术和科学术语,具有本发明所属领域的普通技术人员通常理解的含义。通过进一步的指导,包括术语定义以更好地理解本发明的教导。根据本发明,可固化粘合剂组合物包括热固性或热塑性树脂组分;第一金属或合金的多个颗粒,其熔点不高于300℃并且d50粒度为10μm至100μm;第二金属或合金的多个颗粒,其熔点高于300℃并且d50粒度为0.1μm至小于10μm;和任选存在的固化剂。在一个实施方案中,第一金属或合金的颗粒的d50粒度比第二金属或金属的颗粒的d50粒度大5%,优选大50%,更优选大100%。在本文所述的组合物中提供一种或多种热固性树脂或热塑性树脂组分以改善由本发明组合物制备的一种或多种性能,例如粘性、润湿能力、柔韧性、工作寿命、高温粘附性,和/或树脂-填料相容性。此外,在本文所述的组合物中提供一种或多种热固性树脂或热塑性树脂组分以改善由本发明组合物制备的一种或多种性能,例如流变性、可分配性。所述一种或多种热固性树脂或热塑性树脂组分可以是能够赋予组合物一种或多种上文所列出性能的任何树脂,包括但不限于缩醛,(甲基)丙烯酸类单体、低聚物或聚合物,丙烯腈-丁二烯-苯乙烯(abs)聚合物或共聚物或聚碳酸酯/abs合金,醇酸树脂,丁二烯,苯乙烯-丁二烯,纤维素类(cellulosic),香豆酮-茚,氰酸酯,邻苯二甲酸二烯丙酯(dap),环氧单体、低聚物或聚合物,具有环氧官能团的柔性环氧树脂或聚合物,含氟聚合物,三聚氰胺-甲醛,氯丁橡胶,腈树脂,酚醛清漆树脂(novolac),尼龙,石油树脂,酚类(phenolics),聚酰胺-酰亚胺,聚芳酯和聚芳酯醚砜或酮,聚丁烯,聚碳酸酯,聚酯和共聚酯碳酸酯,聚醚酯,聚乙烯,聚酰亚胺,马来酰亚胺,桥亚甲基四氢邻苯二甲酰亚胺(nadimide),衣康酰胺,聚酮,聚烯烃,聚苯醚,硫化物,醚,聚丙烯和聚丙烯-epdm共混物,聚苯乙烯,聚脲,聚氨酯,乙烯基聚合物,橡胶,有机硅聚合物,硅氧烷聚合物,苯乙烯丙烯腈,苯乙烯丁二烯胶乳和其他苯乙烯共聚物,砜聚合物,热塑性聚酯(饱和),邻苯二甲酸酯,不饱和聚酯,脲醛树脂(urea-formaldehyde),聚丙烯酰胺,聚二醇,聚丙烯酸,聚乙二醇,固有导电聚合物,含氟聚合物等及它们中任意两种或更多种的组合。本文中考虑使用的马来酰亚胺、桥亚甲基四氢邻苯二甲酰亚胺或衣康酰胺分别具有以下结构:其中:m为1-15,p为0-15,每个r2独立地选自氢或低级烷基(诸如c1-5),并且j是包含有机或有机硅氧烷基团的一价或多价基团,和其任意两种或更多种的组合。在某些实施方案中,j是选自以下的一价或多价基团:-通常具有约6至约500个碳原子的烃基或取代的烃基,其中所述烃基选自烷基、烯基、炔基、环烷基、环烯基、芳基、烷基芳基、芳基烷基、芳基烯基、烯基芳基、芳基炔基或炔基芳基,然而,前提是,只有当x包含两种或更多种不同种类的组合时,x才可以是芳基;-通常具有约6至约500个碳原子的亚烃基(hydrocarbylene)或取代的亚烃基,其中所述亚烃基选自亚烷基、亚烯基、亚炔基、亚环烷基、亚环烯基、亚芳基、烷基亚芳基、芳基亚烷基、芳基亚烯基、烯基亚芳基、芳基亚炔基或炔基亚芳基,-通常具有约6至约500个碳原子的杂环或取代的杂环,-聚硅氧烷,或-聚硅氧烷-聚氨酯嵌段共聚物,以及-以上基团中的一种或多种与选自以下的连接基的组合:-o-、-s-、-nr-、-nr-c(o)-、-nr-c(o)-o-、-nr-c(o)-nr-、-s-c(o)-、-s-c(o)-o-、-s-c(o)-nr-、-o-s(o)2-、-o-s(o)2-o-、-o-s(o)2-nr-、-o-s(o)-、-o-s(o)-o-、-o-s(o)-nr-、-o-nr-c(o)-、-o-nr-c(o)-o-、-o-nr-c(o)-nr-、-nr-o-c(o)-、-nr-o-c(o)-o-、-nr-o-c(o)-nr-、-o-nr-c(s)-、-o-nr-c(s)-o-、-o-nr-c(s)-nr-、-nr-o-c(s)-、-nr-o-c(s)-o-、-nr-o-c(s)-nr-、-o-c(s)-、-o-c(s)-o-、-o-c(s)-nr-、-nr-c(s)-、-nr-c(s)-o-、-nr-c(s)-nr-、-s-s(o)2-、-s-s(o)2-o-、-s-s(o)2-nr-、-nr-o-s(o)-、-nr-o-s(o)-o-、-nr-o-s(o)-nr-、-nr-o-s(o)2-、-nr-o-s(o)2-o-、-nr-o-s(o)2-nr-、-o-nr-s(o)-、-o-nr-s(o)-o-、-o-nr-s(o)-nr-、-o-nr-s(o)2-o-、-o-nr-s(o)2-nr-、-o-nr-s(o)2-、-o-p(o)r2-、-s-p(o)r2-或-nr-p(o)r2-;其中每个r独立地是氢、烷基或取代的烷基。本发明中考虑使用的示例性马来酰亚胺、桥亚甲基四氢邻苯二甲酰亚胺或衣康酰胺包括4,4'-二苯基甲烷双马来酰亚胺、4,4'-二苯醚双马来酰亚胺、4,4'-二苯基砜双马来酰亚胺、苯基甲烷马来酰亚胺、间亚苯基双马来酰亚胺、2,2'-双[4-(4-马来酰亚氨基苯氧基)苯基]丙烷、3,3'-二甲基-5,5'-二乙基-4,4'-二苯基甲烷双马来酰亚胺、4-甲基-1,3-亚苯基双马来酰亚胺、1,6'-双马来酰亚胺-(2,2,4-三甲基)己烷、1,3-双(3-马来酰亚氨基苯氧基)苯、1,3-双(4-马来酰亚氨基苯氧基)-苯等。马来酰亚胺的其他实例是由下式表示的化合物。这些化合物可诸如从henkelcorporation购得,其他实例是马来酸酐接枝的聚丁二烯和由其衍生的醇缩合物,诸如来自riconresins,inc.的ricon130ma8、riconma13、ricon130ma20、ricon131mas、ricon131ma10、riconma17、riconma20、ricon184ma6和ricon156ma17。考虑用于本文中的所述一种或多种环氧单体、低聚物或聚合物,在本文中也称为环氧树脂,可以包括具有脂族主链的环氧化物、具有芳族主链的环氧化物、改性环氧树脂或这些物质的混合物。在某些实施方案中,所述一种或多种环氧单体、低聚物或聚合物包括官能化的环氧单体、低聚物或聚合物。环氧树脂中的环氧官能度至少为1。在一些实施方案中,环氧树脂的环氧官能度是1(即,该环氧树脂是单官能环氧树脂)。在其他实施方案中,环氧树脂包含至少两个或更多个环氧官能团(例如2、3、4、5或更多个)。考虑用于实施本发明的环氧树脂不限于具有特定分子量的树脂。示例性环氧树脂的分子量可以在约50或更小至约1,000,000的范围内。在某些实施方案中,考虑用于本文中的环氧树脂的分子量在约200,000至约900,000的范围内。在其他实施方案中,考虑用于本文中的环氧树脂的分子量在约10,000至约200,000的范围内。在其他实施方案中,考虑用于本文中的环氧树脂的分子量在约1,000至约10,000的范围内。在其他实施方案中,考虑用于本文中的环氧树脂的分子量范围为约50至约10,000。在一些实施方案中,环氧树脂可以是包含芳族和/或脂族主链的液体环氧树脂或固体环氧树脂,诸如双酚f的二缩水甘油醚或双酚a的二缩水甘油醚。任选地,环氧树脂是柔性环氧树脂。柔性环氧树脂可以具有可变长度(例如,短链或长链)的链长,诸如短链长或长链长的聚二醇二环氧化合物液体树脂。示例性短链长聚二醇二环氧化物液体树脂包括d.e.r.736,示例性长链长聚二醇二环氧化物液体树脂包括d.e.r.732,均可从dowchemicalcompany(midland,mi)购得。考虑用于本文中的示例性环氧树脂包括基于双酚a的液体型环氧树脂、基于双酚a的固体型环氧树脂、基于双酚f的液体型环氧树脂(例如epiclonexa-835lv)、基于线形酚醛树脂(phenol-novolac)的多功能环氧树脂、二环戊二烯型环氧树脂(例如epiclonhp-7200l)、萘型环氧树脂等,及它们中的任意两种或更多种的混合物。其他实例有eponresin862、epiclonn-730a(来自dainipponink&chemical的表氯醇-酚醛树脂);epiclon830s;aralditegy285(chemicainc.);rsl-1739(p双酚f/表氯醇环氧树脂,来自resolutionperformanceproducts);nscepoxy5320(1,4-丁二醇二缩水甘油醚,来自henkelcorporation);和ex-201-im(间苯二酚二缩水基甘油醚,来自nagasechemtexcorporation)。在某些实施方案中,考虑用于本文中的环氧树脂包括双酚a环氧树脂的二缩水甘油醚、双酚f环氧树脂的二缩水甘油醚、环氧酚醛清漆树脂、环氧甲酚树脂等。在一些实施方案中,环氧树脂可以是增韧的环氧树脂,诸如环氧化的羧基封端的丁二烯-丙烯腈(ctbn)低聚物或聚合物、环氧化的聚丁二烯二缩水甘油醚低聚物或聚合物、杂环环氧树脂(例如,异氰酸酯改性的环氧树脂)等。在某些实施方案中,环氧化的ctbn低聚物或聚合物是具有以下结构的低聚或聚合前体的含环氧基的衍生物:hooc[(bu)x(acn)y]mcooh其中:每个bu是丁烯部分(例如1,2-丁二烯基或1,4-丁二烯基),每个acn是丙烯腈部分,bu单元和acn单元可以随机排列或嵌段排列,x和y各自大于零,前提是x+y的总和=1,x:y的比率在约10:1至1:10的范围内,并且m在约20至约100的范围内。如本领域技术人员已知的,可以多种方式制备环氧化的ctbn低聚物或聚合物,例如,由(1)羧基封端的丁二烯/丙烯腈共聚物、(2)环氧树脂和(3)双酚a通过ctbn的羧酸基团与环氧化物等之间的反应(通过扩链反应)制备:在一些实施方案中,环氧树脂可包括由以下物质制成的环氧化的ctbn低聚物或聚合物:如上所述的(1)羧基封端的丁二烯/丙烯腈共聚物;(2)环氧树脂;和(3)双酚a;以及hyprotm环氧官能的丁二烯-丙烯腈聚合物(以前称为etbn)等。在某些实施方案中,考虑用于本文中的环氧树脂包括橡胶或弹性体改性的环氧树脂。橡胶或弹性体改性的环氧树脂包括以下物质的环氧化衍生物:(a)重均分子量(mw)为30,000至400,00或更高的共轭二烯的均聚物或共聚物,如美国专利号4,020,036中所述(其全部内容通过引用并入本文),其中每分子共轭二烯包含4-11个碳原子(诸如1,3-丁二烯、异戊二烯等);(b)数均分子量(mn)为约800至约50,000的表卤代醇均聚物、两种或更多种表卤代醇单体的共聚物、或一种或多种表卤代醇单体与一种或多种氧化物单体的共聚物,如美国专利号4,101,604中所述(其全部内容通过引用并入本文);(c)烃聚合物,包括乙烯/丙烯共聚物、以及乙烯/丙烯与至少一种非共轭二烯的共聚物,诸如乙烯/丙烯/己二烯/降冰片二烯,如美国专利号4,161,471中所述;或(d)共轭二烯丁基弹性体,诸如由85-99.5重量%的c4-c5烯烃与约0.5-约15重量%的具有4至14个碳原子的共轭多烯烃组成的共聚物,异丁烯和异戊二烯的共聚物,其中大部分结合在其中的异戊二烯单元具有共轭二烯不饱和键(参见,例如,美国专利号4,160,759;其全部内容通过引用并入本文)。在某些实施方案中,环氧树脂是环氧化的聚丁二烯二缩水甘油醚低聚物或聚合物。在某些实施方案中,考虑用于本文中的环氧化聚丁二烯二缩水甘油醚低聚物具有以下结构:其中:r1和r2各自独立地为h或低级烷基,r3为h、饱和或不饱和烃基、或环氧基,每个低聚物中存在至少1个上述含环氧基的重复单元,和至少一个上述烯属重复单元,并且当存在时,存在1-10范围内的各重复单元,并且n的范围是2-150。在某些实施方案中,考虑用于本发明实践的环氧化的聚丁二烯二缩水甘油醚低聚物或聚合物具有以下结构:其中r是h、oh、低级烷基、环氧基、环氧乙烷取代的低级烷基、芳基、烷芳基等。考虑用于本文中的环氧树脂的其他实例包括具有柔性主链的环氧树脂。例如,环氧树脂可以包括以下物质:在一些实施方案中,另外的环氧材料可以包括在本发明配制物中。当包括在本发明配制物中时,可以考虑将多种环氧官能化的树脂用于本文,例如基于双酚a的环氧树脂(例如eponresin834)、基于双酚f的环氧树脂(例如rsl-1739或jeryl980)、基于线形酚醛树脂的多功能环氧树脂、二环戊二烯型环氧树脂(例如epiclonhp-7200l)、萘型环氧树脂等,及它们中任意两种或更多种的混合物。考虑用于本文中的示例性环氧官能化树脂包括脂环族醇的二环氧化物、氢化双酚a(可作为epalloy5000购得)、六氢邻苯二甲酸酐的双官能脂环族缩水甘油酯(可作为epalloy5200购得)、epiclonexa-835lv、epiclonhp-7200l等,及它们中的任意两种或更多种的混合物。适合用作本发明配制物的任选存在的另外组分的常规环氧材料的另外实例包括以下物质:考虑用于本文中的示例性环氧官能化树脂包括环氧化的ctbn橡胶561a、24-440b和ep-7(可从henkelcorporation;salisbury,nc&ranchodominguez,ca购得);脂环族醇氢化双酚a的二环氧化物(可作为epalloy5000购得);六氢邻苯二甲酸酐的双官能脂环族缩水甘油酯(可作为epalloy5200购得);erl4299;cy-179;cy-184;等等,以及它们中任意两种或更多种的混合物。任选地,环氧树脂可以是具有以下主链的共聚物,所述主链是单体单元的混合物(即,杂化主链)。环氧树脂可包括直链或支化链段。在某些实施方案中,环氧树脂可以是环氧化的有机硅单体或低聚物。任选地,环氧树脂可以是柔性的环氧-有机硅共聚物。考虑用于本文中的示例性柔性环氧-有机硅共聚物包括albiflex296和albiflex348,两者均可从evonikindustries(德国)购得。在一些实施方案中,组合物中存在一种环氧单体、低聚物或聚合物。在某些实施方案中,组合物中存在环氧单体、低聚物或聚合物的组合。例如,组合物中存在两种或更多种、三种或更多种、四种或更多种、五种或更多种、或六种或更多种环氧单体、低聚物或聚合物。可以选择环氧树脂的组合并将其用于实现由该组合物制备的膜或糊膏的所需性能。例如,可以选择环氧树脂的组合,使得由该组合物制备的膜表现出一种或多种以下改善的性能:膜质量、粘性、润湿能力、柔韧性、工作寿命、高温粘附性、树脂-填料相容性、烧结能力等。可以选择环氧树脂的组合,使得由该组合物制备的糊膏表现出一种或多种改善的性能,诸如流变性、可分配性、工作寿命、烧结能力等。一种或多种环氧单体、低聚物或聚合物可以组合物的总固体内容物(即,不包括稀释剂的组合物)的至多约50重量%的量存在于组合物中。例如,一种或多种环氧单体、低聚物或聚合物可以约3重量%至约50重量%、约10重量%至约50重量%、或约10重量%至约35重量%的量存在于组合物中。在一些实施方案中,基于组合物的总固体内容物的重量,一种或多种环氧单体、低聚物或聚合物可以约50重量%或更少、约45重量%或更少、约40重量%或更少、约35重量%或更少、约30重量%或更少、约25重量%或更少、约20重量%或更少、约15重量%或更少、约10重量%或更少、或约5重量%或更少的量存在于组合物中。本文所述的组合物可进一步包含丙烯酸类单体、聚合物或低聚物。考虑用于实践本发明的丙烯酸酯是本领域众所周知的。例如参见美国专利号5,717,034,其全部内容通过引用并入本文。考虑用于实践本发明的(甲基)丙烯酸类单体、聚合物或低聚物不限于特定的分子量。示例性的(甲基)丙烯酸类树脂的分子量可以在约50或更低至约1,000,000的范围内。在一些实施方案中,考虑用于本文中的(甲基)丙烯酸类聚合物可具有约100至约10,000的范围内的分子量和约-40℃至约20℃的范围内的tg。在某些实施方案中,考虑用于本文中的(甲基)丙烯酸类聚合物具有在约10,000至约900,000(例如,约100,000至约900,000或约200,000至约900,000)范围内的分子量和在约-40℃至约20℃范围内的tg。用于本文所述的组合物中的(甲基)丙烯酸类共聚物的实例包括teisanresinsg-p3和teisanresinsg-80h(均可从日本的nagasechemtexcorp.商购)、sr423a(来自sartomercompanyinc.)。任选地,用于本文所述的组合物中的(甲基)丙烯酸类聚合物或低聚物可以是可降解的(甲基)丙烯酸类聚合物或低聚物或环氧改性的丙烯酸类树脂。(甲基)丙烯酸类单体、聚合物和/或低聚物可以组合物的总固体内容物的至多约50重量%的量存在于组合物中。例如,(甲基)丙烯酸类单体、共聚物和/或低聚物可以约5重量%至约50重量%、或约10重量%至约50重量%、或约10重量%至约35重量%、或约5重量%至约30重量%、或约5重量%至约20重量%的量存在于组合物中。在一些实施方案中,基于组合物的总固体内容物的重量,(甲基)丙烯酸类单体、共聚物和/或低聚物以约50重量%或更少、约45重量%或更少、约40重量%或更少、约35重量%或更少、约30重量%或更少、约25重量%或更少、约20重量%或更少、约15重量%或更少、约10重量%或更少、或约5重量%或更少的量存在于组合物中。考虑用于本文的示例性(甲基)丙烯酸酯包括单官能(甲基)丙烯酸酯、双官能(甲基)丙烯酸酯、三官能(甲基)丙烯酸酯、多官能(甲基)丙烯酸酯等,以及它们中任何两种或更多种的混合物。考虑用于本文所述的组合物中的其他热固性树脂或热塑性树脂组分可包括聚氨酯、氰酸酯、聚乙烯醇、聚酯、聚脲、聚乙烯醇缩醛树脂和苯氧树脂。在一些实施方案中,组合物可包含含酰亚胺的单体、低聚物或聚合物,诸如马来酰亚胺、桥亚甲基四氢邻苯二甲酰亚胺(nadimides)、衣康酰亚胺、双马来酰亚胺或聚酰亚胺。热固性树脂或热塑性树脂组分,包括一种或多种环氧单体、聚合物或低聚物;丙烯酸类单体、聚合物或低聚物,酚类;酚醛清漆树脂;聚氨酯;氰酸酯;聚乙烯醇;聚酯;聚脲;聚乙烯醇缩醛树脂;苯氧树脂;和/或含酰亚胺的单体、聚合物或低聚物(例如,马来酰亚胺、双马来酰亚胺和聚酰亚胺)可以组合以形成粘结剂。粘结剂可以是固体、半固体或液体。任选地,粘结剂的分解温度小于350℃。考虑用于本文的氰酸酯单体包含两个或多个成环的氰酸酯(-o-c≡n)基团,其在加热时环三聚以形成取代的三嗪环。在一个具体实施方案中,热固性或热塑性树脂组分选自环氧单体、环氧低聚物、环氧聚合物、(甲基)丙烯酸类单体、(甲基)丙烯酸类低聚物、(甲基)丙烯酸类聚合物、酚醛树脂、聚氨酯、氰酸酯、聚乙烯醇、聚酯、聚脲、聚乙烯醇缩醛树脂、苯氧树脂、马来酰亚胺、双马来酰亚胺、桥亚甲基四氢邻苯二甲酰亚胺、衣康酰胺、聚酰亚胺及它们的混合物。优选地,热固性或热塑性树脂组分选自环氧单体、环氧低聚物、环氧聚合物、(甲基)丙烯酸类单体、(甲基)丙烯酸类低聚物、(甲基)丙烯酸类聚合物、马来酰亚胺、双马来酰亚胺及它们的混合物。根据本发明,基于用于芯片贴装的可固化粘合剂组合物的总重量,热固性或热塑性树脂组分以0.5重量%至30重量%、优选1重量%至25重量%、更优选3重量%至20重量%的量存在。用于芯片贴装的可固化粘合剂组合物还包含第一金属或合金的多个颗粒,其中第一金属或合金的熔点不高于300℃(即,低熔点金属或合金)并且d50粒度为10μm至100μm。低熔融温度的金属或合金用作组合物中的间隔物(spacer)以支撑基板与芯片之间的粘合区域。在此,第一金属或合金的颗粒的“d50粒度”表示通过激光衍射粒度分析仪测量而获得的基于体积的粒度分布曲线的中值直径。发明人意外地发现,当低熔融温度的金属和/或合金的间隔物颗粒与其他组分一起包含在组合物中时,可固化粘合剂组合物能够在固化和用于贴装较小芯片时消除空隙、实现更薄的blt和更少的倾斜趋势。第一金属或合金的颗粒的熔点不高于300℃,优选为50℃至300℃,更优选为70℃至200℃,特别是100℃至200℃。在本发明的上下文中,这些金属和合金统称为低熔点合金(lma)。合适的lma颗粒包括铟(in)、锗(ga)、铋(bi)或锡(sn)中的至少一种。优选地,lma的颗粒包含大于30质量%的in、ga、bi或sn中的至少一种。痕量的镉和铅可以掺入lma中以降低合金的熔点。但是,为了满足当地环境保护法规(例如rohs法规)的要求,lma颗粒特别是基本上不包含铅(pb)和镉(cd),诸如包含小于0.1重量%、或小于0.05重量%铅(pb)和镉(cd),优选不包含pb和cd。优选的低熔点金属是in和sn。优选的低熔点合金是ga、in、bi、sn、ag、zn、sb、au和cu的混合物,诸如in/sn合金、in/bi合金、sn/bi合金、in/sn/bi合金、sn/bi/ag合金、sn/ag/cu合金、sn/cu合金、in/sn/zn合金、sn/ag/cu/sb合金和sn/au合金。示例性低熔点合金是in(51)/bi(32.5)/sn(16.5)、in(66.3)/bi(33.7)、in(26)/bi(57)/sn(17)、bi(54)/in(29.7)/sn(16.3)、in(52.2)/sn(46)/zn(1.8)、bi(67.0)/in(33.0)、in(52)/sn(48)、in(50)/sn(50)、sn(52)/in(48)、bi(58)/sn(42)、bi(57)/sn(42)/ag(1)、in(97)/ag(3)、sn(58)/in(42)、in(95)/bi(5)、in(99.3)/ga(0.7)、in(90)/sn(10)、in(99.4)/ga(0.6)、in(99.6)/ga(0.4)、in(99.5)/ga(0.5)、sn(60)/bi(40)、sn(86.5)/zn(5.5)/in(4.5)/bi(3.5)、sn(77.2)/in(20.0)/ag(2.8)、sn(83.6)/in(8.8)/zn(7.6)、sn(91)/zn(9)、sn(86.9)/in(10)/ag(3.1)、sn(91.8)/bi(4.8)/ag(3.4)、sn(90)/au(10)、sn(95.5)/ag(3.8)/cu(0.7)、sn(95.5)/ag(3.9)/cu(0.6)、sn(96.5)/ag(3.5)、sn(97)/ag(3)、sn(95.5)/ag(4.0)/cu(0.5)、sn(96.2)/ag(2.5)/cu(0.8)/sb(0.5)、sn(98.5)/ag(1.0)/cu(0.5)、sn(97.5)/ag(2.5)、sn(98.5)/ag(1.0)/cu(0.5)、sn(98.5)/ag(0.5)/cu(1.0)、sn(99)/ag(1)、sn(99)/cu(1)、sn(99.3)/cu(0.7)、sn(99.2)/cu(0.5)/bi(0.3)、sn(99.5)/cu(0.5)、sn(65)/ag(25)/sb(10)、sn(99)/sb(1)、in(99)/ag(10)、sn(97)/sb(3)、sn(95.0)/ag(5)、sn(95)/sb(5)、bi(95)/sn(5),熔点(液相线温度)为50℃至300℃。这些低熔点金属或合金可商购,诸如从heraeusco.ltd.、sigmaaldrichco.,ltd.、5nplusco.,ltd.(以mcp系列的商品名,诸如mcp137(bi/sn合金)、mcp150(bi/sn/合金)、mcp61(bi/sn/in合金)、mcp79(bi/sn/in合金)等)以及merckmilliporegmbh商购。根据本发明,低熔点合金或金属的间隔物的d50粒度为10μm至100μm,优选为10μm至50μm,并优选为12.5μm至35μm。如果间隔物的d50粒度大于100μm,则在贴装较小尺寸的芯片时容易产生填角。如果间隔物的d50粒度小于10μm,则间隔物可能无法支撑芯片和基板。根据本发明,低熔点合金的隔离物的振实密度为3-12g/cm3,优选为5-10g/cm3。如果密度太低或太高,则间隔物可能不能与其他组分混溶并且可能不能很好地分散在粘合剂组合物中,特别是当加热粘合剂组合物以使其固化时。间隔物的不均匀性可能导致严重的倾斜趋势,在芯片和间隔物承受载荷力时,这将增加发生贴装失败的风险。低熔点合金或金属的形状不受特别限制,其实例包括球形、近似球形、椭球形、纺锤形、立方体形、近似立方体形、薄片形和不定形(unshaped-shaped)。其中,从保存稳定性的观点出发,优选使用球形、近似球形和薄片形的填料。根据本发明,基于用于芯片贴装的可固化粘合剂组合物的总重量,第一金属或合金的颗粒以0.1重量%至5重量%、优选0.3重量%至3重量%、更优选0.5重量%至2重量%的量存在。可固化粘合剂组合物还包含作为导电性填料的第二金属或合金的多个颗粒。导电性填料颗粒的熔点高于300℃,优选为350℃至2000℃,更优选为400℃至1500℃,甚至更优选为500℃至1200℃。第二金属或合金的颗粒包含金(au)、银(ag)、镍(ni)、铝(al)或铜(cu)中的至少一种,并且包含大于50质量%的au、ag或cu中的一种。在一个实施方案中,第二金属或合金的颗粒包含银,并且包含大于50质量%、优选大于70质量%、或甚至大于90质量%的银。导电性填料颗粒的d50粒度为0.1μm至小于10μm,优选为0.5μm至8μm,更优选为2μm至6μm。当导电性填料的粒径在上述范围内时,填料充分地分散在可固化粘合剂组合物中,这可以改善可固化粘合剂组合物的保存稳定性,并提供均匀的粘合强度。此处,导电性填料的“d50粒度”是指通过激光衍射粒度分析仪测量而获得的基于体积的粒度分布曲线的中值直径。导电性填料颗粒的振实密度为1-10g/cm3,优选为2-8g/cm3。导电性填料的形状没有特别限制,其实例包括球形、近似球形、椭球形、纺锤形、立方体形、近似立方体形、薄片形和不定形。其中,从保存稳定性的观点出发,优选使用球形、近似球形和薄片形填料。薄片形填料的实例可包括板形、层形和鳞片形填料。薄片形填料的优选实例包括在侧面方向上具有薄板形且在正面方向上具有圆形、椭圆形、多边形或不定形的颗粒。具有这种形状的填料在填料之间具有高接触面积,这可以减少固化产物中的空隙。在一个实施方案中,导电性填料选自薄片形银填料、球形银填料及它们的混合物。银填料可从诸如metalortechnologies,ferrocorp.、technicinc.、eckartgmbh、amesgoldsmithcorp.、pottersindustriesinc.、dowaholdingsco.,ltd.、mitsui和fukuda购得。薄片形银填料的实例是由metalortechnologies以商品名silverflakeea出售的那些。球形或近似球形的银填料的实例是technic以商品名silverpowderfasab出售的那些。可用于本发明的导电性填料可以通过已知方法诸如还原法、研磨法、电解法、雾化法或热处理法来制造。在一个实施方案中,导电性填料的表面可以涂布有有机物质。有机物质的量优选为导电性填料的0.01-10重量%,更优选为0.1-2重量%。还优选根据导电性填料的形状等来调节有机物质的量。有机物质的量可以通过例如通过加热使有机物质挥发或热分解并测量重量减少来测量。在此,导电性填料“涂布有有机物质”的状态包括通过将导电性填料分散在有机溶剂中而使有机溶剂附着于导电性填料表面的状态。涂布导电性填料的有机物质的实例可包括亲水性有机化合物,诸如具有1至5个碳原子的烷基醇、具有1至5个碳原子的烷烃硫醇、和具有1至5个碳原子的烷烃多元醇,或具有1至5个碳原子的低级脂肪酸;和疏水性有机化合物,诸如具有15个或更多个碳原子的高级脂肪酸及其衍生物、具有6至14个碳原子的中级脂肪酸及其衍生物、具有6个或更多个碳原子的烷基醇、具有16个或更多个碳原子的烷基胺、或具有6个或更多个碳原子的烷烃硫醇。其中,高级脂肪酸、中级脂肪酸、及它们的金属盐、酰胺、胺或酯化合物是优选的。斥水性(疏水性)有机化合物更优选为高级或中级脂肪酸或其斥水性衍生物。考虑到其涂布效果,特别优选高级或中级脂肪酸。高级脂肪酸的实例包括直链饱和脂肪酸,诸如十五烷酸、十六烷酸、十七烷酸、十八烷酸、12-羟基十八烷酸、二十烷酸、二十二烷酸、二十四烷酸、二十六烷酸(蜡酸)或二十八烷酸;支化饱和脂肪酸,诸如2-戊基壬酸、2-己基癸酸、2-庚基十二烷酸或异硬脂酸;以及不饱和脂肪酸,诸如棕榈油酸、油酸、异油酸、反油酸、亚油酸、亚麻酸、蓖麻油酸、鳕油酸(gadoleicacid)、芥酸和鲨油酸(selacholeicacid)。中级脂肪酸的实例包括直链饱和脂肪酸,诸如己酸、庚酸、辛酸、壬酸、癸酸、十一烷酸、十二烷酸、十三烷酸或十四烷酸;支化饱和脂肪酸,诸如异己酸、异庚酸、2-乙基己酸、异辛酸、异壬酸、2-丙基庚酸、异癸酸、异十一烷酸、2-丁基辛酸、异十二烷酸和异十三烷酸;和不饱和脂肪酸,诸如10-十一碳烯酸。用于制造具有涂布有有机物质的表面的导电性填料的方法的实例包括但不特别限于在有机溶剂存在下通过还原法制造导电性填料的方法。具体地,导电性填料可以通过将羧酸银盐与伯胺混合并在有机溶剂存在下使用还原剂沉积导电性填料获得。还优选将获得的导电性填料分散在用于制造填料的溶剂中,并将该分散体直接添加至本发明的可固化粘合剂组合物中。另外,导电性填料的表面可以涂布有两个或更多个有机物质层。例如,可以通过将上述制造的具有有机物质涂层的导电性填料分散到其他有机溶剂中来获得这样的填料。可以将待添加到本发明的可固化粘合剂组合物中的溶剂优选用作这样的“其他溶剂”。当导电性填料的表面涂布有有机物质时,可以进一步防止或减少导电性填料在可固化粘合剂组合物中的聚集。导电性填料可以单独使用或将两种或更多种组合使用。不同形状或不同尺寸的填料的组合可降低固化产物的孔隙率。组合的实例包括但不限于薄片形填料与中心粒径小于薄片形填料中心粒径的近似球形的填料的混合物。薄片形填料与近似球形填料的质量比为0.3-5,优选为0.4-3。根据本发明,基于用于芯片贴装的可固化粘合剂组合物的总重量,第二金属或合金的颗粒以60重量%至95重量%、优选为70重量%至90重量%、更优选75重量%至85重量%的量存在。本文所述的可固化粘合剂组合物可任选地包含一种或多种固化剂。固化剂可以在组合物中任选地用作引发剂、促进剂和/或还原剂。考虑用于实践本发明的固化剂包括脲、脂族和芳族胺、聚酰胺、咪唑、双氰胺、酰肼、脲-胺杂化固化体系、自由基引发剂、有机碱、过渡金属催化剂、酚、酸酐、路易斯酸、路易斯碱、过氧化物等。例如参见美国专利号5,397,618,其全部内容通过引用并入本文。固化剂的掺入取决于热固性或热塑性树脂组分的选择。如果将环氧树脂用作树脂组分,则固化剂的实例可以是脂族和芳族胺、酸酐、咪唑及它们的混合物。如果将(甲基)丙烯酸酯用作树脂组分,则固化剂可以例如为过氧化物,诸如叔丁基氢过氧化物、过苯甲酸叔丁酯、过氧化苯甲酰、枯烯过氧化物、枯烯氢过氧化物、甲乙酮过氧化物和本领域已知的其他过氧化物。基于用于芯片贴装的可固化粘合剂组合物的总重量,固化剂可任选地以0重量%至10重量%、优选0.1重量%至8重量%、更优选0.3重量%至5重量%的量存在于组合物中。本文所述的可固化粘合剂组合物可进一步包含稀释剂,包括例如有机稀释剂。有机稀释剂可以是反应性有机稀释剂、非反应性有机稀释剂或它们的混合物。示例性的稀释剂包括例如芳族烃(例如,苯、甲苯、二甲苯等);脂族烃(例如己烷、环己烷、庚烷、十四烷等);氯代烃(例如二氯甲烷、氯仿、四氯化碳、二氯乙烷、三氯乙烯等);醚(例如乙醚、四氢呋喃、二噁烷、二醇醚、乙二醇的单烷基或二烷基醚等);酯(例如乙酸乙酯、乙酸丁酯、乙酸甲氧基丙酯、乙酸丁氧基乙氧基乙酯等);多元醇(例如聚乙二醇、丙二醇、聚丙二醇等);酮(例如丙酮、甲乙酮等);酰胺(例如二甲基甲酰胺、二甲基乙酰胺等);杂芳族化合物(例如n-甲基吡咯烷酮等);和杂脂族化合物。根据本发明考虑使用的非反应性稀释剂的量可以广泛地变化,只要采用足够的量来溶解和/或分散本发明组合物的组分即可。当存在时,所用的非反应性稀释剂的量通常在组合物的约2重量%至约30重量%的范围内。如本领域技术人员容易认识到的,在某些实施方案中,本发明的组合物中基本上不包含非反应性稀释剂。即使偶尔存在非反应性稀释剂,也可以在固化过程中将其除去。本发明配制物可进一步包含一种或多种流动添加剂、粘附促进剂、流变改性剂、增韧剂、助熔剂和/或自由基聚合调节剂,以及它们中任意两种或更多种的混合物。可以通过将所有组分混合在一起以获得均匀混合物来制备根据本发明的可固化粘合剂组合物。混合在室温下进行。混合装置可以是例如轨道运动(行星式)混合器或强制混合器。本发明的可固化粘合剂组合物为液体形式,并且该组合物的brookfield粘度在25℃和5rpm优选为约1,000cps至约40,000cps。在这种粘度范围内的液体粘合剂组合物具有良好的流动性,这使得易于将其施用或注入到基板上。当施用时,可固化粘合剂组合物的粘合层厚度可以控制为小于50μm,优选为5-30μm,更优选为10-30μm。可固化粘合剂组合物能够在氮气气氛中在200℃固化。本发明的另一方面涉及通过特别是在氮气气氛和200℃将可固化粘合剂组合物热固化而形成的固化产物。固化产物可表现出小于50μm、优选5-30μm、更优选10-30μm的粘合层厚度。在该芯片贴装过程中,芯片在足够程度的压力和/或热量下与芯片贴装粘合剂接触,使得粘合剂铺展并完全覆盖芯片下方的基板。理想的是,如图1所示,粘合剂在芯片的外围处进一步形成填角,即凸起的边缘或凸脊。在芯片贴装粘合剂的分配中,当使用薄芯片并且当芯片堆叠时,常规的糊膏芯片贴装材料不适用于这些应用,因为芯片贴装材料不容易在所需边界处形成填角,并且容易溢出到半导体封装的拥挤空间中,并污染相邻的芯片和电气互连,或者溢出到芯片的顶部,这将影响后续的引线连接工艺。另外,如果不施用压力,则难以实现正确水平的粘合剂流动和粘合。当对薄芯片施用压力时,芯片会破裂、倾斜或翘曲。令人意外的是,本发明的可固化粘合剂组合物和固化产物适合于具有小于5mm的宽度和小于5mm的长度的尺寸的较薄/较小的芯片,而没有上述缺点。本发明的另一方面提供了一种组件,其包括通过固化产物粘附至基板的芯片。本发明的另一方面提供了一种芯片贴装的方法,其包括:(a)将可固化粘合剂组合物施用于基板,(b)使所述基板与芯片紧密接触以形成组件,以及(c)使所述组件处于适合于使所述可固化粘合剂组合物固化的条件。具体地,根据本发明的可固化粘合剂组合物可以通过自动分配系统的针筒,在压力/载荷力下按照预定的路线涂布到基板诸如印刷电路板的表面上。然后,将芯片层合到粘合剂组合物上,并通过间隔物控制基板与芯片之间的高度差。在粘合剂在整个粘合区域上自流平之后,在空气或氮气的气氛中从上到下进行加热以固化,并且固化时间通常可以为约0.5小时至约5小时。载荷力通常可以为约50g至1,000g。组合物的固化产物的粘合层厚度小于50μm,优选为5-30μm,更优选为10-30μm。固化产物的倾斜小于30μm,优选小于20μm,更优选小于15μm。本文描述的配制物可以在电子工业和其他工业应用中使用。例如,本文所述的配制物可用于:功率分离元件(powerdiscretes)的引线框上的芯片贴装应用、作为高性能分离元件的引线连接替代的夹具连接应用、用于带裸露焊盘的功率分离元件的冷却的散热板(heatslug)连接应用、用于单芯片和多芯片器件、以及用于需要在芯片与框之间具有高导电率和/或导热率的其他器件。以下实施例旨在帮助本领域技术人员更好地理解和实践本发明。本发明的范围不受实施例限制,而是由所附权利要求书限定。除非另有说明,否则所有份数和百分比均基于重量。实施例材料ex-201-im为可得自nagasechemtexcorporation的间苯二酚二缩水甘油醚。dpm是可得自lyondellchemical的二丙二醇单甲醚。epiclonb-570是可得自dic的4-甲基四氢邻苯二甲酸酐。银薄片ea0295-004是振实密度为4.4g/cm3且d50粒度为5.3μm的银填料,可得自metalortechnologies。银粉fasab499是振实密度为5.6g/cm3且d50粒度为3.9μm的银填料,可得自technicinc.。mcp137是振实密度为8.58g/cm3且d50粒度为27μm的bi58/sn42合金,可得自5nplusinc.。cm1016是可得自henkel的x-双马来酰亚胺,其结构为ricon130ma20是加合有马来酸酐的聚丁二烯低聚物,可得自sartomercompany.inc.。sr423a是可得自sartomercompany.inc.的甲基丙烯酸异冰片酯。beea是可得自sigma-aldrich的纯度为99%的乙酸丁氧基乙氧基乙酯。a6153是可得自sigma-aldrich的二枯基过氧化物。sa0201是可得自metalortechnologies的d50粒度为5.3μm的银填料。epiclonn-730是可得自dainipponink&chemical的表氯醇-苯酚甲醛。seikacure-s是可得自sumitomochemical的4,4'-二氨基二苯酚砜。1,4-丁二醇二缩水甘油醚是可得自nationalstarch&chemical的78-4603。碳酸胺催化剂是得自chemica的n,n'-(4-甲基-1,3-亚苯基)-双-1-吡咯烷-甲酰胺。gs-230是可得自seikisuichemical的d50粒度为30μm的二乙烯基苯聚合物间隔物。silpowder81-637是可得自technicinc.的d50粒度为30μm的银间隔物。实施例1将5g环氧树脂(ex-201-im)、5g溶剂(dpm)和5g固化剂(epiclonb-570)添加到容器中,并使用thinky混合器(thinkycorporation,arv-310)以2000rpm搅拌2分钟以获得均匀溶液。然后添加24.5g片状银填料(银片ea0295-004)和59.2g球状银填料(银粉fasab499)并在1500rpm下搅拌2分钟。最后,在真空条件下添加1.3g间隔物(mcp137)并在1500rpm下搅拌2分钟以获得均匀的可固化粘合剂糊膏。所制备糊膏的密度为约5.5g/cm3。在以下条件下将糊膏组合物加载到芯片上:间隔物的载荷为1.3重量%(20/mm2)。固化过程为:在n2气氛中以5℃/min升至140℃,保持30分钟,然后以5℃/min升至200℃,保持60分钟。芯片尺寸为1mm×1mm。载荷力为100g。实施例2将5gbmi树脂(cm1016)、1.5gbmi低聚物(ricon130ma20)、4g(甲基)丙烯酸酯单体(sr423a)、5g稀释剂(beea)和0.5g固化剂(a6153)添加到容器中,并使用thinky混合器(thinkycorporation,arv-310)在2000rpm下搅拌2分钟以获得均匀溶液,然后,添加82.5g球形银填料(sa0201)并在1500rpm下搅拌2分钟。最后,在真空条件下添加1.5g间隔物(mcp137)并在1500rpm下搅拌2分钟以获得均匀的可固化粘合剂糊膏。所制备的糊膏的密度为约4.9g/cm3。在以下条件下将糊膏组合物加载到芯片上:间隔物的载荷为1.5重量%(20/mm2)。固化过程为:在n2气氛中以5℃/min升至200℃,保持30分钟。芯片尺寸为1mm×1mm。载荷力为100g。实施例3将15g环氧树脂(epiclonn-730)、2g固化剂(sekiacure-s)、7g稀释剂(1,4-丁二醇二缩水甘油醚)和1g催化剂(碳酸胺)添加到容器中,并使用thinky混合器(thinkycorporation,arv-310)在2000rpm下搅拌2分钟以获得均匀溶液,然后,添加73.1g片状银填料(银片ea0295-004)并在1500rpm下搅拌2分钟。最后,在真空条件下添加1.9g间隔物(mcp137)并在1500rpm下搅拌2分钟以获得均匀的可固化粘合剂糊膏。所制备的糊膏密度为约4.0g/cm3。在以下条件下将糊膏组合物加载到芯片上。间隔物的载荷为1.9重量%(20/mm2)。固化过程为:在n2气氛中以5℃/min升至175℃,保持60分钟。芯片尺寸为1mm×1mm。载荷力为100g。对比例1将5g环氧树脂(ex-201-im)、5g溶剂(dpm)和5g固化剂(epiclonb-570)添加到容器中,并使用thinky混合器(thinkycorporation,arv-310)在2000rpm下搅拌2分钟以获得均匀溶液。添加25g片状银填料(银片ea0295-004)和59.8g球形银填料(银粉fasab499),然后在1500rpm下搅拌2分钟。最后,在真空条件下添加0.2g间隔物(gs-230)并在1500rpm下搅拌2分钟以获得均匀的可固化粘合剂糊膏。所制备的糊膏的密度为约5.5g/cm3。在以下条件下将糊膏组合物加载到芯片上。间隔物的载荷为0.2重量%(20/mm2)。固化过程为:在n2气氛中以5℃/min升至140℃,保持30分钟,以及以5℃/min升至200℃,保持60分钟。芯片尺寸为1mm×1mm。载荷力为100g。对比例2将5gbmi树脂(cm1016)、1.5gbmi低聚物(ricon130ma20)、4g(甲基)丙烯酸酯单体(sr423a)、5g稀释剂(beea)和0.5g固化剂(a6153)添加到容器中并使用thinky混合器(thinkycorporation,arv-310)在2000rpm下搅拌2分钟以获得均匀溶液。然后,添加81.8g球形银填料(sa0201)并以1500rpm搅拌2分钟。最后,在真空条件下添加2.2g间隔物(silpowder81-637)并在1500rpm下搅拌2分钟以获得均匀的可固化粘合剂糊膏。所制备的糊膏的密度为约4.9g/cm3。在以下条件下将糊膏组合物加载到芯片上。间隔物的载荷为2.2重量%(20/mm2)。固化过程为:在n2气氛中以5℃/min升至200℃,保持30分钟。芯片尺寸为1mm×1mm。载荷力为100g。性能评价在固化之前和固化之后,使用以下方法评价实施例。blt通过leicadms1000显微镜(leicamicrosystems制造)测量blt。在固化之前和之后,分别测量具有和不具有糊膏的芯片的四个角的高度,并取平均至。将基板设置为零高度基线。固化之前和固化之后的blt计算如下:固化之前的blt=(固化之前含糊膏的芯片的平均高度)-(固化之前不含糊膏的芯片的平均高度);固化之后的blt=(固化之后含糊膏的芯片的平均高度)-(固化之后不含糊膏的芯片的平均高度)。倾斜趋势通过leicadms1000显微镜(leicamicrosystems制造)测量倾斜趋势。固化之前和固化之后的倾斜计算如下:固化之前的倾斜=(固化之前含糊膏的芯片的最高高度)-(固化之前含糊膏的芯片的最低高度);固化之后的倾斜=(固化之后含糊膏的芯片的最高高度)-(固化之后含糊膏的芯片的最低高度)。空隙使用phoenixx-ray机(由phoenixx-raysystems&servicesgmbh制造),通过观察带有固化的粘合剂的芯片来测量固化的粘合剂的空隙。空隙可以直接从所获得的x射线图像目视发现。如果在图像上未发现任何空隙,则将其评价为“否”,如果在图像上清楚地发现了任何空隙,则评估为“是”。测试结果示于表1中。显然,在使用较小尺寸的芯片时,所有本发明实施例均具有优异的blt、填角、倾斜趋势和空隙(如图3所示)控制,而包含有机聚合物或高熔点金属的常规间隔物的所有对比例在倾斜趋势和空隙方面均表现出差的性能(如图4和5所示)。表1.测试结果测试项目实施例1实施例2实施例3对比例1对比例2固化前的blt(μm)22.22417.429.825.3固化后的blt(μm)18.218.61524.424.8固化前的倾斜(μm)9.814.51320.89.3固化后的倾斜(μm)9.8119.816.812.7空隙否否否是是当前第1页1 2 3
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询

tips


 商标分类
商标分类  商标转让
商标转让 



