用于减少缺陷的抛光组合物及其使用方法与流程
 2021-02-02 16:02:48|
2021-02-02 16:02:48| 247|
247| 起点商标网
起点商标网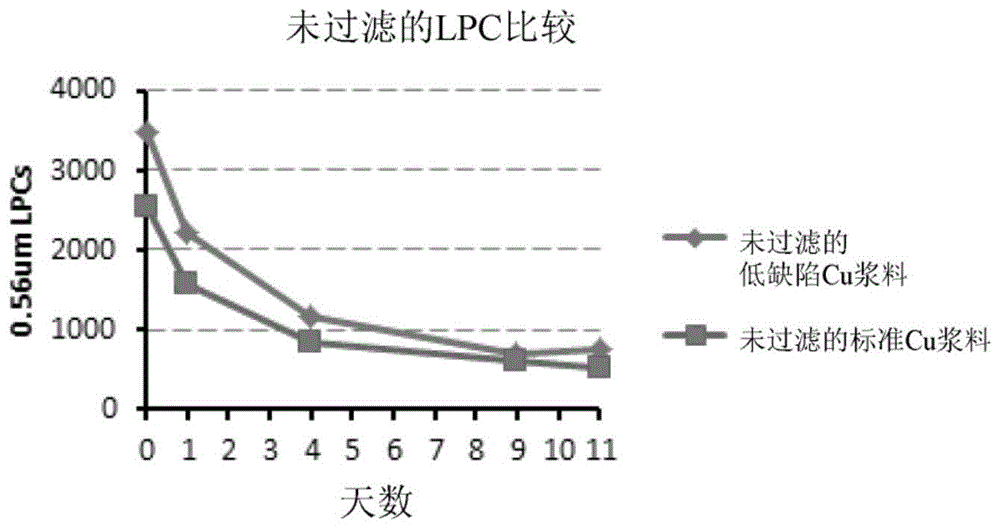
本公开涉及化学机械抛光组合物。更特别地,本公开涉及这样的具有低于期望阈值的大颗粒计数的组合物。
背景技术:
:铜是在半导体制造中用于形成互连的常用材料。一旦通过例如镶嵌工艺形成铜镶嵌结构,就通过抛光并清除镶嵌线之间的铜和阻挡金属来制造隔离的铜线。铜和阻挡层cmp涉及铜和阻挡层的抛光。期望以高材料去除速率对晶片进行抛光以提高处理能力,同时仍保持有利的晶片特性,例如低的总缺陷数。称为化学机械抛光或平坦化(cmp)的工艺涉及使用抛光垫和浆料对半导体晶片上的不同层进行抛光/平坦化,以在构造后续层之前抛光掉多余或不需要的材料层。铜是在半导体制造中用于形成互连的常用材料。一旦通过例如根据由例如镶嵌工艺所决定的图案来沉积铜的镶嵌工艺形成铜镶嵌结构,就通过抛光并清除镶嵌线之间的铜和阻挡金属来制造隔离的铜线。铜和阻挡层cmp涉及使用一种抛光浆料或多种抛光浆料以将铜和阻挡层去除至进行半导体制造过程中的下一步骤所需的程度。典型的铜cmp工艺由3个工艺步骤组成。首先,以相对高的向下力对电镀铜覆盖层(overburden)(根据技术节点,其厚度可以高至5μm或更大)进行快速抛光,留下一些量的铜直到使沉积形貌完全平坦化。以较低的向下力抛光掉在第一步骤期间在完全平坦化之后剩余的铜覆盖层,在阻挡层上停止。用于增加处理能力的高去除速率与平坦化效率和低缺陷的结合是cmp工艺的关键需求。特别地,如果来自铜cmp步骤的不期望的深划痕具有足够的深度而无法在随后的阻挡层抛光中去除,则它们可能在芯片制造的后期阶段期间继续存在。这类划痕最终可能损害器件性能并导致无功能的装置以及降低的晶片良品率。cmp工艺类似地用于对包含铜之外的金属和/或介电材料的基底(同时还可能另外包含铜)进行抛光。因此,在半导体工业中寻求改善的抛光组合物及其使用方法。技术实现要素:提供该
发明内容以介绍在以下详细描述中进一步描述的概念的选择。该
发明内容不旨在确定所要求保护的主题的关键或必要特征,也不旨在用作帮助限制所要求保护的主题的范围。在一个方面中,本文中公开的实施方案涉及化学机械抛光组合物,其包含磨料、第一去除速率增强剂和水,其中,当使用0.2μm的面元尺寸(binsize)测量时,抛光组合物对于以下关系具有小于800000的值:大颗粒计数/磨料重量百分比。本公开还提供了用所述组合物抛光基底的方法。在另一方面中,本文中公开的实施方案涉及化学机械抛光组合物,其包含磨料、第一去除速率增强剂和水,其中,当使用0.2μm的面元尺寸测量时,抛光组合物对于以下关系具有小于50000的值:大颗粒计数/固体重量百分比。在另一方面中,本公开提供了制备抛光组合物的方法,其中所述抛光组合物包含磨料、第一去除速率增强剂和水。当使用0.2μm的面元尺寸测量时,抛光组合物对于以下关系具有小于800000的值:大颗粒计数/磨料重量百分比。该方法包括以下步骤:选择磨料使得其符合所述值,以及将磨料、第一去除速率增强剂和水合并。根据以下描述和所附权利要求,所要求保护的主题的其他方面和优点将是明显的。附图说明图1示出了现有技术的未过滤的浆料(图1至13中的“标准浆料”)和根据本公开的未过滤的组合物(图1至13中的“低缺陷浆料”)使用0.56μm的面元尺寸的lpc计数。图2示出了现有技术的未过滤的浆料和根据本公开的未过滤的组合物使用1.01μm的面元尺寸的lpc计数。图3示出了现有技术的未过滤的浆料和根据本公开的未过滤的组合物使用0.29μm的面元尺寸的lpc计数。图4示出了现有技术的未过滤的浆料和根据本公开的未过滤的组合物使用0.2μm的面元尺寸的lpc计数。图5是示出现有技术的浆料和根据本公开的组合物的归一化铜去除速率的比较的图。图6是示出在使用现有技术的浆料和根据本公开的组合物对具有各种cu图案(即,线宽/密度)的晶片抛光之后观察的凹陷(dishing)的比较的图。图7示出了与现有技术的抛光浆料相比,本公开的组合物的归一化的总缺陷计数。图8示出了与现有技术的抛光浆料相比,本公开的组合物的归一化的划痕总数。图9示出了十种抛光组合物在老化0天、3天和7天时使用0.2μm的面元尺寸的lpc计数。图10示出了十种抛光组合物在老化0天、3天和7天时使用0.29μm的面元尺寸的lpc计数。图11示出了十种抛光组合物在老化0天、3天和7天时使用0.56μm的面元尺寸的lpc计数。图12示出了十种抛光组合物在老化0天、3天和7天时使用1.01μm的面元尺寸的lpc计数。图13示出了现有技术的抛光浆料和本公开的组合物在使其经受使用0.1μm深度过滤器的过滤之后在11天的时间段内使用0.2μm的面元尺寸测量的lpc计数的图。图14示出了浆料1至10在配制之后0天、3天和7天时在0.2μm的面元尺寸下测量的lpc/二氧化硅重量百分比。图15示出了浆料1至10在配制之后0天、3天和7天时在0.29μm的面元尺寸下测量的lpc/二氧化硅重量百分比。图16示出了浆料1至10在配制之后0天、3天和7天时在0.2μm的面元尺寸下测量的lpc/固体重量百分比。图17示出了浆料1至10在配制之后0天、3天和7天时在0.29μm的面元尺寸下测量的lpc/固体重量百分比。具体实施方式本文中公开的实施方案提供了化学机械抛光组合物,当与已知的cmp组合物相比时,所述化学机械抛光组合物能够使缺陷特别是微划痕最小化。本公开的组合物包含具有特别限制为低于限定水平的大颗粒计数(lpc)的磨料。由此在使用本公开的组合物时避免了较高水平的lpc的有害影响(例如,高水平的缺陷)或使其最小化,同时仍保持相同或更高程度的抛光活性。本公开的组合物具有低于某一阈值的大颗粒计数(lpc),所述大颗粒计数是指大于某一尺寸的颗粒的数目。在cmp领域中,组合物的lpc与经抛光的表面上的缺陷(例如划痕)数目之间明确的相关性仍然不明。本发明人出乎意料地发现,当组合物的lpc数相对于组合物中的磨料(或固体)的量保持低于某一量时,存在明显改善的结果。cmp浆料中的lpc可以来自浆料中使用的磨料,或者在浆料配制期间作为固体添加的可以随时间溶解但是可能缓慢和/或不完全溶解的其他组分(例如,腐蚀抑制剂、去除速率增强剂等)。如将在本申请中进一步详细说明的,本发明人已经发现,通过使用以下抛光组合物,在抛光期间可以使划痕或缺陷最小化,同时保持相同或更高的抛光速率:在使用0.2μm的面元尺寸测量lpc时(即,当lpc被分类为大于0.2μm的颗粒时),所述抛光组合物包含小于800000的lpc/磨料重量百分比(即,对于关系:大颗粒计数/磨料重量百分比而言小于800000lpc的值)。此外,相关地,以下抛光组合物还实现了比具有更高lpc/固体重量百分比读数的组合物更少的晶片缺陷和划痕:当使用0.2μm的面元尺寸测量lpc时,所述抛光组合物具有小于50000的lpc/固体重量百分比(即,对于关系:大颗粒计数/在配制期间作为固体添加的组分的重量百分比而言小于50000lpc的值)。%固体(固体重量百分比)旨在与%磨料(磨料重量百分比)具有如下区别,%固体包括在配制期间以固体形式添加的所有组分,其中一些可能在老化时最终溶解或部分溶解。不论组合物的整体组成如何,将lpc计数标准化为磨料重量百分比或固体重量百分比允许组合物的直接比较,因为发明人已经观察到如果各种组合物(例如,具有0.08磨料重量百分比的那些至具有10磨料重量百分比的那些)具有超出上述范围的lpc计数,则对它们观察到更高的划痕。如以下更详细讨论的,本公开中所述的益处是出乎意料的,因为当使用高于本文中确定的阈值的常规阈值测量lpc时,这些益处没有出现。所要求的比率的益处仅在使用以下讨论的更小的面元尺寸测量lpc时出现。此外,先前认为cmp组合物的去除速率增强剂显著有助于lpc和缺陷,但是本公开提出磨料是划痕缺陷的最大贡献者。这是本公开的比率使用较小的lpc阈值(更旨在包含组合物中的磨料颗粒)的原因。如以下还讨论的,当组合物满足所要求的比率的限度时,出现显著的益处。如上所述,如果来自cmp步骤的不期望的深划痕具有足够的深度而无法在任何后续抛光步骤中去除,则它们可能在芯片制造的后期阶段期间继续存在。这类划痕可能最终损害器件性能,并且深划痕背后的潜在元凶之一可能是存在于cmp浆料中的大的不期望的颗粒。这些不期望的颗粒的存在通常通过光散射技术来监测以确定lpc,其中对溶液中直径高于所选阈值(常规地,约0.5微米(μm)和/或约1.0μm)的颗粒的浓度进行量化。常规选择的尺寸阈值(例如,0.5μm和/或1.0μm)通常远高于溶液中期望颗粒(例如,磨料)的尺寸分布的第99百分位,并因此阻止了关于浆料中有助于lpc的颗粒是否是不期望的(例如,污染物)还是期望的混淆。然而,发明人出乎意料地发现,磨料颗粒的大于约0.2μm的部分与增加的划痕高度相关。因此,由于需要实现令人满意的去除速率和整体抛光性能而通常被认为是期望的磨料的部分实际上是有害的并且显著地促使在抛光期间非常不期望的划痕。如在本公开中稍后呈现的实施例中所证明的,发明人已经发现,当与使用0.2μm的面元尺寸测量lpc时具有更高lpc/磨料重量百分比的相似配制的抛光组合物相比时,将lpc/磨料重量百分比控制为在使用0.2μm的面元尺寸测量lpc时小于800000产生实现减少的晶片缺陷/划痕的抛光组合物。不受理论的束缚,本发明人认为,由于lpc限度减少了组合物中由于它们的硬度和尺寸而最可能产生划痕的较大磨料的相对量,因此当遵守上述lpc限度时实现了缺陷/划痕的减少。实际上,在美国专利第9914852号的
背景技术:
部分中,讨论了大于约0.5μm的颗粒被教导为存在潜在的划痕问题,但是其中没有提及如本申请中所证明的限制大于0.2μm的颗粒以在抛光期间减少缺陷/划痕的重要性。在抛光浆料中,当在0.2μm的面元尺寸下测量时,lpc由磨料控制,而由于用于抛光组合物中使用的磨料的典型尺寸选择,使用更大的面元尺寸(例如,约0.5μm和约1μm)的测量中磨料组分的表现少得多。用于抛光组合物的磨料具有这样的粒径分布:即使两种不同的磨料可能具有相似或甚至相同的平均粒径,粒径分布也可能根据合成方法或合成过程的参数而显著不同。例如,取平均粒径各自为60nm的两种磨料源,一种磨料源可以具有比具有较窄粒径分布的另一种磨料源更宽的粒径分布和更大比例的大于200nm(即,大于0.2μm的面元尺寸)的颗粒。因此,当在0.2μm的面元尺寸下测量时,即使它们具有相同的平均粒经,较宽分布磨料源的lpc也将高于(并且可能超出本公开中所述的限度)较窄分布的磨料源。前述段落中所讨论的考虑是不能假定目前可获得的浆料或组合物具有本公开的特性的一个原因。目前的浆料可能具有相似的平均粒径,但是这并不意味着它们在所述的面元尺寸下具有相同的lpc计数。此外,如先前在本说明书中描述的,由于在较大面元尺寸下差异根本不明显,因此没有迹象表明本申请组合物的lpc计数与目前可获得的组合物的lpc计数相比可能有或将有这样的分歧。应选择本公开的磨料使得它们实现期望的lpc计数和比率。如先前在本公开中提出的,即使将浆料过滤也不必然意味着lpc将降低至本公开的阈值水平。本公开的磨料还可以进行化学处理或用特定的化学合成形成以确保它们满足期望的lpc特性。实际上,可以使用过滤过程以试图从产品或浆料制剂中去除大于一定尺寸的颗粒。然而,即使使用过滤也可能无法一直有效地将lpc降低至使划痕或缺陷最小化的水平。例如,并且如将在本公开中稍后呈现的实施例中所示,0.1μm深度过滤器在将lpc降低至低于800000lpc/磨料重量百分比或50000lpc/固体重量百分比的阈值方面不是有效的。这不是直观的,因为将预期具有0.1μm孔直径的过滤器将能够显著减少能够在0.2μm的面元尺寸中引起计数的颗粒(包括大于0.2μm的颗粒)的出现。然而,深度过滤器具有宽的孔径分布,并且允许大于额定值的组分的至少一部分通过过滤器。因此,在一个或更多个实施方案中,本公开的抛光浆料在配制之后不过滤和/或用于抛光浆料的磨料组分在配制之前不过滤。例如,当磨料由供应商提供时,它们通常分散在溶液内,然后与其他组分一起混合以配制浆料。因此,在一些实施方案中,由供应商提供的分散的磨料溶液在配制成抛光浆料之前不过滤。在一个或更多个实施方案中,抛光组合物包含选自以下的磨料:氧化铝、热解法氧化硅、胶态氧化硅、涂覆颗粒、氧化钛、氧化铈、氧化锆、及其任意混合物。在一个或更多个实施方案中,磨料选自热解法氧化硅、胶态氧化硅及其混合物。在一个或更多个实施方案中,抛光组合物包含选自有机酸和有机酸盐的去除速率增强剂。在更具体的实施方案中,去除速率增强剂选自氨基酸、羧酸、多胺、基于氨的化合物、季铵化合物、无机酸、具有羧基官能团和氨基官能团二者的化合物、乙二胺四乙酸、二亚乙基三胺五乙酸、及其任意混合物。在一个或更多个实施方案中,抛光组合物包含选自唑、唑衍生物及其混合物的腐蚀抑制剂。在更具体的实施方案中,腐蚀抑制剂可以选自苯并三唑、苯并三唑衍生物、甲苯基三唑及其混合物。在一个或更多个实施方案中,抛光组合物包含选自以下的氧化剂:过氧化氢、过硫酸铵、硝酸银、硝酸铁、氯化铁、过酸、过酸盐、臭氧水、铁氰化钾、重铬酸钾、碘酸钾、溴酸钾、三氧化钒、次氯酸、次氯酸钠、次氯酸钾、次氯酸钙、次氯酸镁、硝酸铁、kmno4、其他无机过氧化物或有机过氧化物、及其任意混合物。在一个或更多个实施方案中,抛光组合物包含选自以下的至少一者:表面活性剂、第二去除速率增强剂、杀生物剂、表面精整剂、ph调节剂、缺陷减少剂、凹陷减少剂、动态表面张力减小剂、或其任意混合物。在一个或更多个实施方案中,本文中所述的抛光组合物可以基本上不含某些成分中的一种或更多种,例如盐(例如卤化物盐)、聚合物(例如阳离子或阴离子聚合物,或凹陷减少剂之外的聚合物)、表面活性剂(例如铜腐蚀抑制剂之外的那些)、增塑剂、氧化剂、腐蚀抑制剂(例如,非唑类腐蚀抑制剂)、和/或某些磨料(例如,氧化铈或氧化铝磨料或非离子磨料)。可以从抛光组合物中排除的卤化物盐包括碱金属卤化物(例如卤化钠或卤化钾)或卤化铵(例如氯化铵),并且可以为氯化物、溴化物或碘化物。如本文中所使用的抛光组合物“基本上不含”的成分是指不是有意添加到抛光组合物中的成分。在一些实施方案中,本文中所述的抛光组合物可以具有至多约1000ppm(例如,至多约500ppm、至多约250ppm、至多约100ppm、至多约50ppm、至多约10ppm、或至多约1ppm)的抛光组合物基本上不含的一种或更多种上述成分。在一些实施方案中,所描述的抛光组合物可以完全不含一种或更多种上述成分。实施例在以下呈现的实施例中,使用配备有particlemeasuringsystemsinc.(boulder,co)liquilazs02液体光学颗粒计数器的celerity(tualatin,or)浆料颗粒测量车型号ad10300-01,随时间测量0.2μm、0.29μm、0.56μm和1.01μm面元尺寸的参照的lpc测量结果。所有样品在车内用0.04μm过滤的去离子水稀释至500倍至1000倍以使计数达到适合于s02颗粒计数器的水平。所报道的lpc考虑了所有稀释物(图1至4)。此外,在某些实施例中,通过%二氧化硅(二氧化硅重量百分比)负载(图14和图15)以及%固体负载(图16和图17)将结果归一化。实施例1在该实施例中,在多个面元尺寸下测量现有技术的浆料和根据本公开的组合物二者在11天的时间段内lpc计数的变化。现有技术的抛光浆料的lpc计数超过了根据本公开的抛光浆料所教导的限度。相反地,本公开的抛光组合物的lpc计数低于根据本公开的抛光浆料所教导的限度。两种抛光浆料的组分在化学上相同,并且在每种组合物内以相同的量使用。当配制抛光组合物时,最初可以添加两种类型的固体材料。一种类型是在组合物中保持固体的固体,例如磨料,而另一种类型的组分是在一段时间内溶解在组合物中的固体。随时间保持固体的固体将在浆料的lpc计数中保持稳定存在,而溶解的固体将在浆料的lpc计数上显示减少的存在,并且一旦溶解,也将不会造成在抛光期间划伤晶片的担忧。常规思维假设较大的颗粒在抛光时导致划痕缺陷,并因此通常使用0.56μm和/或1.01μm的面元尺寸测量和报道lpc值。即,通常的做法是测量大于约0.56μm和/或1.01μm的颗粒的lpc计数,并努力使它们在抛光浆料中的存在最小化。图1和2分别示出了未过滤的现有技术的浆料和未过滤的本公开的抛光组合物在0.56μm和1.01μm的面元尺寸下的lpc计数。这些图显示的是两种浆料在这些面元尺寸的lpc开始高,然后随着时间发展在更低且基本相同的值处稳定。该结果表明在两个面元尺寸的lpc主要由随时间溶解的组分而不是随时间不溶解的固体磨料组分控制。此外,因为值在大致相同的值处稳定,所以当与现有技术的组合物相比时,低缺陷组合物减少缺陷的能力(图7和8中所示)无法通过这两个尺寸范围内的lpc值来说明。图3示出了未过滤的现有技术的浆料和未过滤的本公开的抛光组合物在0.29μm的面元尺寸下的lpc计数(即,对尺寸大于0.29μm的颗粒进行计数)。与0.56μm和1.01μm的面元尺寸的结果相似,图3中的结果显示两种浆料在这些面元尺寸的lpc开始高,然后随着时间发展在更低且基本相同的值处稳定。因此,当与现有技术的组合物相比时,该面元尺寸的颗粒也由随时间溶解的组分控制,并且无法说明低缺陷组合物减少缺陷的能力(稍后在实施例4中讨论并且在图7和8中示出)。图4示出了未过滤的现有技术的浆料和未过滤的本公开浆料的抛光组合物在0.2μm的面元尺寸下的lpc计数(即,对尺寸大于0.2μm的颗粒进行计数)。在此,两种不同浆料的lpc计数显示出显著的分歧。具体地,lpc计数在测试的时间段内保持相对稳定,表明该值主要由非溶解磨料组分控制。其次,现有技术的组合物获得的值是本公开的抛光组合物获得的计数值的大于两倍。结合稍后在实施例4中讨论并在图7和8中示出的结果,该结果出乎意料地表明,通过特别地控制尺寸大于0.2μm的颗粒的量,可以实现经抛光的晶片上划痕/缺陷的减少。实施例2在实施例2中,在两个不同的向下力值下,对现有技术的抛光浆料的铜覆盖层(blanket)去除速率与本公开的抛光组合物的铜去除速率进行比较。现有技术的抛光浆料的lpc计数超过了根据本公开的抛光浆料所教导的限度。相反地,本公开的抛光组合物的lpc计数低于根据本公开的抛光浆料所教导的限度。两种抛光浆料的组分在化学上相同,并且在每种组合物内以相同的量使用。图5中呈现的结果证明在每个向下力值下每种浆料的铜去除速率在正常的晶片对晶片工艺(wafer-to-waferprocess)变化中是相当的。实施例3在实施例3中,对用现有技术的抛光浆料抛光晶片之后观察到的凹陷与用本公开的抛光组合物抛光之后观察到的凹陷进行比较。现有技术的抛光浆料的lpc计数超过了根据本公开的抛光浆料所教导的限度。相反地,本公开的抛光组合物的lpc计数低于根据本公开的抛光浆料所教导的限度。在每种组合物中两种抛光浆料的组分使用相同的化学组分。此外,当使用每种组合物时,抛光条件相同。图6中呈现的结果证明在具有各种cu图案(即线宽/密度)的晶片上使用两种浆料之后,观察到的凹陷量是相当的。实施例4在该实施例中,对在经现有技术的抛光浆料抛光的覆盖层铜晶片上发现的总缺陷和缺陷类型与在经本公开的抛光组合物抛光的覆盖层铜晶片上发现的那些进行比较。现有技术的抛光浆料的lpc计数超过了根据本公开的抛光浆料所教导的限度。相反地,本公开的抛光组合物的lpc计数低于根据本发明的抛光浆料所教导的限度。两种抛光浆料的组分在化学上相同,并且在每种组合物内以相同的量使用。此外,当使用每种组合物时,抛光条件相同。图7显示当将数据归一化时,本公开的抛光组合物的总缺陷计数显著低于在用现有技术的抛光浆料抛光时观察到的那些。图8显示当将数据归一化时,本公开的抛光组合物的划痕总数显著低于在用现有技术的抛光浆料抛光时观察到的那些。此外,由于在图8中获得的对使用本公开的抛光组合物获得的划痕数的值与在图7中示出的对缺陷总数的值的强相关性(即,归一化的值在约0.6处相似),因此可以得出结论,在经抛光的晶片上观察到的大多数缺陷是划痕,而不是污点、有机残留物、腐蚀等。该结果还显示当用本公开的抛光组合物进行抛光时,划痕可以减少约40%。实施例5在该实施例中,通过示出各自具有不同的组分和/或组分的量的十种不同的抛光组合物的条形图证明了实施例1中详述的基于面元尺寸选择的lpc计数趋势的一般性(generality)。图9示出了十种抛光组合物在老化0天、3天和7天时使用0.2μm的面元尺寸的lpc计数。图10示出了十种抛光组合物在老化0天、3天和7天时使用0.29μm的面元尺寸的lpc计数。图11示出了十种抛光组合物在老化0天、3天和7天时使用0.56μm的面元尺寸的lpc计数。图12示出了十种抛光组合物在老化0天、3天和7天时使用1.01μm的面元尺寸的lpc计数。重要地,通过最初添加的用以形成每种组合物的固体(即,所有固体组分,包括磨料和在最初配制期间作为固体添加的任何其他组分)的百分比将所示的lpc计数归一化,使得即使每种浆料组合物有差别,也可以比较lpc计数。当从较小至较大的面元尺寸(即,图9至图12)观察时,在图9中所有浆料的lpc计数相对稳定(使用0.2μm面元尺寸),而如图10至12所示,当在三个较大的面元尺寸下测量时,所有浆料的计数从第0天至第3天显著减少。该证据支持了实施例1中讨论的结论的一般性,其中显示磨料主要控制在0.2μm的面元尺寸的lpc计数,而其中显示在更大且更常规地测量的面元尺寸控制lpc计数的可溶性固体组分示出随时间lpc计数的显著减少。此外,该数据还呈现了对常规地认为lpc计数应控制在0.56μm和/或1.01μm面元尺寸的观点与现实世界应用中的减少缺陷/划痕不太相关的原因的说明。具体地,划痕主要由磨料引起,并且0.56μm和/或1.01μm的面元尺寸在充分表征来自非溶解磨料的有问题的lpc计数方面是不适当的。实施例6在该实施例中,研究了过滤的使用以确定通过深度过滤器的过滤(cmp工业中通常使用的做法)可以对现有技术的抛光浆料和本公开的抛光组合物的lpc计数具有怎样的影响。现有技术的抛光浆料的lpc计数在过滤之前超过了根据本公开的抛光组合物所教导的限度。相反地,本公开的抛光组合物的lpc计数在过滤之前低于根据本公开的抛光组合物所教导的限度。两种抛光浆料的组分在化学上相同,并且在每种组合物内以相同的量使用。图13示出了现有技术的抛光组合物和本公开的抛光组合物在使其经受使用0.1μm深度过滤器的过滤之后,在11天的时间段内使用0.2μm的面元尺寸测量的lpc计数的图。如图所示,使用0.1μm深度过滤器的过滤确实稍微减少了现有技术和本公开的抛光组合物二者的lpc计数,但是现有技术的抛光组合物的lpc计数从未接近本公开的抛光组合物所获得的水平。实施例7在该实施例中,对根据本申请配制的浆料和未根据本申请配制的比较浆料的lpc计数/浆料中使用的二氧化硅重量百分比磨料进行了比较。浆料1至4和6根据本发明配制,而浆料5和7至10是未根据本发明配制的比较浆料。虽然所有浆料具有稍微不同的配方,但是一个主要差异是每种配方中使用的特定二氧化硅产品。下表1汇总了浆料。表1浆料高的划痕倾向1否2否3否4否5是6否7是8是9是10是图14示出了浆料1至10在配制之后0天、3天和7天时在0.2μm的面元尺寸下测量的lpc/二氧化硅重量百分比。浆料1至4和6使用导致在0.2μm的面元尺寸下测量时的适当水平的lpc/二氧化硅重量百分比(即小于800000lpc/%二氧化硅)的二氧化硅磨料产品,而浆料5和7至10使用导致大于800000lpc/二氧化硅重量百分比的lpc/二氧化硅重量百分比的二氧化硅产品。经浆料1至4和6抛光的晶片显示出少于经比较浆料5和7至10抛光的晶片上观察到的划痕。图15示出了浆料1至10在配制之后0天、3天和7天时在0.29μm的面元尺寸下测量的lpc/二氧化硅重量百分比。显著地,比较浆料(即浆料5和7至10)平均显示出在该面元尺寸下低于产生较少划痕并且根据本公开配制的浆料1至4和6的lpc计数。该结果进一步证明在0.29μm或更大的面元尺寸下测量的lpc计数与抛光期间减少划痕/缺陷的浆料不太相关。实施例8在该实施例中,对根据本申请配制的浆料和未根据本申请配制的比较浆料的lpc计数/浆料中使用的固体重量百分比(即,磨料和可溶性固体组分)进行比较。浆料1至4和6根据本发明配制,而浆料5和7至10是未根据本发明配制的比较浆料。在该实施例中使用的浆料与实施例7中使用的浆料相同,但是将图16至17中所示的lpc计数归一化为固体重量百分比。图16示出了浆料1至10在配制之后0天、3天和7天时在0.2μm的面元尺寸下测量的lpc/固体重量百分比。如前所述,当与比较浆料5和7至10相比时,浆料1至4和6在抛光之后显示出减少的缺陷。因此,基于图16中所示的数据,小于50000的lpc/固体重量百分比值将是浆料在抛光期间减少缺陷/划痕的有效限度。图17示出了浆料1至10在配制之后0天、3天和7天时在0.29μm的面元尺寸下测量的lpc/固体重量百分比。如图所示,五种最低lpc/固体重量百分比中的四种实际上是作为证明不可接受的/增加的划痕水平的比较浆料的浆料6至9。因此,在0.29μm或更大的面元尺寸下测量的lpc计数与在抛光期间减少划痕/缺陷的浆料不太相关。虽然以上仅详细描述了几个示例性实施方案,但是本领域技术人员将容易理解,在实质上不脱离本发明的情况下,示例性实施方案中可以进行许多修改。因此,所有这些修改旨在包括在如以上权利要求所限定的本公开的范围内。当前第1页1 2 3
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
相关标签: 配制溶液
 热门咨询
热门咨询

tips


 商标分类
商标分类  商标转让
商标转让 



