碳掺杂单晶硅晶圆及其制造方法与流程
 2021-01-31 02:01:30|
2021-01-31 02:01:30| 327|
327| 起点商标网
起点商标网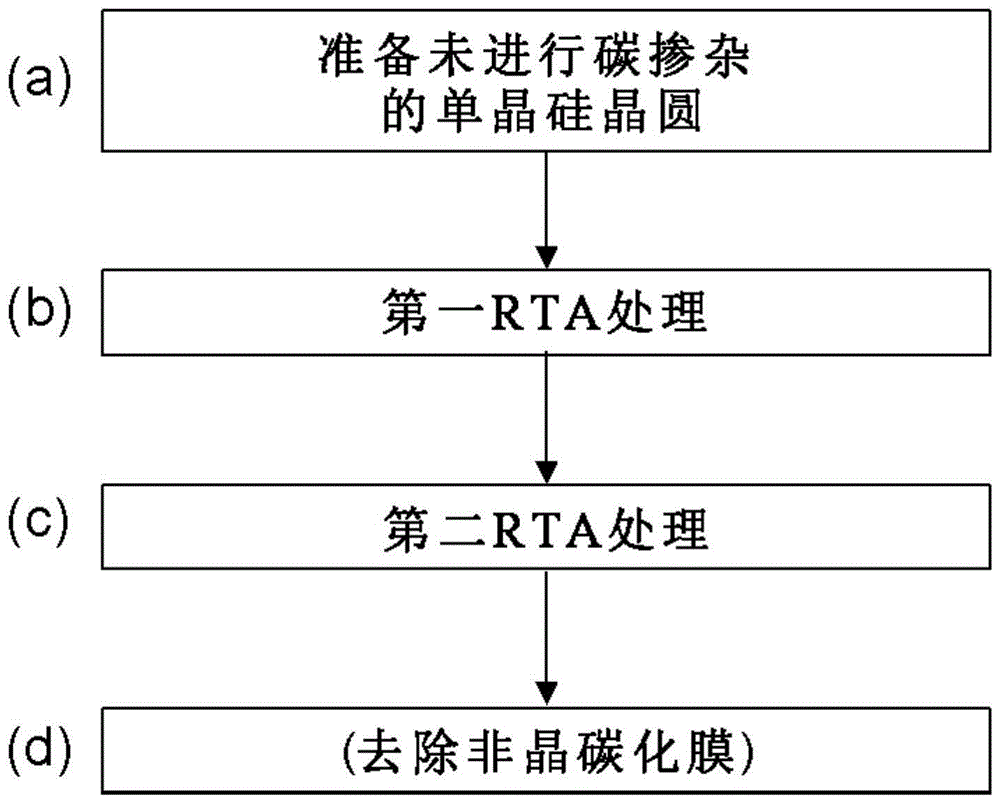
本发明涉及一种碳掺杂单晶硅晶圆及其制造方法。
背景技术:
作为用于制造半导体器件的基板,单晶硅晶圆被广泛使用。此外,已知为了吸除在半导体器件的制造工序中混入的金属杂质,对单晶硅晶圆赋予吸杂能力。然而,近年来,最尖端器件的制造条件的低温化被不断推进。由于在制造工序中作为金属杂质的吸杂位点而发挥作用,因此逐渐开始使用即使在低温工序中,也容易因氧析出而形成bmd(bulkmicrodefect,体内微缺陷)的、掺杂了碳的单晶硅晶圆。
此外,还已知通过向单晶硅晶圆中掺杂氮或碳而提高晶圆强度。然而,由于氮在单晶硅中的扩散速度快,因此在氮掺杂单晶硅晶圆中,氮会在用于制作器件的热处理中向外部扩散,难以得到高表层强度。另一方面,由于碳的扩散系数小,因此在碳掺杂单晶硅晶圆中,能够提高表层强度。
此外,已知进行了碳掺杂的固体图像传感器用单晶硅晶圆中的碳抑制载流子从电极的注入,因此达成较小的暗电流与优异的光敏性(参照非专利文献1)。
此外,还已知单晶硅晶圆中的碳具有抑制在热处理中产生的氧供体的形成的效果(参照专利文献1)。
现有技术文献
专利文献
专利文献1:日本特开2011-54656号公报
专利文献2:日本特开2018-190903号公报
非专利文献
“structuralelementsofultrashallowthermaldonorsformedinsiliconcrystals”a.hara,t.awano,y.ohnoandi.yonenaga:jpn.j.appl.phys.49(2010)050203.
技术实现要素:
本发明要解决的技术问题
作为提高单晶硅晶圆的晶圆强度的方法,已知有单晶硅晶圆的碳掺杂及氮掺杂、将晶圆制成高氧浓度晶体的方法、使氧在晶圆中析出的方法。然而,在通过提拉法使单晶硅(单晶硅锭)生长的阶段中向晶体中掺杂碳或氮时,由于偏析现象,杂质浓度会因经单晶化的晶体的位置而发生变化,因晶体位置的不同而产生氧析出量的差异。
此外,仅靠氧浓度控制单晶硅晶圆的氧析出量是有限度的,难以以不掺杂碳或氮的方式将氧析出量控制为高密度。
进一步,由于上述的最近的器件工序的低温化工艺的进展,单晶硅晶圆中的氧析出变得越来越难,因此谋求一种即使在这样的低温器件工序中,也能够将氧析出量控制在所需的氧析出量的技术。
另一方面,提出了通过在含碳气体氛围下对单晶硅晶圆进行热处理,从而将bmd控制为高密度(参照专利文献2)。然而,在专利文献2中,由于通过电阻加热而进行热处理,因此在降温中碳会向外部扩散,无法充分地提高晶圆表面的碳浓度,在晶圆强度这一点上并不充分。
本发明鉴于上述问题而完成,其目的在于提供一种通过使单晶硅晶圆的表层的碳浓度为高浓度、且使表面的碳浓度分布均匀,从而能够提高晶圆强度的碳掺杂单晶硅晶圆及其制造方法。
解决技术问题的技术手段
为了达成上述目的,本发明提供一种碳掺杂单晶硅晶圆的制造方法,其特征在于,所述制造方法具有以下工序:准备未进行碳掺杂的单晶硅晶圆的工序;在包含含碳原子化合物气体的氛围下,对所述单晶硅晶圆进行第一rta处理的工序;及以高于所述第一rta处理的温度,进行接着所述第一rta处理的第二rta处理的工序,通过所述第一rta处理及第二rta处理,对所述单晶硅晶圆注入空位并同时掺杂碳,将由所述单晶硅的表面至深0.1μm的范围内的碳浓度设为1×1017atoms/cm3以上。
若为这样的碳掺杂单晶硅晶圆的制造方法,则在基于快速加热-快速冷却的rta(rapidthermalannealing,快速热退火)处理阶段中,通过一同注入碳与空位,能够利用空位的作用而增大碳的扩散系数且不受经单晶化的晶体位置的影响。其结果,能够使碳从表面开始均匀地扩散,同时能够将由单晶硅晶圆的表面至深0.1μm的范围内的碳浓度提高为1×1017atoms/cm3以上,得到高晶圆强度。
在本发明的碳掺杂单晶硅晶圆的制造方法中,优选将距所制造的所述碳掺杂单晶硅晶圆的表面深于0.1μm的区域内的碳浓度设为1×1015atoms/cm3以上。
通过如此地设定所制造的晶圆的体(bulk)部的碳浓度,能够控制为更高的晶圆强度与所需的氧析出量。
此外,优选将准备的所述单晶硅晶圆的氧浓度设为11ppma以上。
如此,通过将准备的晶圆的氧浓度设为11ppma以上,碳掺杂单晶硅晶圆中的氧析出变得更容易。另外,在本发明的说明中,氧浓度以jeita标准表示。
此外,优选:在进行所述第二rta处理的工序后,具有去除通过所述第一rta处理及第二rta处理而形成在所述碳掺杂单晶硅晶圆的表面上的非晶碳化膜的工序。
如此,通过去除形成在表面上的非晶碳化膜,不需要在制作器件时再次去除非晶碳化膜。
此外,优选将所准备的所述单晶硅晶圆设为由nv区域、ni区域及v区域中的任意一种形成的单晶硅晶圆。
由于通过本发明的碳掺杂单晶硅晶圆的制造方法而制造的单晶硅晶圆中存在碳,因此无论为哪种缺陷区域,均能够形成氧析出,且通过使所准备的晶圆为具有这样的缺陷区域的晶圆,氧析出变得更容易。
此外,优选将所述第一rta处理及第二rta处理的氛围设为含有烃类气体且含有ar或nh3、或者ar与nh3的混合氛围。
通过在这样的氛围下进行热处理,能够更有效地将空位与碳一同注入。
此外,优选:通过以600℃以上850℃以下的温度保持5秒以上60秒以下的时间,从而进行所述第一rta处理,通过以1100℃以上且为硅熔点以下的温度保持10秒以上150秒以下的时间,从而进行所述第二rta处理。
通过这样的rta处理的条件,能够更有效地将空位与碳一同注入。
此外,本发明提供一种碳掺杂单晶硅晶圆,其为掺杂有碳、且具有空位的单晶硅晶圆,其特征在于,在由所述单晶硅晶圆的表面至深0.1μm的范围内,碳浓度为1×1017atoms/cm3以上。
由于这样的碳掺杂单晶硅晶圆的表面的碳浓度为1×1017atoms/cm3以上、较高,因此能够得到高晶圆强度。
此外,优选在距所述碳掺杂单晶硅晶圆的表面深于0.1μm的区域内,碳浓度为1×1015atoms/cm3以上。
通过如此地设定体部的碳浓度,能够控制为更高的晶圆强度与所需的氧析出量。
此外,优选所述碳掺杂单晶硅晶圆的氧浓度为11ppma以上。
若为这样的氧浓度,则碳掺杂单晶硅晶圆中的氧析出变得更容易。
此外,可使所述碳掺杂单晶硅晶圆在其表面上不具有非晶碳化膜。
如此,若为在表面上不具有非晶碳化膜的碳掺杂单晶硅晶圆,则不需在制作器件时再次去除非晶碳化膜。
此外,优选所述单晶硅晶圆由nv区域、ni区域及v区域中的任意一种形成。
通过使晶圆具有这样的缺陷区域,氧析出变得更容易。
发明效果,
若为本发明的碳掺杂单晶硅晶圆的制造方法,则通过在rta处理阶段一同注入碳与空位,能够利用空位的作用而增大碳的扩散系数且不受经单晶化的晶体位置的影响。其结果,能够使碳从表面开始均匀地扩散,同时能够将由单晶硅晶圆的表面至深0.1μm的范围内的碳浓度提高为1×1017atoms/cm3以上,得到高晶圆强度。此外,由于本发明的碳掺杂单晶硅晶圆的由表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上、较高,因此能够得到高晶圆强度。
附图说明
图1为示出本发明的碳掺杂单晶硅晶圆的制造方法的一个例子的流程图。
图2为示出本发明的碳掺杂单晶硅晶圆的制造方法中的rta处理的温度曲线的概要的图表。
图3为示出本发明的碳掺杂单晶硅晶圆的制造方法的过程中的烃类气体附着的截面示意图。
图4为示出通过sims测定实施例中的碳掺杂单晶硅晶圆的碳浓度分布的结果的图表。
图5为示出通过sims测定比较例中的碳掺杂单晶硅晶圆的碳浓度分布的结果的图表。
具体实施方式
如上所述,由于最近的器件工序的低温化工艺的进展,单晶硅晶圆中的氧析出变得越来越难,因此谋求一种即使在这样的低温器件工序中也能够将氧析出量控制为所需的氧析出量的技术。本申请的发明人发现,为了提高晶圆强度,需要向单晶硅晶圆中掺杂碳,且使由晶圆表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上。此外,本申请的发明人还发现,通过在热处理阶段一同注入碳与空位,碳的扩散系数因空位的作用而增大且不受经单晶化的晶体位置的影响,由此能够使氧析出均匀地加速生长,从而完成了本发明。
本发明为一种碳掺杂单晶硅晶圆的制造方法,其特征在于,所述制造方法具有以下工序:准备未进行碳掺杂的单晶硅晶圆的工序;在包含含碳原子化合物气体的氛围下,对所述单晶硅晶圆进行第一rta处理的工序;及以高于所述第一rta处理的温度,进行接着所述第一rta处理的第二rta处理的工序,通过所述第一rta处理及第二rta处理,对所述单晶硅晶圆注入空位并同时掺杂碳,将由所述单晶硅晶圆的表面至深0.1μm的范围内的碳浓度设为1×1017atoms/cm3以上。
首先,如图1的(a)所示,准备未进行碳掺杂的单晶硅晶圆(工序a)。优选此处所准备的单晶硅晶圆为由通过提拉法进行了提拉的单晶硅锭制作的单晶硅晶圆。此外,本发明中的“未进行碳掺杂”是指未刻意地向单晶硅晶圆中添加碳,含有作为非刻意的不可避免的杂质的碳的单晶硅晶圆包含在“未进行碳掺杂的单晶硅晶圆”中。
此处所准备的未进行碳掺杂的单晶硅晶圆例如可通过以下方式准备。首先,通过提拉法(cz法)提拉单晶硅锭。然后,通过切片、研磨、抛光、蚀刻等公知的方法将单晶硅锭加工为单晶硅晶圆(cw加工)。
优选使此处所准备的单晶硅晶圆的氧浓度为11ppma以上。该氧浓度可通过调节进行提拉时的条件而达成。此外,优选此处所准备的单晶硅晶圆为由nv区域、ni区域及v区域中的任意一种形成的单晶硅晶圆。由这些缺陷区域形成单晶硅晶圆可通过调节进行提拉时的条件、特别是调节提拉速度而得到。此外,可以是整个面由nv区域形成的晶圆、整个面由ni区域形成的晶圆、整个面由v区域形成的晶圆,但也可以是混合存在有上述区域的晶圆。另外,在通过提拉法进行了提拉的单晶硅中存在下述区域:在晶体制造工序中导入了点缺陷(空位、间隙硅),这些点缺陷凝集而形成grown-in(原生)缺陷的区域(v区域、i区域);点缺陷未凝集的完整晶体区域(n区域)等。此外,在n区域中,虽然未发生点缺陷的凝集,但存在空位占优势的nv区域与间隙硅占优势的ni区域。
然后,如图1的(b)所示,在包含含碳原子化合物气体的氛围下,对以上述方式准备的未进行碳掺杂的单晶硅晶圆进行第一rta处理(工序b)。
然后,如图1的(c)所示,以高于第一rta处理的温度,进行接着第一rta处理的第二rta处理(工序c)。
优选将第一rta处理及第二rta处理的氛围设为含有烃类气体且含有ar或nh3、或者ar与nh3的混合氛围。通过在这样的氛围下进行热处理,能够更有效地将空位与碳一同注入。
对于第一rta处理与第二rta处理,在图2中示出rta处理的温度曲线的概要。第一rta处理中,优选通过以600℃以上850℃以下的温度保持5秒以上60秒以下的时间,从而以不使烃类气体碳化的方式使其附着在单晶硅晶圆的整个表面上。此外,第二rta处理中,优选通过以1100℃以上且为硅熔点以下的温度保持10秒以上150秒以下的时间,从而使附着在单晶硅晶圆表面上的碳向内部扩散。通过这样的rta处理的条件,能够更有效地将空位与碳一同注入。
通过第一rta处理(工序b)及第二rta处理(工序c),能够对单晶硅晶圆注入空位,且同时掺杂碳。此外,本发明通过在rta处理阶段一同注入碳与空位,能够利用空位的作用而增大碳的扩散系数且不受经单晶化的晶体位置的影响。其结果,能够使碳从表面开始均匀地扩散,且同时将由单晶硅晶圆的表面至深0.1μm的范围内的碳浓度增高为1×1017atoms/cm3以上,得到高晶圆强度。
此外,在本发明的碳掺杂单晶硅晶圆的制造方法中,可进一步将距所制造的碳掺杂单晶硅晶圆的表面深于0.1μm的区域内的碳浓度设为1×1015atoms/cm3以上。
能够成为这样的对晶圆厚度方向的碳浓度分布进行了控制的碳分布的原因在于,单晶硅的金刚石结构为空隙多、容易使杂质扩散的结构。特别是在空位占优势的状态下,碳极易通过空位的作用而扩散。因此,首先如图3所示,通过第一rta使碳均匀地附着在单晶硅晶圆w的表面。通过之后的第二rta,能够使由单晶硅晶圆表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上,此外,优选能够将体区域的碳浓度控制在1×1015atoms/cm3以上,能够控制成高晶圆强度与所需的氧析出量。
像这样,通过rta的两阶段热处理,在表面上形成非晶碳化膜。与此同时产生空位,由此碳容易向内部扩散,顶面的碳浓度变得极高。此外,可使体部的碳浓度扩散至热处理温度较高的第二rta的温度下的碳的固溶度。
此外,在本发明的碳掺杂单晶硅晶圆的制造方法中,可在第二rta处理(工序c)之后,进一步具有图1的(d)所示的、去除通过第一rta处理及第二rta处理而形成在碳掺杂单晶硅晶圆的表面上的非晶碳化膜的工序(工序d)。
如上所述,由于通过第一rta处理及第二rta处理形成了15nm左右的非晶碳化膜,因此优选将其去除。该工序为任选有无的工序,但由于去除了形成在表面上的非晶碳化膜,因此在制作器件时,不需要再次去除非晶碳化膜。此外,只要能够使由碳掺杂单晶硅晶圆的表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上,则也可进行将表面抛光至深于非晶碳化膜的位置的工序。
通过这样的本发明的碳掺杂单晶硅晶圆的制造方法而制造的碳掺杂单晶硅晶圆为掺杂有碳、且具有空位的单晶硅晶圆,为由单晶硅的表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上的碳掺杂单晶硅晶圆。此外,优选距碳掺杂单晶硅晶圆的表面深于0.1μm的区域内的碳浓度为1×1015atoms/cm3以上。
此外,优选碳掺杂单晶硅晶圆的氧浓度为11ppma以上,优选碳掺杂单晶硅晶圆由nv区域、ni区域及v区域中的任意一种形成。
此外,通过进行上述工序(d),可制成在碳掺杂单晶硅晶圆的表面上不具有非晶碳化膜的晶圆。
实施例
以下,举出实施例及比较例对本发明进行具体说明,但本发明并不限定于这些实施例。
(实施例)
首先,通过提拉法提拉单晶硅锭,将其加工为晶圆,由此准备直径为200mm、晶面取向(100)、p型、通常电阻、氧浓度为12ppma(jeita)、碳浓度小于2.5×1015atoms/cm3、缺陷区域为nv区域的单晶硅晶圆,将其作为未进行碳掺杂的单晶硅晶圆(工序a)。
然后,通过以下方式进行第一rta处理及第二rta处理。
在将单晶硅晶圆投入rta处理装置之后,从室温升温至800℃,然后在800℃下保持20秒(工序b,第一rta)。此时的氛围为ch4+nh3/ar,将碳浓度设为2%。
然后,升温至1200℃,在1200℃下保持10秒(工序c,第二rta)。接着第一rta,此时的氛围为ch4+nh3/ar,将碳浓度设为2%。然后进行降温。
然后,去除附着在单晶硅晶圆的表面上的非晶碳化膜(工序d)。此时,以使加工余量(取り代)为0.1μm的目标进行抛光加工。
最后,使用sims(二次离子质谱),对所制造的碳掺杂单晶硅晶圆的碳浓度的深度分布进行测定。将该结果示于图4。由碳掺杂单晶硅晶圆的表面至深0.1μm的范围内的碳浓度为1×1021atoms/cm3。此外,距表面深于0.1μm的区域的碳浓度为3×1016atoms/cm3以上,其为接近1200℃的碳固溶度的浓度。另外,通过sims得到的碳浓度的检测下限约为7×1015atoms/cm3。
(比较例)
首先,通过与实施例相同的方式,准备直径为200mm、晶面取向(100)、p型、通常电阻、氧浓度为12ppma(jeita)、碳浓度小于2.5×1015atoms/cm3、缺陷区域为nv区域的单晶硅晶圆,将其作为未进行碳掺杂的单晶硅晶圆。
然后,使用立式热处理炉,进行碳掺杂热处理。首先,以750℃投入立式热处理炉之后,以10℃/分钟的升温速度升温至1000℃。然后,以3℃/分钟的升温速度从1000℃升温至1200℃,以1200℃保持60分钟,以-3℃/分钟的降温速度进行降温。然后,在700℃下从立式热处理炉中取出。将整个热处理工序的气体氛围设为碳浓度为1%的co2+ar。
最后,去除进行了热处理的晶圆的表面氧化膜,评价sims的碳曲线。将该结果示于图5。由晶圆的表面至深0.1μm的范围内的碳浓度为2×1016atoms/cm3,深度2μm附近的碳浓度接近固溶度,为3×1016atoms/cm3,确认到碳浓度在体方向上下降。
可知通过本发明的方法,能够使由单晶硅晶圆的表面至深0.1μm的范围内的碳浓度为1×1017atoms/cm3以上。
另外,本发明不受上述实施方案限定。上述实施方案为例示,具有与本发明的权利要求书中记载的技术构思实质相同的构成、并发挥相同作用效果的技术方案均包含在本发明的保护范围内。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询



 商标分类
商标分类  商标转让
商标转让 



