大流量气相法晶体生长的压力自适应模糊控制方法与流程
 2021-01-30 23:01:48|
2021-01-30 23:01:48| 352|
352| 起点商标网
起点商标网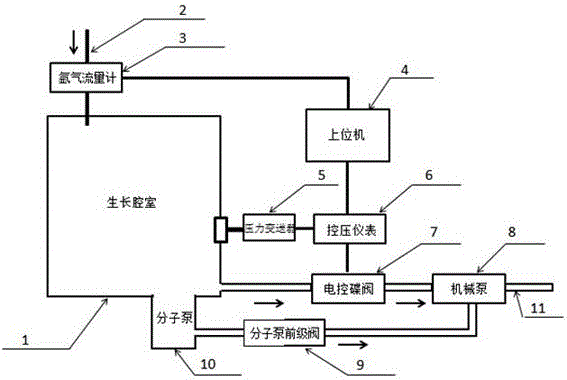
本发明涉及一种晶体生长的压力自适应模糊控制方法,特别涉及一种大流量气相法晶体生长的压力自适应模糊控制方法。
背景技术:
压力控制在晶体材料制备中广泛存在。压力控制的核心就是使得系统的进气量和排气量达到一个相对的平衡,实现方式有两种,一是固定排气量,通过调节进气量实现压力平衡,比如排气通过保持一定开度的针阀,进气通过流量计并且流量大小可调,这样的方式更多地应用在小腔室、小流量的生长系统中;二是固定进气量,通过调节排气量实现压力平衡,比如利用气体流量计设定一定的进气量,通过调节碟阀、球阀的开启比例,或者通过变频器控制真空泵的抽速来实现系统的压力控制,这样的控制方式更适用于大腔室、大流量动态气氛下的晶体生长系统。
无论是控制进气,还是控制排气,控制装置可以采用控压仪表或者plc控制器中的pid模块,两者都是根据压力测量值和目标设定值及采样时间,依照pid输出计算公式将控制输出转换为电流或者电压信号送给流量控制设备,如调节气体流量计的流量大小或调整碟阀和球阀的开启比例,从而实现系统的压力控制。但是常规的控压仪表或plc中的pid模块都只有一套pid参数,对于晶体生长压力变化较大或者需要多段压力控制工艺的系统来说,一套pid参数难以满足在不同压力区间的控制效果,如果想获得理想的控制效果,还需要有操作经验的工艺人员逐步调整pid控制参数。
以碳化硅等气相法晶体生长来说,随着晶体尺寸不断增大的需求,单晶生长腔室由最初的小体积的石英结构,逐步升级为目前的大体积的不锈钢炉体,之前的针阀压力控制系统转变为目前的碟阀或者球阀装置。此外,晶体质量要求的不断提升对单晶生长各个工艺环节的控制要求也逐步加强,尤其是对气相法生长过程中的压力控制的精准性和快速性要求更高。在晶体生长的初期和末期需要炉内保持在较大的压力状态下以防止自发成核,在生长过程中又需要保证炉内的低压状态,并尽量减少压力扰动以降低晶体产生诸如包裹、微管道等缺陷,可见压力控制的准确性对晶体的质量具有很大的影响。除了人为的改变工艺参数,比如生长系统的目标压力由低压变为高压,还有一种情况在实际的单晶生长实验中广泛存在,那就是工艺参数保持不变,但是系统的加热和保温系统都会随着使用次数的增加而逐步发生老化,对于像碳化硅单晶生长保温系统来说,它本身属于多孔的一种材质,它对气体的透过率会随着老化而逐步变差,但是随着实验次数的增加,保温系统的老化会导致控制效果逐渐变差,如果不及时调整pid参数会使得控制效果越来越差,而本申请所采用模糊自适应压力控制系统就可以在系统参数发生变化时能够及时的调整pid控制参数,使得本系统始终以最佳的状态进行工作,以保证晶体生长质量,这就具有重要的现实意义。
技术实现要素:
鉴于现有技术存在的问题,本发明提供一种大流量气相法晶体生长的压力自适应模糊控制方法,适用于大腔室大气流环境下晶体生长过程中压力控制。具体技术方案是,一种大流量气相法晶体生长的压力自适应模糊控制方法,基于大流量气相法晶体生长炉的仪表控制系统,其包括生长腔室、进气管道、氩气流量计、压力变送器、控压仪表、机械泵、分子泵前级阀、分子泵、排气管道、压力传感器,其特征在于:还包括上位机、电控碟阀,上位机通过通讯缆分别与氩气流量计、控压仪表连接,电控碟阀通过排气管道分别与生长腔室、排气管道与机械泵连接,构成大流量气相法晶体生长的压力自适应模糊控制系统;压力控制调节方法为上位机根据压力的测量值和设定值之间的偏差及偏差的变化率的大小,按照模糊控制规则所获得的pid参数增量调节,更新控压仪表中的三个pid参数,具体包括以下步骤:
一、首先开启机械泵,在上位机中设定控压仪表的目标压力为0mbar,并设定电控碟阀的最小开度为99%,最大开度为100%,通过机械泵和电控碟阀这一条气路对生长腔室进行低真空抽气操作;待系统真空降至1×10-1pa,设定电控碟阀的最小开度为0%,最大开度也为0%,即关闭电控碟阀这条气路,然后开启分子泵前级阀,同时启动分子泵开始进行高真空抽气操作,待系统真空降至1×10-3pa时,关闭分子泵和分子泵前级阀,最后关闭机械泵;
二、在上位机中设定氩气流量计的流量为10l/min,通过进气管道进入生长腔室内,待炉内充气压力至1100mbar时将流量计的流量设定为0l/min;
三、在上位机中设定控压仪表的目标压力为10-1000mbar,再设定氩气流量计的流量为0-10l/min,之后设定电控碟阀的最小开度为0%,最大开度为100%,保证电控碟阀能在关闭和打开的范围内连续变化,最后开启机械泵;
四、用e(k)和ec(k)的模糊论域的变量,计算e(k)模糊化的比例因子及ec(k)模糊化的比例因子:
根据已知误差公式e(k)=r(k)-y(k)和误差的变化率公式ec(k)=e(k)-e(k-1),其中y(k)表示当前压力变送器的测量值、r(k)表示当前控压仪表的设定值,用e和ec分别代表e(k)和ec(k)的模糊论域的变量,其中e(k)及ec(k)的最大控制范围是[-20,20],而对应的e及ec的最大控制范围是[-10,10],则e(k)模糊化的比例因子为变量e和e(k)的范围比值,同理ec(k)模糊化的比例因子为变量ec和和ec(k)的范围比值;
五、在上位机中设定控压仪表的pid控制的三个参数的最大增量调节范围:δkp、δki、δkd均为[-10,10],根据表1[模糊控制规则]进行模糊运算公式求得表2[pid参数的增量调节表],之后根据每次采样的e(k)和ec(k)的数值,先将其转换为模糊论域内的变量数值,在表2中进行查表获得δkp、δki、δkd的增量调节数值;
表1模糊自适应控制规则表
表2模糊自适应pid参数调节增量表
六、获得δkp、δki、δkd的增量调节数值之后,更新控压仪表pid的3个参数kp、ki、kd,再根据pid计算公式得到控制输出的百分比,控压仪表(6)将输出的百分比转换为0-5v的电压信号送给电控碟阀(7)调整开启比例,经过3分钟左右的调节时间,系统压力稳定在目标压力值,上下波动控制在±1mbar之内;
七、若需要改变压力控制目标值,则在上位机中重新设定控压仪表的目标压力,再设定氩气流量计数值,重复上面的第四和第五步骤,同样在经过3分钟左右的调节之后,系统压力稳定在新的压力目标值,上下波动同样控制在±1mbar之内。
本发明的技术效果是,在线实时地对控压仪表的pid的参数进行修正,实现真空室压力在1-30mbar范围内的精确控制,可以满足不同时刻不同压力的精准控制要求。
附图说明
图1为本发明晶体生长系统的压力控制结构示意图;
图2为本发明模糊自适应pid控制结构图;
图3为本发明模糊自适应pid算法流程图。
具体实施方式
下面以碳化硅气相法晶体生长的压力自适应模糊控制方法为例进一步说明本发明。
如图1、图2、图3所示,一种碳化硅气相法晶体生长的压力自适应模糊控制方法,基于碳化硅气相法晶体生长炉的仪表控制系统,其包括生长腔室1、进气管道2、氩气流量计3、压力变送器5、控压仪表6、机械泵8、分子泵前级阀9、分子泵10、排气管道11、压力传感器12,还包括上位机4、电控碟阀7,上位机4通过通讯缆分别与氩气流量计3、控压仪表6连接,电控碟阀7通过排气管道分别与生长腔室1、排气管道与机械泵8连接,构成碳化硅气相法晶体生长的压力自适应模糊控制系统;压力控制调节方法为上位机4根据压力的测量值和设定值之间的偏差及偏差的变化率的大小,按照模糊控制规则所获得的pid参数增量调节,更新控压仪表6中的三个pid参数,具体包括以下步骤:
(一)首先开启机械泵8,在上位机4中设定控压仪表6的目标压力为0mbar,并设定电控碟阀7的最小开度为99%,最大开度为100%,通过机械泵8和电控碟阀7这一条气路对生长腔室1进行低真空抽气操作;待系统真空降至1×10-1pa,设定电控碟阀7的最小开度为0%,最大开度也为0%,即关闭电控碟阀7这条气路,然后开启分子泵前级阀9,同时启动分子泵10开始进行高真空抽气操作,待系统真空降至1×10-3pa时,关闭分子泵10和分子泵前级阀9,最后关闭机械泵8;
(二)在上位机4中设定氩气流量计3的流量为10l/min,通过进气管道2进入生长腔室1内,待炉内充气压力至1100mbar时将流量计3的流量设定为0l/min;
(三)在上位机4中设定控压仪表6的目标压力为400mbar,再设定氩气流量计3的流量为1l/min,之后设定电控碟阀7的最小开度为0%,最大开度为100%,保证电控碟阀7能在关闭和打开的范围内连续变化,最后开启机械泵8;
(四)y(k)表示当前压力变送器5的测量值、r(k)表示当前控压仪表6的设定值、e(k)=r(k)-y(k)表示误差、ec(k)=e(k)-e(k-1)表示误差的变化率,e和ec分别代表e(k)和ec(k)的模糊论域的变量;其中e(k)及ec(k)的实际控制范围是[-10,10],而对应的e及ec的范围是[-6,6],则e(k)和ec(k)模糊化的比例因子均为ke=kec=6/10;在上位机4中设定控压仪表6的pid控制的三个参数的增量调节范围:δkp、δki、δkd均为[-7,7],根据表1[pid参数的增量调节表]进行模糊运算求得pid参数的增量调节表,之后根据每次采样的e(k)和ec(k)的数值,先将其转换为模糊论域内的变量数值,再进行查表2[模糊自适应pid参数调节增量表]获得δkp、δki、δkd的增量调节数值;
表1模糊自适应控制规则表
表2模糊自适应pid参数调节增量表
(五)模糊pid算法的采样周期为1秒,控压仪表6的pid参数的初始值为kp0=100,ki0=20,kd0=10,则第1次pid参数调节的增量计算过程为:e(1)=r(1)-y(1)=400-1000=-600,ec(1)=e(1)-e(0)=-600,模糊化变量e=-600*ke,经四舍五入可得e=-6,同理可得ec=-6,通过查询表2pid参数的增量调节表可得δkp=7、δki=-7、δkd=1,经调整后控压仪表的pid参数变为kp1=107,ki1=13,kd1=11,再根据pid计算公式得出输出的百分比为100%,控压仪表6将输出的百分比转换为5v*100%=5v的电压信号送给电控碟阀7,电控碟阀7就全部打开,通过机械泵8全速抽气。类似的,第100次pid参数调节的增量计算过程为:e(100)=r(100)-y(100)=400-395=5,ec(1)=e(100)-e(99)=2,模糊化变量e=5*ke=3,同理可得ec=2*kec,经四舍五入可得ec=1通过查询表2[模糊自适应pid参数调节增量表]可得δkp=-4、δki=4、δkd=1,那么kp100=140,ki100=28,kd100=26;再根据pid计算公式得出输出的百分比为40%,控压仪表6将输出的百分比转换为5v*40%=2v的电压信号送给电控碟阀7,电控碟阀7就打开40%的开度,通过机械泵8进行抽气;经过3分钟180次的调节之后,pid参数变为kp180=157,ki180=32,kd180=22,系统压力稳定在400mbar,上下波动控制在±1mbar之内;
(六)若需要改变压力控制目标值,在上位机4中设定控压仪表6的目标压力为800mbar,再设定氩气流量计3的流量为1.5l/min,此次的目标压力值和氩气流量计数值都和上次时不同,但电控碟阀7的最小开度仍为0%,最大开度仍为100%;pid参数的调节过程和上一步相同,但是pid参数的初始值为kp0=157,ki0=32,kd0=22,为上一次调整的结果;在经过3分钟180次的调节之后,pid参数变为kp180=140,ki180=26,kd180=26,系统压力稳定在800mbar,上下波动同样控制在±1mbar之内。
本模糊自适应pid控制系统表1、表2也适用于氮化铝气相法晶体生长的压力自适应模糊控制方法。
原理:
通过上面的第5和第6步的调节过程,可以看出模糊自适应pid控制和传统pid控制的区别,虽然两者的计算公式相同,都和误差e(k),误差的变化率ec(k)、采样时间有关,但是模糊自适应pid控制的输出计算还和pid这三个参数的增量有关,即当系统误差较大时,模糊控制可通过更大的输出来降低误差,误差较小时,模糊控制以更小的输出去接近目标值,始终以最优的动态控制效果达到系统的控制目标。
以上实施方式仅用于说明本发明,而并非对本发明的限制,有关技术领域的
普通技术人员,在不脱离本发明的精神和范围的情况下,还可以做出各种变
化和变型,因此所以等同的技术方案也属于本发明的范畴,本发明的专利保
护范围应由权利要求限定。
起点商标作为专业知识产权交易平台,可以帮助大家解决很多问题,如果大家想要了解更多知产交易信息请点击 【在线咨询】或添加微信 【19522093243】 与客服一对一沟通,为大家解决相关问题。
与客服一对一沟通,为大家解决相关问题。
此文章来源于网络,如有侵权,请联系删除
 热门咨询
热门咨询



 商标分类
商标分类  商标转让
商标转让 



